Материал: anishik_v_m_uglov_v_v_cherenda_n_n_rezerfordovskoe_obratnoe

щины (например, для ионов гелия с энергией 2 МэВ, t ≤0.5 мкм). При большей толщине пленок необходимо учитывать изменение тормозной способности ионов с увеличением глубины их проникновения.
Рассмотрим случай двухслойной системы (рис. 3.3). Первая пленка состоит из атомов сорта А, вторая – из атомов сорта В. Будем считать, что первая пленка играет роль только поглотителя энергии анализирующих частиц, но не влияет на их число. Вследствие потерь энергии пучком ионов в первой пленке, правый склон сигнала от атомов сорта В уже не будет соответствовать энергии КВЕ0 и окажется смещенным в область более низких энергий – Е1В,tА.
Рис. 3.3. Схема обратного рассеяния ионов от двухслойной системы
Толщина первого слоя может быть определена по уже рассмотренным методикам. В общем случае толщина второго слоя может быть определена из выражения:
|
[ε]B |
, |
(3.14) |
∆EB = |
1 + (N AtA / cos Θ2 )(dεA / dE) NBtB |
где ∆ЕВ – энергетическая ширина сигнала от ионов, рассеянных на атомах сорта В, tA и tB – толщины 1-й и 2-й пленок, NA и NB – концентрации
атомов сорта А и В. В данном выражении [ε]B определяется при Евх=ЕtА и Евых=КВЕtА (в поверхностном энергетическом приближении), а dεA / dE рассчитывается в диапазоне энергий, соответствующем Е1В,tA
26

(см. рис. 3.3). В предельном случае, когда 1-й слой отсутствует или толщина его → 0, формула (3.14) переходит в формулу (2.17). Использование для расчета формулы (3.14) подразумевает, что пленка В имеет сравнительно малую толщину, иначе в формулу (3.14) необходимо вводить поправку на зависимость εB(Е).
Для расчета с использованием формулы 3.14 необходимо знать энергию ионов на границе раздела пленок (на рис. 3.3 это ЕtА). Для определения этой энергии можно использовать следующий подход. Предположим, что потери энергии в любом слое при движении иона до и после соударения не зависят от глубины, то есть:
α = |
∆Eвых = const . |
(3.15) |
|
∆Eвх |
|
Тогда из геометрии столкновения, определяемой рис. 2.4, следует, что
|
E1 +αE0 |
|
E = |
KM +α . |
(3.16) |
Таким образом, при определении Евх для второго слоя можно использовать значение Е, получаемое при подстановке в формулу 3.16 значений α и КМ для первого слоя. Значение α может быть определено, используя табулированные значения ε (приложение 2):
α |
ε(KM E0 ) |
cos Θ1 |
. |
(3.17) |
|
ε(Eo ) cos Θ2 |
|
||
Несмотря на то что выражение для α (формула 3.17) получено в предположении справедливости поверхностного энергетического приближения, данный подход может быть использован для пленок или слоев значительной толщины, когда это приближение, строго говоря, применять нельзя. Это связано с тем, что с изменением энергии значение α меняется меньше, чем значение ε.
Погрешность в определении толщины слоя δt связана с энергетическим разрешением детектора δЕ и определяется с помощью следующей формулы:
δ |
E |
=[ε]обр |
Nδt . |
(3.18) |
|
элем |
|
|
Задание
1.Провести качественный анализ образца и, используя описанную методику, определить состав образца (в первом приближении). Полученные данные занести в таблицу.
27
Элемент |
Н, |
σ, |
[ε]обрэлем , |
Концентрация, |
|
им- |
10– 24см2/ср |
10– 15эВ·см2 |
атомные % |
|
пульсы |
|
|
|
|
|
|
|
|
2. Провести анализ спектра и определить толщины пленок, используя:
I – формулу (3.11), II – формулу (2.17), считая Евх=Е0 и Евых=КМiЕ0, III – формулу (2.17) с учетом формул (3.16, 3.17). Полученные данные
занести в таблицу.
Элемент |
|
I |
|
II |
|
III |
|
|
|
А, |
|
t, |
∆Е, |
[ε]обрэлем , |
t, |
[ε]обрэлем , |
t, |
|
им- |
|
нм |
кэВ |
10–15эВ·см2 |
нм |
10–15эВ·см2 |
нм |
|
пуль |
|
|
|
|
|
|
|
|
сы |
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
Используя формулу (3.18), определить погрешность δt для методик II и III. Сделать вывод о применимости для данной системы каждого из использованных методов расчета толщины.
Контрольные вопросы
1.Способ вычитания, используемый для определения состава образца. Его преимущества.
2.Способы определения толщины пленки. Условия их применимости. Их преимущества и недостатки.
3.Определение толщины слоев в многослойной системе.
4.Как выглядит спектр РОР двухслойной системы, изображенной на рис. 3.3? (Рассмотреть различные варианты).
5.Вывести равенство KB E0 − E1B,tA = N AtA[ε]BA (см. рис. 3.3).
28
ЛАБОРАТОРНАЯ РАБОТА № 4
ОПРЕДЕЛЕНИЕ ЭНЕРГИИ АКТИВАЦИИ РОСТА СИЛИЦИДА МЕТАЛЛА
Цель работы: изучение кинетики процесса роста силицидов металлов на кремнии и определение энергии активации роста силицида.
Впоследнее время в связи с высокими требованиями, предъявляемыми к интегральным схемам, важное значение приобрели исследования процессов образования и роста силицидов металлов. Поэтому возникает необходимость получения информации о параметрах, характеризующих эти процессы. Один из таких параметров – энергия активации роста может быть определен с помощью метода РОР. Данный метод позволяет исследовать лишь стадию роста фазы при образовании силицида, а не процесс его зарождения. Это связано с тем, что трудно точно идентифицировать состав слоя толщиной менее 20 нм, локализованного у поверхности раздела металл – кремний на глубине нескольких сотен нанометров от металлической пленки.
Вкачестве примера рассмотрим формирование силицида никеля на
границе раздела пленки никеля и кремния. Отжиг такой системы, начиная с 200 оС, приводит к образованию Ni2Si (рис. 4.1). С увеличением времени отжига толщина силицидного слоя будет увеличиваться. На спектре РОР это соответствует увеличению энергетической ширины плато, соответствующего силициду, и уменьшению энергетической ширины
сигналов от пленки никеля и кремниевой подложки (рис. 4.1). В случае отжига при температуре больше 350 оС на поверхности раздела между Si
иNi2Si образуется NiSi (рис. 4.2). Определим энергию активации роста силицида Ni2Si. Для этого необходимо из соответствующих спектров РОР получить зависимости толщины силицидного слоя t от времени вы-
держки τ при каждой температуре отжига в интервале 200–350 оС
(рис. 4.3).
Полученные данные позволяют определить скорость роста силицида
для определенной температуры отжига: |
|
||
V (τ) = |
t |
. |
(4.1) |
τ |
|
||
Кинетика роста Ni2Si соответствует параболической зависимости толщины силицидного слоя от времени отжига. Такой вид зависимости характерен для силицидов большинства металлов. Однако дисилициды неко-
29
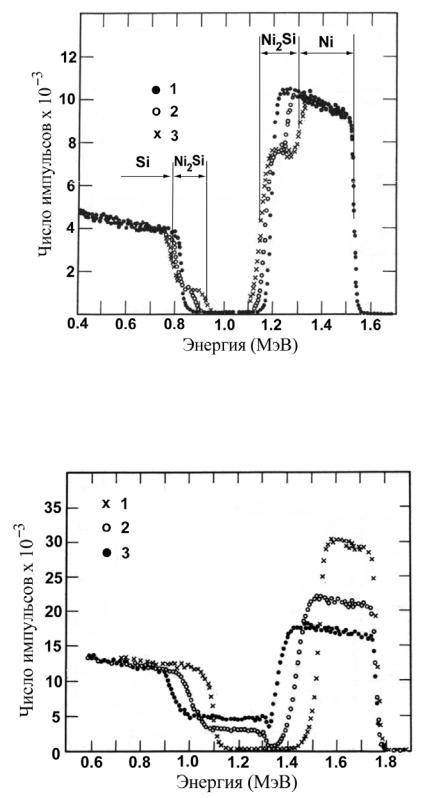
Рис. 4.1. Спектры РОР для пленки Ni толщиной 200 нм на Si до и после отжига при 250 оС: 1 – сразу после нанесения пленки; 2 – после отжига 1 ч; 3 – после отжига 4 ч (для этого случая указаны энергетические ширины сигналов, соответствующих
Ni, Si, Ni2Si)
Рис. 4.2. Спектры РОР для пленки Ni на Si, показывающие последовательное образование Ni2Si и NiSi: 1–200 нм Ni на Si сразу после напыления; 2–350 оС,
20 мин, образовался Ni2Si; 3–400 оС, 2 ч, образовался NiSi
30