Материал: TTE_Lect1

У момент t1 до бази БТ подається негативний імпульс струму
(рисунок 10.9), ЕП вмикається в прямому напрямі, дірки з емітера інжектують до бази. ЕП переходить до активного режиму роботи, робоча точка рухається вздовж навантажувальної прямої від т.А до т.В, наближаючись до області режиму насичення (РН). Струм бази в момент
t1 різко зростає до значення IБнас , і концентрація дірок у базі біля ЕП
збільшується. Але струм колектора починає змінюватися лише через деякий час затримки, який потрібно затратити діркам, щоб подолати відстань між емітером і колектором. Через певний час дифундуючі до колектора дірки заповнюють базу, градієнт їх концентрації біля КП
збільшується, і струм колектора зростає (крива t2 на рисунку 10.8, а). В
момент t3 транзистор наближається до РН, розподіл концентрації дірок у базі стає лінійним, наростання струму колектора IК сповільнюється
(рисунок 10.8, а, крива t3 , рис. 10.9). Робоча точка транзистора переходить до точки В на навантажувальній прямій. Ця точка відповідає
напрузі UKE UБЕ (UKE EK )
і струму IKнна (EK UKE )/ RK EK / RK .
Напруга на КП UКБ UKEнEн UБЕ 0 , і КП вмикається в прямому напрямі. Починається інжекція дірок з колектора до бази, і їх концентрація біля КП зростає, стає більшою, ніж рівноважна (рисунок
10.8, крива t4 ). Градієнт дірок у базі в РН залишається постійним, і струм колектора більш не наростає (рисунок 10.9).
У момент t5 імпульс керування в базі БТ закінчується, і прилад
поступово повертається до свого початкового стану. Починається процес розсмоктування дірок у базі за рахунок їх екстракції до областей емітера і колектора. Зміна знака градієнта концентрації біля ЕП (крива
t5 на рисунку 10.8) і перехід дірок до області емітера спричиняють зміну напряму струму бази, який досягає значення IБ (рисунок 10.9). За час розсмоктування неосновних носіїв (від моменту t5 до моменту t7 )
концентрація дірок у базі біля ЕП та КП зменшується таким чином, що градієнт їх концентрації залишається постійним (крива t6 і t7 на
рисунку 10.8, б), і тому струми IБ та IK не змінюються. Після того як концентрація дірок у базі біля КП і ЕП досягає рівноважного значення
126

( pn0 ), градієнти їх концентрації починають зменшуватись, і це викликає зменшення струмів бази і колектора до початкових значень
IБ0 = IKБ0 та IK0 = IKБ0 , характерних для РВ.
Рисунок 10.9 – Часові діаграми струмів БТ в ключовому режимі
На тривалість переднього і заднього фронтів вихідного імпульсу струму (рисунок 10.9) суттєво впливають частотні властивості БТ. Чим вища гранична частота транзистора, тим вища його швидкодія в ключовому режимі.
Крім того, швидкодія БТ в режимі перемикання збільшується при збільшенні коефіцієнта передачі струму h21E (або збільшенні
амплітуди імпульсу струму бази – імпульсу керування).
З метою підвищення граничної частоти транзистори виготовляють з малими ємностями переходів, а також, оскільки на швидкість розсмоктування впливає не лише екстракція, а й рекомбінація, зменшують середню тривалість життя неосновних носіїв шляхом введення до бази домішок, що прискорюють рекомбінацію (наприклад, золото у кремнієвих БТ).
127
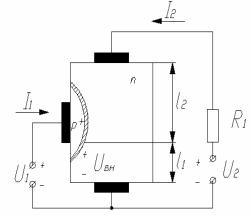
10.3 Одноперехідний транзистор
Одноперехідний транзистор, або двобазовий діод (рисунок 10.10), - це біполярний прилад, що працює в режимі перемикання.
P n перехід, що відокремлює високолеговану область емітера від низьколегованої базової області, розділяє останню на дві частини:
нижню з довжиною l1 і верхню базу з довжиною l2 . Струм емітера при
прямому вмиканні цього переходу містить здебільшого лише діркову складову, і тому перехід називають інжектором. Принцип дії приладу грунтується на зміні об’ємного опору бази під час інжекції.
Рисунок 10.10 – Будова одноперехідного транзистора
На омічні контакти верхньої і нижньої баз подається напруга,
що викликає проходження через прилад струму I2 . Цей струм створює на опорі нижньої бази спад напруги Uвн , яке містить p n перехід у зворотному напрямі. Через закритий перехід тече його зворотний струм
I10 (рисунок 10.10). При прикладенні до входу транзистора напруга перехід не відкривається, і малий струм I10 залишається практично незмінним. Транзистор перебуває в закритому стані. При
U1 Uвн перехід вмикається прямо, і починається інжекція дірок до баз, унаслідок чого їх опори зменшуються. Це приводить до зменшення спаду напруги Uвн , подальшого відкривання переходу, збільшення струму I1 , подальшого зменшення опорів баз і т.д.
128

Починається лавинний процес перемикання транзистора, що супроводжується збільшенням ємітерного струму I1 і зменшенням спаду напруги між емітером і нижньою базою (U1 ). На вхідній
статичній характеристиці виникає ділянка з негативним диференційним опором (рисунок 10.11, а). Внаслідок процесу перемикання транзистор переходить до відкритого стану. В цьому стані прилад перебуватиме доти, поки інжекція дірок через перехід буде підтримувати в базі
надлишкову концентрацію носіїв, тобто поки струм I1 буде більшим за величину I1 вимкн (рисунок 10.11, а).
На рисунку 10.11,б показано вихідні характеристики
одноперехідного транзистора |
I2 f (U2 ) |
I |
const . При |
I1 =0 вихідна |
|
|
1 |
|
|
характеристика лінійна, бо |
прилад поводить себе |
як звичайний |
||
резистор. При I1 >0 вихідні характеристики набирають нелінійного характеру, оскільки результуюча напруга на переході змінюються при зміні вихідного струму I2 .
Рисунок 10.11 – Вхідна (а) і вихідна (б) статичні характеристики одноперехідного транзистора
Одноперехідні транзистори використовують у різноманітних імпульсних схемах (генератори релаксаційних коливань, підсилювачі тощо).
129
10.4 Високочастотні малопотужні транзистори
Як відомо з п.10.1, частотний діапазон БТ має задовольнити
вимогу r C |
|
|
1 |
, з якої випливає, що для роботи |
на |
високих |
|
|
|||||
Б |
K |
|
|
r |
|
|
частотах БТ повинен мати малий розподільний опір бази |
і малу |
|||||
|
|
|
|
|
Б |
|
бар’єрну ємність КП CK .
При виготовленні високочастотних транзисторів сплавний спосіб не застосовують, оскільки він не дозволяє отримати вузьку базу
(малий опір rБ ) і малу площу переходів. Тому такі транзистори
виготовляють за технологією дифузійного введення домішок. Глибина проникнення атомів домішок у напівпровідниковий кристал залежить від тривалості процесу дифузії та виду дифундуючих домішок.
При цьому в кристалі створюється нерівномірний розподіл домішок від поверхні до глибини. Це сприяє збільшенню концентрації
домішок у базі біля ЕП і, як наслідок, зменшенню rБ . Відносне
зменшення концентрації домішок біля КП приводить до зменшення його бар’єрної ємності за рахунок розширення переходу в бік бази, а також до збільшення пробивної напруги колектора.
Прикладом транзисторів, виготовлених за дифузійною технологією, є дрейфові транзистори. У базах транзисторів створюється експоненціальний розподіл донорних домішок, що зменшується від емітера до колектора (рисунок 10.12).
У наслідок іонізації атомів домішок у базі виникає так зване вбудоване електричне поле, спрямоване від емітера до колектора. Це поле збільшує швидкість руху через базу. Завдяки цьому усувається істотний недолік сплавних транзисторів з точки зору частотних властивостей, тобто зменшується час прольоту дірок через базу. Ємність КП у таких транзисторах мала, тому що він має велику товщину.
130