Материал: Сучасні термоелектричні наноматеріали: класифікація і технологія
Принципові елементи установки для
вирощування напівпровідникових структур методом МПЕ, що розміщуються у
вакуумній камері, показані на рис. 3.6. Римськими цифрами позначені області
(зони), що визначають основні особливості МПЕ: I - зона генерації молекулярних
пучків ефузійними комірками Кнудсена з механічними засувками; II - зона
змішування (перетину) пучків елементів, випаровуваних з різних ефузійних комірок;
III - зона кристалізації на підкладці (зона росту).
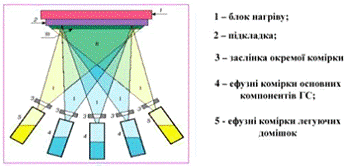
Рис. 3.6 Схема одержання
наноматеріалів методом молекулярно-променевої епітаксії
Зону росту можна умовно розділити на три частини, перша з яких представляє собою кристалічну підкладку або черговий вирощений моноатомний шар, другий - газову суміш компонентів ГС в приповерхневій області, а третє є перехідним шаром, геометрія якого і протікаючі в ньому процеси сильно залежать від вибору умов нарощування. Отже, якщо необхідно виростити ГС методом МПЕ, потрібно мати можливість належним чином регулювати структуру і склад перехідного шару. Для вирощування ідеальних кристалічних структур слід так підбирати режим нарощування, щоб перехідний шар був максимально тонким, тобто моноатомний. Ця умова може бути виконана, якщо потік атомів, падаючих на підкладку, близький до потоку атомів, що випаровуються з підкладки. У цьому режимі зростання структури здійснюється шляхом утворення і подальшого зростання двовимірних зародків на атомарно -плоскій поверхні.
Епітаксіальне нарощування методом МПЕ включає в себе елементарні процеси (рис. 3.7):
) адсорбція (прилипання) падаючих на підкладку атомів або молекул, складових вирощується з'єднання;
) міграція (поверхнева дифузія) адсорбованих атомів по поверхні підкладки (може передувати дисоціації молекул вирощуваного з'єднання);
) вбудовування атомів, складових ГС, в кристалічну гратку підкладки або зростаючий моноатомний шар;
) термічна десорбція атомів, не вбудовані в кристалічну гратку;
) утворення і подальше зростання двовимірних зародків кристала на підкладці або на поверхні зростаючого шару;
) взаємна дифузія атомів, вбудована
в кристалічну решітку.

Рис. 3.7 Елементарні процеси в зоні
росту: 1 - адсорбція атомів із зони змішування на поверхню, 2 - міграція
(поверхнева дифузія) адсорбованих атомів по поверхні, 3 - вбудовування
адсорбованих атомів в кристалічну гратку, 4 - термічна десорбція, 5 - утворення
поверхневих зародків, 6 - взаємна дифузія. Над зростаючою поверхнею показані
атоми газової суміші компонентів у приповерхневій області. Літерами n-n та i-i
показані нормальна і інвертована поверхні розділу зростаючої ГС. Область між
цими поверхнями являє собою квантову яму шириною L
Іонно-ковалентний характер і значна величина енергії хімічних зв'язків у напівпровідникових з'єднаннях А3В5 і А2В6 призводять до того, що в результаті адсорбції і міграції по поверхні атоми катіонів А і аніонів В заміщають цілком певні положення в кристалічній гратці, тобто за час зростання одного моноатомного шару (зазвичай за цей час ( ~ 1 с) атом здійснює декілька тисяч дифузійних стрибків, поки він не займе своє остаточне місце в гратці) відбувається своєрідна самоорганізація зростаючої структури.
Найбільш поширеною кристалічною
решіткою для з'єднань А3В5 і А2В6 є так звана структура цинкової обманки ZnS,
показана на рис. 3.8. Якщо поверхня підкладки паралельна одній з граней
елементарного куба з індексами Міллера (001), то епітаксіальне нарощування
здійснюється послідовним нарощуванням аніонних і катіонних шарів, як це
показано на рис. 3.7., де схематично представлена ГС
А1хGа1-xАs-GaAs, в якій шар арсеніду галію укладений між двома шарами твердого
розчину алюмінію (з атомної концентрацією х) в арсеніді галію . Алюміній ,
близький за своїми хімічними властивостями галію, заміщає атоми галію в гратці
GaAs, не приводячи при цьому до істотної зміни міжатомних відстаней.

Рис. 3.8 Кристалічна структура
цинкової обманки. Вгорі - проекція на площину (001), перпендикулярну осі росту.
Виділена грань елементарного куба в площині (001). Цифрами вказані атоми, що
заповнюють шар в площині (001), стрілки вказують послідовність шарів, як це
показано на малюнку внизу, де представлена проекція структури на площину (110)
Кожен напівпровідник (наприклад, GaAs або А1хGа1-xАs) може бути вирощений пошарово при фіксованій швидкості росту, коли температура підкладки забезпечує оптимальну для даного з'єднання швидкість поверхневої дифузії. Оскільки хімічні зв'язки в різних напівпровідникових з'єднаннях різні, то різні і енергії активації поверхневої дифузії катіонів, що входять до складу цих з'єднань. Тому якість гетерограниць може бути істотно різна залежно від того, яка з сполук при обраному температурному режимі зростає першою. Межі прийнято називати нормальними, якщо компонент з більш низькою температурою плавлення росте першим (наприклад, А1хGа1-xАs на GaAS); для зворотної послідовності використовується термін "інвертована границя". На рис. 3.7. проекції цих двох границь зображені лініями з літерними індексами n та i відповідно. Щоб отримати більш гладкі і досконалі гетерограниці, використовується методика переривання росту або методика осадження пульсуючим пучком. Згладжування поверхні протягом часу переривання росту (само переривання здійснюється механічним перекриттям на деякий проміжок часу засувок ефузних комірок) обумовлено поверхневою міграцією та/або сублімацією атомів, адсорбованих на поверхню вирощеного моношару.
Температура підкладки визначає співвідношення між потоками адсорбції і десорбції атомів, що входять до складу зростаючої структури. Це співвідношення може бути охарактеризоване коефіцієнтом прилипання атома даного сорту до поверхні, на якій відбувається епітаксіальне нарощування. Коефіцієнт прилипання показує, яка частина падаючого потоку адсорбується на поверхні. При адсорбції аніонного компонента, наприклад миш'яку при зростанні арсеніду галі , важливу роль відіграє те, в якій молекулярній формі (As2 або As4) аніонний компонент доставляється на поверхню, де відбуваються дисоціація молекул і подальше вбудовування атомів в кристалічну гратку.
Крім того, температура підкладки
визначає швидкість поверхневої дифузії, яка випереджає вбудовування атомів в
кристалічну гратку. Ця температура повинна бути досить високою, щоб забезпечити
необхідне число (~104) дифузійних стрибків атома на поверхні, перш ніж він
займе своє положення в гратці. При цьому середнє переміщення атома по поверхні
за чвс t визначається як
![]() , де
, де
![]()
коефіцієнт поверхневої дифузії.
Передекспоненційний фактор
![]()
де a - довжина дифузійного стрибка
(відстань між сусідніми еквівалентними положеннями атома на поверхні росту), T
- температура в енергетичних одиницях, ![]() 1012
с-1 - частота коливань атома на поверхні. Енергія активації поверхневої дифузії
1012
с-1 - частота коливань атома на поверхні. Енергія активації поверхневої дифузії
![]() в
напівпровідниках зазвичай становить 1-1,5 еВ, тому за одну секунду атом в
середньому зміщується на кілька десятків або сотень міжатомних відстаней при
температурі підкладки 600 - 800 ° C. Таке зміщення якраз і відповідає приблизно
104 дифузійним стрибкам.
в
напівпровідниках зазвичай становить 1-1,5 еВ, тому за одну секунду атом в
середньому зміщується на кілька десятків або сотень міжатомних відстаней при
температурі підкладки 600 - 800 ° C. Таке зміщення якраз і відповідає приблизно
104 дифузійним стрибкам.
Метод МПЕ - складний і дорогий для
експлуатації, його можна віднести до ексклюзивного. Для більшості
термоелектричних матеріалів не є обов’язковими упорядковані структури, тому для
їх реалізації пропонується використовувати парофазні методи: відкритого
випаровування, гарячої стінки, чи газодинамічного потоку.
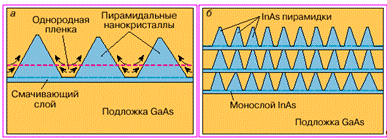
Рис. 3.9. Модель процесу росту
надграток квантових точок (механізм Странскі-Крастанова) а) - утворення
пірамідальних островків InAs в результаті трансформації плоских шарів цього
напівпровідника (пунктир), вирощуваних на підкладці GaAs із відмінними
параметрами гратки; б - система зв’язаних вертикально квантових точок InAs на
підкладці GaAs
.3
Наноструктури на основі PbTe
Телурид свинцю PbTe є одним із кращих термоелектричних матеріалів для середніх температур (450-800) К. Максимум ZT РbТе становить 0,7 при 700 К. Останнім часом ZT була подвоєна при 773 K у легованих талієм PbTe через підвищення коефіцієнту Зеєбека.
Використанням нанокомпозитів PbTe також можна досягнути високих ZT. Мікроструктура кульково подрібнених наночастинок представлена на (рис.3.9, а). Під час гарячого пресування, наночастинки швидко ростуть, і розмір зерна гарячоспресованого PbTe більший, ніж 1 мм (рис. 3.9, б). У порівнянні з властивостями злитків, теплопровідність гарячопресованих зразків незначно зменшується у всьому діапазоні температур (рис. 3.9, с), а електропровідність зростає (рис. 3.9, e). Коефіцієнт Зеєбека трохи зменшується при більш високих температурах (рис. 3.9, d), а ZT зростає (рис. 3.9, f). Нанокомпозити PbTe з 95% теоретичної густини отримують також при спіканні наночастинок (100-150) нм іскро-плазмовим методом.
Нанокомпозити PbTe підготовлені
спіканням порошків в об'ємні зразки показали невелике збільшення коефіцієнта
Зеєбека при значному параметрі розсіювання за рахунок фільтрації енергії
електронів. В окремому дослідженні об'ємні зразки телуриду свинцю були
підготовлені з надлишком Pb або Ag, які осаджували в PbTe матрицю. Ці зразки
показали чудове підвищення (до 100%) коефіцієнт Зеєбека, і одночасне збільшення
параметра розсіювання (який склав < 1 для сипучих і до 3-4 у зразках із
нановключеннями). Хоча природа збільшення параметра розсіювання не ясна, ефект,
ймовірно, є фільтрацією енергії електронів, що призводить до високого
коефіцієнта Зеєбека. З іншого боку, рухливість електронів була занадто низькою
і збільшення ZT не було отримано. Зовсім недавно у роботі підготовлено PbTe з
нановключеннями як Pb так і Sb одночасно, що призвело до значного підвищення
коефіцієнта потужності по відношенню до об'ємного PbTe. Зауважимо, що досі не
з'ясовно те що, коли концентрація Sb склала 3% і Pb 2% у нанокомпозиті,
рухливість електронів збільшувалася у температурному інтервалі від 300 K до 450
K.
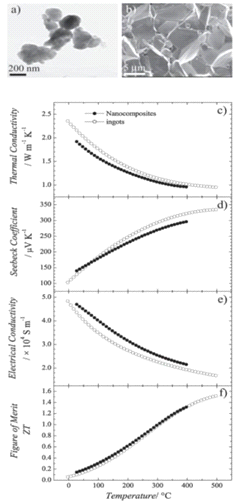
Рис. 3.10 ПЕМ - зображення кульково
подрібнених PbTe нанопорошків (а) і СEM (скануючий електронний мікроскоп) -
зображення гарячо-спресованих PbTe нанокомпозитів (b) та залежність від
температури теплопровідності (с), коефіцієнта Зеєбека (d), електропровідності
(е), і ZT(f) гарячо спресованих нанокомпозитів PbTe
ВИСНОВКИ
. На базі експериментальних даних для термоелектричних властивостей квантово-розмірних структур показано, що у таких системах має місце різке зниження граткової теплопровідності.
. Виходячи з теоретичних та експериментальних досліджень зафіксовано немонотонний осциляційний характер термоелектричної добротності квантово-розмірних напівпровідникових структур.
. Для розуміння шляхів покращення термоелектричної добротності основна задача на сьогодні полягає у розробці теоретичних моделей впливу квантово-розмірних ефектів на електронну і фононну підсистему наноструктур.
. Представлена характеристика
термоелектричних матеріалів та підкреслена перспективність матеріалів із
високими значеннями термоелектричної добротності.
СПИСОК ВИКОРИСТАНОЇ ЛІТЕРАТУРИ
1. A.I. Boukai, Y. Bunimovich, J. Tahir-Kheli, J.-K. Yu, W.A. Goddard III, J.R. Heath, Nature 451 (2008) 168-171.
. A.I. Hochbaum, R. Chen, R.D. Delgado, W. Liang, E.C. Garnett, M. Najarian, A. Majumdar, P. Yang, Nature 451 (2008) 163-167.
. T.C. Harman, P.J. Taylor, M.P. Walsh, B.E. La Forge, Science 297 (2002) 2229-2232.
. B. Poudel, Q. Hao, Y. Ma, Y. Lan, A. Minnich, B. Yu, X. Yan, D. Wang, A. Muto, D.Vashaee, X. Chen, J. Liu, M.S. Dresselhaus, G. Chen, Z. Ren, Science 320 (2008) 634-637.
. J. Androulakis, C.H. Lin, H.J. Kong, C. Uher, C.I. Wu, T. Hogan, B.A. Cook, T. Caillat, K.M. Paraskevopoulos, M.G. Kanatzidis, Journal of the American Chemical Society 129 (2007) 9780-9788.
. G.D. Mahan, Good Thermoelectrics, Solid State Physics, vol. 51, Academic Press, 1997, pp. 82-157.
. L.D. Hicks, T.C. Harman, X. Sun, M.S. Dresselhaus, Physical Review B 53 (1996) R10493-R10496.
. T.C. Harman, D.L. Spears, M.J. Manfra, Journal of Electronic Materials 25 (1996) 1121-1127.
. A. Casian, I. Sur, H. Scherrer, Z. Dashevsky, Physical Review B 61 (2000) 15965.
. A. Ishida, D. Cao, S. Morioka, M. Veis, Y. Inoue, T. Kita, Applied Physics Letters 92 (2008) 182105.
. G.S. Nolas, J. Sharp, H.J. Goldsmid, Thermoelectrics-Basic Principles and New Materials Development, Springer, New York, 2001.
. A.F. Ioffe, Semiconductor Thermoelements and Thermoelectric Cooling, Infosearch Ltd., London, 1957.
. C. Kittel, Introduction to Solid State Physics, John Wiley, New York, 1996.
. H. Kroemer, C. Kittel, Thermal Physics, W.H. Freeman and Co., New York, 1980.
. C.B. Vining, Nature Materials 7 (2008) 765-766.
. D.G. Cahill, S.K. Watson, R.O. Pohl, Physical Review B: Condensed Matter 46 (1992) 6131-6140.
. M.M. Koza, M.R. Johnson, R. Viennois, H. Mutka, L. Girard, D. Ravot, Nature7 (2008) 805-810.
. B.C. Sales, B.C. Chakoumakos, D. Mandrus, Physical Review B 61 (2000) 2475
. R.P. Hermann, F. Grandjean, G.J. Long, American Journal of Physics 73 (2005) 110-118.
. M. Christensen, A.B. Abrahamsen, N.B. Christensen, F. Juranyi, N.H. Andersen, K.Lefmann, J. Andreasson, C.R.H. Bahl, B.B. Iversen, Nature Materials 7 (2008) 811- 815.
. A.A. Balandin, Journal of Nanoscience and Nanotechnology 5 (2005) 1015-1022.
. X. Lu, Applied Physics Letters 104 (2008) 054314
. E.T. Swartz, R.O. Pohl, Reviews of Modern Physics 61 (1989) 605-668.
. P. Kim, L. Shi, A. Majumdar, P.L. McEuen, Physical Review Letters 87 (2001)
.
. H. Maune, H.-Y. Chiu, M. Bockrath, Applied Physics Letters 89 (2006) 013109.
. R.S. Prasher, Physical Review B 77 (2008) 075424.
. R.S. Prasher, Applied Physics Letters 89 (2006) 063121.
. R.S. Prasher, Applied Physics Letters 89 (2006) 063121.
. L.J. Lauhon, M.S. Gudiksen, D. Wang, C.M. Lieber, Nature 420 (2002) 57-61.
. P. Carruthers, Reviews of Modern Physics 33 (1961) 92-138