Материал: Введение в нанотехнологии (Рыбалкина), c.87

Многим известно, что основой первых ЭВМ служили электронные лампы, и что их производительность была крайне мала, а габариты и сложность обслуживания – чрезвычайно велики. Создание первых ИМС или планарных транзисторов (от англ. "planar" - плоский), имело революционное значение и привело к созданию микропроцессоров, что дало толчок бурному росту индустрии информационных технологий.
Удивительной особенностью транзисторов является то, что увеличение их производительности сопровождается уменьшением размеров. Современные транзисторы в 20 раз быстрее и в 100 с лишним раз меньше, чем те, что выпускались два десятилетия назад. Но для того, чтобы транзисторы продолжали уменьшаться в размерах, необходимо постоянное совершенствование методов литографии.
Чтобы убедиться в этом, рассмотрим вкратце технологию "выращивания" интегральной микросхемы (ИМС). Этот процесс происходит в несколько этапов:
1. Подготовка подложки.
Подложкой для микросхемы является полупроводниковая пластина из кристалла кремния (Si) - самого распространенного полупроводника на Земле. Для этой цели применяется химически чистый кремний, который переплавляется в большие цилиндрические заготовки. После множества дополнительных химических чисток монокристалл кремния разрезается на тончайшие пластины, которые в будущем послужат подложкой для изготовления процессоров.
Очищенная кремниевая пластина подвергается так называемому оксидированию (или окислению) - воздействию на заготовку кислородом, которое происходит под высокой температурой (1000°C). Таким образом, на поверхности заготовки создается тончайший слой диоксида кремния SiO2. Регулируя время воздействия кислорода и температуру кремниевой подложки, можно легко сформировать слой оксида нужной толщины. Диоксидная пленка отличается очень высокой химической стойкостью, большой механической прочностью и обладает свойствами хорошего диэлектрика, что обеспечивает надежную изоляцию расположенного под ним кремния и защищает его от нежелательных воздействий в ходе дальнейшей обработки.
2. Если некоторые области кремния, лежащие под слоем диоксида, необходимо подвергнуть обработке, то слой оксида необходимо предварительно удалить с соответствующих участков. Выделение таких участков на кремниевой подложке выполняется с помощью процесса, получившего название литографии. Целью этого процесса является перенос рисунков с фотошаблонов на поверхность пластины с тем, чтобы в дальнейшем создать на ней необходимые слои.
Рис а. Исходная полупроводниковая пластина с проводимостью р-типа, покрытая слоями SiO2, и фоторезиста;
26
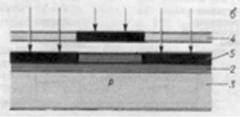
1- слой фоторезиста,
2- слой SiO2(диоксид кремния)
3- полупроводниковая пластина,
Для этого на диоксидную пленку наносится слой фоторезиста (см. рис. а). Фоторезист – это светочувствительный материал, который после облучения становится растворимым в определенных химических веществах. Различают два типа фоторезиста - позитивный и негативный. Позитивные фоторезисты передают рисунок фотошаблона один к одному, негативные - формируют негативное изображение фотошаблона.
Фотошаблон представляет собой пластинку, состоящую из прозрачных и непрозрачных участков, и выполняет роль трафарета.
3. Третьим шагом при создании ИМС является экспонирование – пластина с наложенным на неё фотошаблоном подвергается облучению потоком соответствующего излучения. В результате экспонирования фоторезист, расположенный под "окнами" фотошаблона (прозрачными участками) засвечивается.
В результате засвеченный слой, чьи структура и химические свойства изменились под действием излучения, а также находящийся под ним слой диоксида кремния могут быть удалены с помощью химикатов (каждый слой - своим химикатом). См. рис. Б.
Рис б. Облучение фоторезиста через фотошаблон;
2- слой SiO2(диоксид кремния)
3- полупроводниковая пластина,
4- фотошаблон,
5- засвеченный участок фоторезиста,
4.Процесс удаления облученного фоторезиста и диоксидной пленки называется травлением. Этот процесс необходим для того, чтобы вскрыть окно для доступа к материалу подложки. Травление может быть химическим "жидкостным" или плазменным "сухим". Химическое жидкостное травление основано на растворении химическими веществами не защищенных фоторезистивной маской участков образца. Более эффективными являются "сухие" методы обработки, основанные на взаимодействии газозарядной плазмы с поверхностным слоем материала. Различают ионное травление, ионно-химическое травление и плазмохимическое травление.
Результатом процесса травления является полное удаление материала на участках, не защищенных фоторезистом. (рис. в.)
27

Рис в. Кремниевая пластина с "окном" в слое SiO2 , образовавшимся в результате облучения и последующего травления;
2- слой SiO2(диоксид кремния)
3- полупроводниковая пластина,
5.Заключительным этапом формирования микросхемы являются процессы
эпитаксии, диффузии и металлизации.
Эпитаксиальным процессом или эпитаксией называется ориентированное наращивание слоев вещества с воспроизведением кристаллической структуры подложки. Эпитаксиальное выращивание производят в особом реакторе. Если наращиваемые слои по составу не отличаются (или незначительно отличаются) от материала подложки, то говорят о гомоэпитаксии или автоэпитаксии. Процесс ориентированного наращивания эпитаксиальных слоев, существенно отличающихся по составу от вещества подложки, называют гетероэпитаксией. Эпитаксиальное выращивание позволяет создавать атомные слои, равномерно легированные (введенные в кремний) по пластине.
Диффузия является тем процессом, который чаще всего используют для направленного изменения параметров р- и n-областей пластин, предварительно подготовленных в процессе литографии. Для диффузии в кремний в качестве акцептора используется бор (B), а в качестве доноров - фосфор (P) и мышьяк (As). Процесс заключается в нагреве пластины до температуры, не превышающей температуру плавления и внедрении вглубь пластины примесей (бор, фосфор, мышьяк) в виде ионов с высокой энергией.
Рис в. Выращивание на поверхности пластины эпитаксиального n-слоя с помощью диффузии донорных примесей
2 - слой SiO2(диоксид кремния)
3 - полупроводниковая пластина,
6 - донорные атомы.
Процесс металлизации завершает изготовление ИМС. В ходе этого процесса осаждаются тонкие металлические пленки из алюминия, золота или никеля, которые образуют электрические соединения между активными областями и приборами, размещенными на кристалле. Слой металла еще раз подвергается методу литографии и травления, подобно описанному выше, в результате которой от всего
28
слоя металлизации остаются лишь токопроводящие линии и контактные площадки – те, что мы можем наблюдать на любой микросхеме.
Итак, процесс изготовления микросхем включает несколько технологических этапов: очистка, окисление, литография, травление, диффузия, осаждение, измерения. Очевидно, что для дальнейшего усовершенствования микроэлектроники, т.е. увеличения производительности за счет уменьшения размеров чипов (микросхем), ключевым моментом является именно усовершенствование методов литографии.
Очевидно, что для этого толщина линий, наносимых световым пучком на поверхности фоторезиста в момент формирования "рисунка" микросхемы, должна стремиться к уменьшению. То есть должна уменьшаться длина волны, поскольку именно она ограничивает точность операций вследствие явлений дифракции. Первоначально засветка производилась излучением с длиной волны, примерно соответствующей видимому свету - чуть более 1 микрона. Толщина линий, формируемых при помощи такого процесса, была больше, чем длина волны излучения.
Впоследние годы стандартными стали длины волн 435 и 365 нм соответственно. При помощи источника излучения с длиной волны 365 нм вычерчиваются линии толщиной до 0,35 микрон, что почти соответствует длине волны. Затем благодаря переходу на источники, действующие в спектре глубокого УФ-излучения (DUV-литография "Deep Ultra Violet"), с длиной волны 248 нм. Сейчас полупроводниковая промышленность переходит на 0,18-микронную литографию. Достижение топологических размеров в 100 нм и меньше, таким образом, потребует уменьшения длины волны излучения, возможно за счет применения принципиально новых источников.
Внастоящее время интенсивно ведутся исследования технологии, названной EUV-литографией (Extreme Ultra Violet) – литография в спектре жесткого ультрафиолета. Считается, что эта технология станет достойным приемником DUVлитографии уже к 2005-2006 году. Процесс производства по технологии EUVлитографии обеспечит толщину линий проводников в 0,07 микрон (70 нм), что примерно в тысячу раз меньше толщины человеческого волоса.
EUV-литография является обычной оптической литографией, но с использованием излучения с длиной волны 11 - 14 нм и отражательными оптикой и фотошаблонами.
Оптическая система (один из ее вариантов представлен на рисунке) содержит набор зеркал между источником света и маской.
29
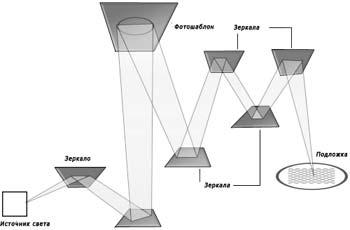
Набор зеркал между маской и подложкой с резистивным обеспечивает уменьшение размера изображения в 4 раза позволяет рисовать линии с разрешением до 70 нм.
Чтобы дать наглядное представление о преимуществах EUV-литографии, приведем несколько примеров:
•EUV-технология ведет к появлению микропроцессоров в 30 раз быстрее существующих. Процессор в 10 ГГц, например, будет настолько быстрым, что, например, за время, за которое человек успевает только моргнуть (около 1/50 секунды), он сможет произвести порядка 400 млн. вычислений.
•EUV-литография предназначена для печати на кремниевой подложке элементов размером 0,07 мкм (70 нм) и менее. Это все равно как печатать изображение размером с двухрублевую монету на поверхности Земли с космического корабля, а затем поверх него печатать другую картинку, четко совмещая их между собой. На одном кристалле соли (с ребром 0,25 мм) разместилось бы около 3600 таких 70-нанометровых элементов.
•Сегодняшние литографические установки с применением глубокого ультрафиолетового излучения (DUV) - машины, используют источники света с длиной волны 248 нм. Длина волны EUV-излучения около 13 нм, т.е. примерно в 20 раз меньше. Для сравнения, длина волны видимого света находится в диапазоне от 400 до 700 нм.
•Элементы, нанесенные с помощью EUV- и DUV-литографии, примерно так же отличаются друг от друга, как две одинаковые линии, проведенные на бумаге шариковой ручкой (EUV) и маркером (DUV).
Переход к EUV литографии позволит перейти 100 нм рубеж, оставаясь в рамках традиционной фотолитографии. Однако сложная зеркальная оптика и дорогостоящая технология изготовления фотошаблонов делает такой подход исключительно дорогостоящим и оставляет место для разработки литографических процессов основанных на иных физических принципах.
Мягкая литография.
Обычная фотолитография прекрасно зарекомендовала себя в случае, когда необходимо разместить как можно большее количество элементов на маленькой
30