Материал: UnEncrypted

термообробки, або перед нею іонами високої енергії (10-100 кеВ), низькоенергетичними іонами або нейтральними частинками (до 5 кеВ). Глибина проникнення домішки з поверхневого джерела залежить від тривалості бомбардування t, енергії іонів і інтенсивності опромінювання.
Розподіл концентрації домішок при радіаційно-стимулюючій дифузії визначається виразом
, |
(9.17) |
де  – поверхнева концентрація;
– поверхнева концентрація; 

 – дифузійна довжина пробігу дефекту;
– дифузійна довжина пробігу дефекту;  – коефіцієнт дифузії залежний від надмірної
– коефіцієнт дифузії залежний від надмірної  відносно термічно рівноважної
відносно термічно рівноважної  концентрації коефіцієнта дифузії вакансій
концентрації коефіцієнта дифузії вакансій .
.
Технологія радіаційно-стимулюючої дифузії проводиться при температурах 600-700°С, що значно нижче за температури високотемпературної дифузії. При цьому напрям дифузійного потоку визначається не градієнтом домішки в пластині, а розташуванням шару порушень, створюваних іонним променем, а швидкість генерації дефектів визначається не температурою, а параметрами іонного променя. В результаті велика частина введеної домішки знаходиться у вузлах кристалічних граток в електрично активному стані.
Радіаційно-стимулююча дифузія дозволяє одержувати леговані шари з різним профілем розподілу концентрації домішок – експоненціально затухаючої або майже прямокутної форми. Даний метод дифузії найбільш доцільний при легуванні напівпровідникових з'єднань, а також напівпровідників, в яких дифузія відбувається при дуже високих температурах.
9.5 Іонне легування напівпровідників
Мікроелектронні структури можна одержувати за допомогою електронного і іонного променів (пучків). Таку технологію називають еліонною, а всі питання, що відносяться до її реалізації – еліонікою.
Еліонну технологію застосовують для різних видів оброблення – мікрофрезерування (гравіювання, літографії), мікрозварювання, різці, створення р-n-переходів і ін., а також для інтенсифікації фізико-хімічних процесів, що відбуваються на поверхні напівпровідникової або діелектричної підкладки, десорбції, полімеризації, конденсації, деструкції і т.д.
Найбільш широко використовують еліоніку в технології напівпровідникових ІМС для локального легування напівпровідників, заснованого на іонному впровадженні домішок.
Сутність іонного легування полягає в такому. Іони домішки, одержувані із спеціальних джерел, швидшають і фокусуються в електричному полі, потрапляють на підкладку, бомбардуючи її. Маючи
140
велику енергію (10-103 кеВ), вони впроваджуються в поверхневий шар напівпровідника. При впровадженні в кристалічні гратки іони втрачають свою енергію внаслідок кулонівської взаємодії з атомами гратки, порушуючи або іонізуючи їх, так і через пружні (ядерних) зіткнення з атомами, в результаті яких утворюється велике число точкових дефектів гратки (міжвузлові атоми підкладки і вакансії). В загальному випадку при іонному впровадженні атоми домішки частково займають певне положення в гратках, а частково підпорядковане. Для впорядкування порушеної упровадженням іонів структури і тим самим створення електрично активної домішки підкладки піддають відпалу при температурі 650—700°С. Застосовують також лазерний відпал.
Таким чином, процес іонного легування складається з впровадження іонів і відпалу, одночасного з упровадженням або після нього.
Характерною особливістю іонного легування є те, що зміст упроваджених атомів домішки визначається не фізичними властивостями підкладки (як при дифузії), а умовами впровадження іонів і температурою відпалу, яка значно нижча, ніж при дифузії.
Іонне легування створюється на установці, схема якої показана на рис. 9.4. Джерело іонів 1 складається з камери, призначеної для іонізації пари легуючих елементів, і екстрагуючого іони зонда. Іонізація проводиться у високочастотному або дуговому розряді. Початковими матеріалами для отримання іонів фосфору і бору, які в основному використовують при легуванні кремнію, є червоний порошкоподібний або кристалічний фосфор і галогеніди бору. Речовину у вигляді твердої фази завантажують в тигель джерела, а пари галогенідів поступають в джерело через натікач.
Екстраговані за допомогою негативно зарядженого зонда додатні іони концентруються і фокусуються в пучок з густиною до 100 А/м2 . Під дією напруги прискорювальної системи 2 (20-200 кВ) іонні пучки набувають необхідної енергії, достатньо потужної для іонного впровадження.
141
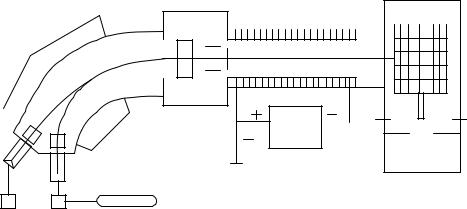
С М
 ВЗ
ВЗ
IФ
 IБ
IБ
Н МН БФ3
ПК
УТ Б ФС 

З
Д
ІН 

 ВС
ВС
Рисунок 9.4 – Схема установки іонного легування напівпровідників
Магнітний мас-сепаратор 3 служить для виділення іонів потрібної маси, що досягається розділенням руху частинок по різних траєкторіях у відповідності з їх масами під впливом магнітного поля. Сепарація за масами обумовлює високу чистоту легування.
Система сканування 4 забезпечує керування потоком іонів по поверхні підкладок, встановлених в багатопозиційному приймачі іонів 5. Щоб уникнути зіткнень іонів при русі в установці підтримується вакуум
(54·10-5 – 14·10-4 Па).
Установки даного типу забезпечують отримання легованих тонких шарів кремнію з глибиною залягання р-n-переходів 0,2—0,4 мкм, для чого необхідна доза іонного легування складає 10 –15 см-2, причому упровадження іонів здійснюється як в умовах нагріву підкладки, так і при кімнатній температурі з подальшим відпалом.
Ефективність застосування іонного легування визначається багатьма чинниками, головними з яких є: розподіл пробігів упроваджених атомів, ступінь і характер безпорядковості гратки, локалізація атомів в кристалічних гратках і електричні властивості шарів після упровадження і відпалу.
Основні переваги іонного легування:
− можливість точного завдання конфігурації розподілу концентрації домішки як за глибиною, так і за площею опромінювання.
При цьому градієнт концентрації домішки в області р-n-переходу істотно більший, ніж у дифузійного профілю;
− здійснення процесу при низьких температурах (біля 600 – 800°С для відпалу), що дозволяє зберігати заданий профіль розподілу концентрації домішок в структурах і їх електрофізичні параметри;
142
−можливість легування кремнію і інших напівпровідників будьякими легуючими домішками в різних кількостях, аж до граничної розчинності;
−отримання ізотопної чистоти іонів легуючої домішки, сепарованих в магнітному полі;
−відсутність впливу навколишнього середовища, оскільки процес здійснюється у вакуумі;
−висока відтворність результатів завдяки точному контролю інтенсивності пучка і дози впроваджуваних іонів;
−можливість здійснення на одній установці комплексу операцій, включаючи легування, металізацію і захист поверхні.
Недоліки іонного легування – складність технологічних установок і можливість утворення дефекного шару на поверхні підкладок.
Іонне легування використовують для створення біполярних транзисторів НВЧ-діапазону, МДН-транзисторів із затвором, що самопоєднується, діодів, високоомних резисторів і інших елементів напівпровідникових ІМС.
9.6 Епітаксійне нарощування напівпровідникових шарів
Епітаксією називають орієнтоване зростання шарів, кристалічна гратка яких повторює структуру підкладки.
У мікроелектроніці на явищах епітаксії засновані технологічні процеси епітаксійного нарощування різних напівпровідникових структур.
Методи отримання. Механізм орієнтованого зростання монокристалічних шарів залежить від технологічного методу. Використовують три основні технологічні методи: газофазні реакції, вакуумне осадження і кристалізацію з рідкої фази.
При виготовленні епітаксійних напівпровідникових структур застосовують в основному газофазні реакції, наприклад, для епітаксійного синтезу – реакції відновлення хлоридів германію і кремнію,
головним чином тетрахлоридів ( GeCl4 , SiCl4 ), гідрогеном до чистих
елементів, що осідали в монокристалічній затравці, а також йодидний процесс – осадження на затравку плівок германію і кремнію з парів
йодидів ( GeJ2 , SiJ2 ) у результаті реакції диспропорціонування.
Епітаксійне нарощування є одним з видів синтезу монокристалів і тому має багато спільного із вирощуванням кристалів з розчину або розплаву. Домінуючим чинником, що впливає на епітаксійне вирощування, є поверхнева рухливість обложених атомів. Вирощування кристала з газової фази відбувається швидше, ніж з розбавленого розчину, але повільніше, ніж з чистого розплаву. Швидкість росту, тобто лінійний
143

приріст товщини плівки, складає декілька сантиметрів на добу. Вирощування монокристала складається з трьох основних етапів:
−переносу пари до поверхні підкладки (приманки);
−кристалізації і зростання нових шарів на поверхні підкладки;
−розсіяювання прихованої теплоти кристалізації і теплоти реакції, що звільняється.
Міграція атомів, що осіли на поверхні, приводить до виникнення стійких зародків кристалізації. Внаслідок теплових коливань деякі атоми можуть відірватися від зародків. Вірогідність відриву тим більша, чим менше насичених зв'язків у атомів, що осіли. Енергія їх зв'язку з гранями кристала, що ростуть, пропорційна числу суміжних сторін. Нарощування епітаксійного шару відбувається уздовж поверхні, шар, що росте, повторює морфологію підкладки. Якщо підкладка і плівка, що росте, складаються з однієї речовини, то процес називають автоепітаксійним, якщо з різних – гетероепітаксійним. Залежно від співвідношення питомого опору шару

і підкладки r v розрізняють пряму ( ) і зворотну (
) і зворотну ( ) епітаксії.
) епітаксії.
За допомогою автоепітаксії в технології мікроелектроніки створюють тонкі монокристалічні шари кремнію, леговані необхідною домішкою до потрібної концентрації, в яких формуються активні і пасивні елементи ІМС. Гетероепітаксія дозволяє одержувати гетеропереходи, які мають специфічні електрофізичні властивості. Епітаксійне нарощування напівпровідникових шарів спільно з дифузією домішок використовують для отримання транзисторних структур напівпровідникових ІМС. Застосування методів епітаксійного нарощування шарів в технології напівпровідникових ІМС дає такі переваги:
а) отримання монокристалічних шарів напівпровідників із заданою орієнтацією кристалографічних осей;
б) рівномірний розподіл домішок в шарах (при використовуванні тільки дифузії домішок це практично неможливо);
в) лише дві стадії дифузії при отриманні чотиришарових транзисторних структур в інтегральних мікросхемах;
г) отримання транзисторних структур з кращими, ніж потрійна дифузія характеристиками і спрощення операцій з ізоляціії елементів р-n- переходами;
д) скорочення тривалості операцій, отримання транзисторних структур (швидкість росту епітаксійних плівок відносно висока).
Всі методи епітаксійного нарощування напівпровідникових шарів прийнято поділяти на прямі і непрямі. В прямих методах частинки напівпровідника переносяться від джерела до підкладки без проміжних хімічних реакцій шляхом випаровування з рідкої фази, сублімації, реактивного розпилювання. В непрямих методах атоми напівпровідників
144