Материал: TTE_Lect1

Рисунок 3.3 – Вольт-фарадна характеристика р-n-переходу
Дифузійна ємність зумовлена здебільшого процесами інжекції. Зміну заряду неосновних носіїв стосовно рівноважного рівня біля переходу при зміні прямої напруги можна розглядати як прояв деякої ємності
C |
диф |
|
dQінж |
, |
(3.6) |
|
|||||
|
|
dUпр |
|
||
де Qінж - величина інжектованого заряду.
Величина цієї ємності може бути розрахована за формулою
|
|
qП |
|
Uпр |
|
|||
|
|
|
|
|
|
|
||
Cдиф |
|
(Lnnp0 |
Lp pn0 )e T . |
(3.7) |
||||
|
||||||||
|
|
T |
|
|
|
|
||
Як правило, при прямому ввімкненні р-n-переходу враховують лише дифузійну ємність, тому що бар’єрна ємність становить одиниці пікофарад, а дифузійна – десятки нанофарад.
Ємності переходу враховують при складанні його
еквівалентної схеми (рисунок 3.4). На схемі r1- розподільний опір р-
та n- областей, rn - поверхневий опір (для струмів поверхневого
витоку), rg T / Iпр -диференційний опір переходу.
26

Рисунок 3.4 – Еквівалентна схема р-n-переходу
Для кімнатної температури (Т=300К) справедлива формула
Шоклі |
|
26 |
|
|
|
|
|
r |
|
, |
|
(3.8) |
|
|
Iпр |
|
||||
|
g |
|
|
|
|
|
де Iпр |
подають у міліамперах. |
|
|
|
|
|
|
При прямому вмиканні р-n-переходу Cдиф Cбар |
rgпр |
r1 , |
|||
тому |
еквівалентна схема набуває |
вигляду - рисунок |
3.5,а. |
При |
||
зворотному Cдиф Cбар rgзв r1 , і спрощена еквівалентна схема переходу має вигляд - рисунок 3.18,б.
Рисунок 3.5 – Еквівалентна схема р-n-переходу: а) при прямому вмиканні ; б) при зворотному вмиканні
3.1.3 |
Реальна ВАХ р-n-переходу |
|
Під |
час |
розгляду теоретичної ВАХ р-n-переходу не |
враховувалися термогенерація носіїв у запірному шарі, поверхневі струми витоку, падіння напруги на опорах нейтральних областей НП, а також явище пробою при певних зворотних напругах. Тому реальна
27

ВАХ переходу істотно відрізняється від теоретичної (рисунок 3.6).
Рисунок 3.6 – Різниця між реальною та теоретичною ВАХ р-n- переходу
3.1.4 Пробої p-n - переходу
При деяких досить великих Uзв на зворотній гілці реальної
ВАХ з’являється ділянка пробою р-n-переходу. Явище пробою полягає в різному зростанні зворотного струму. Існує 4 різновиди пробою: лавинний, тунельний, тепловий та поверхневий.
При лавинному пробої (рисунок 3.6, крива 2) відбувається ударна іонізація нейтральних атомів збідненого шару НП неосновними носіями заряду, що розвивають під час вільного пробігу достатню кінетичну енергію. Іонізація приводить до лавинного
помноження вільних носіїв і до зростання Iзв . Оскільки умовою лавинного пробою є те, що довжина вільного пробігу електрона має
бути значно меншою від товщини р-n-переходу ( Ln ), такі
пробої найбільш імовірні для широких переходів, коли НП леговано невеликою кількістю домішок.
Тунельний пробій (рисунок 3.6, крива 1) виникає у вузьких р-n-переходах (при великих концентраціях домішок у НП), коли напруженість зовнішнього електричного поля в кремнію досягає
10В/см, а в германію -3 105 В/см. Під дією сильного поля валентні електрони вириваються з ковалентних зв’язків, створюються пари
“електрон-дірка”, зростає Iзв . Для дуже вузьких переходів величини
28
напруг пробою можуть бути невеликими.
Тепловий пробій (рисунок 3.6, крива 3) спричинюється
явищем самоперегріву НП. Воно полягає в тому, що збільшення Iзв
приводить до зростання температури в переході; це, у свою чергу, зумовлює додаткову термогенерацію носіїв, зростає струм і, нарешті, перехід перегрівається, кристалічна решітка руйнується. Тому пробій такого виду є необоротним і стає можливим при порушенні режиму охолодження. Ділянка АВ з негативним диференційним опором зумовлена тим, що збільшення кількості носіїв заряду веде до зменшення опору р-n-переходу і спад напруги на ньому.
Поверхневий пробій може виникнути в місцях виходу р-n- переходу на поверхню НП, в яких створюється додатковий електричний поверхневий заряд, що значно спотворює картину поля в переході. Якщо товщина переходу біля поверхні менша від товщини переходу в глибині НП, то поверхневий пробій відбувається при менших напругах, ніж звичайно. Цю особливість необхідно враховувати при виборі захисних покриттів напівпровідникових приладів.
3.1.5 Різновиди електричних переходів та контактів
Крім р-n-переходів, у напівпровідникових приладах використовують й інші переходи та контакти. Розглянемо деякі з них.
3.1.5.1 Гетеропереходи Гетероперехід створюється двома НП, які відрізняються
шириною забороненої зони. До таких переходів належать переходи германій-арсенід галію, арсенід галію – миш’яковий індій, германійкремній. Розрізняють n- р- та р-n-гетеропереходи (на першому місці ставиться буква, що означає тип електропровідності НП з більш вузькою ЗЗ).
Енергетична діаграма n- р- гетеропереходу германій n-типу
( Wn 0.72eB ) - арсенід галію р- типу ( Wn 0.72eB ) наведена на рисунку 3.7.
29
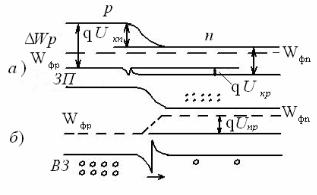
Рисунок 3.7 – Енергетична діаграма n- р- гетеропереходу в стані рівноваги (а) і при прямому вмиканні(б)
При відсутності зовнішньої напруги (U =0) і з’єднанні напівпровідників відбувається перерозподіл носіїв заряду, внаслідок чого вирівнюються рівні Фермі р- та n-областей і виникають
потенціальні бар’єри: для електронів n-області - qUKn , для дірок р-
області-qUKp , причому UKn >UKp (рисунок 3.7,а). Оскільки бар’єри
для електронів і дірок відрізняються, то під дією зовнішньої прямої напруги гетероперехід забезпечує односторонню ефективну інжекцію дірок з матеріалу, що має більшу ширину ЗЗ (рисунок 3.7,б). Цю особливість називають явищем над інжекції, що робить гетероперехід ефективним інжектором.
3.1.5.2 P p та n n переходи
P - p -переходи ( n -n-переходи) - це контакти двох НП
одного типу електропровідності, але з різною концентрацією домішок. Знаком “+” позначають НП з більшою концентрацією акцепторів чи донорів.
У таких переходах носії з області більшої концентрації переходять до області з меншою концентрацією. Внаслідок цього в області з більшою концентрацією домішок створюється деяка кількість іонізованих атомів домішок, а з протилежного боку переходу зростає надлишок основних носіїв. Виникає дифузійне електричне
30