Материал: Rozrakhunkovo_grafichna_robota
 ,
,
де NaCdTe, NdZnS – концентрації донорів і акцепторів у відповідних матеріалах.
Після розрахунку вказаних фізичних величин приступити до побудови зонної діаграми гетеропереходу в рівноважному стані. При цьому врахувати, що при приведені напівпровідників у контакт, положення рівня Фермі у матеріалах стає однаковим (рис.5).
Побудову проводити або з використанням міліметрового паперу або будь-якого графічного редактора.
Для розрахунку темнової ВАХ реального гетеропереходу використати співвідношення, що давалися у лекційному курсі та наведені у довідниковій частині методичної вказівки. Для цього спочатку розрахувати ni, Uk, Js, Is.
Всі розрахунки проводити в системі СІ.
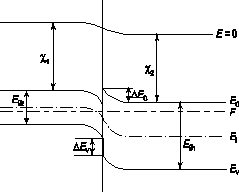
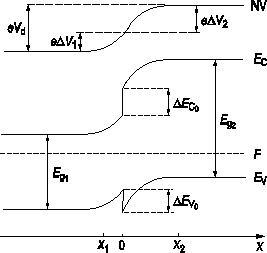
Рис. 5. Зонна діаграма гетеропереходів p-Ge – n-GaAs та n-Ge – p-GaAs в рівноважному стані
Зміст завдання 2
Побудувати світлову ВАХ фотоелектричного перетворювача при температурі вказаній у таблиці 6 за номером 2. Знайти його напругу холостого ходу, струм короткого замикання, фактор заповнення ВАХ та ККД. Умова освітлення АМ1 для варіантів 1-10 та AM0 для варіантів 11-20.
Методичні вказівки до завдання 2
Беручись за виконання завдання 2 слід згадати, що світлова ВАХ сонячного елементу зсунута відносно темнової за струмом на величину світлового струму Isc = IL.
Коефіцієнт корисної дії фотоперетворювача розраховується за формулою
=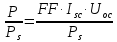 , (10)
, (10)
де Рs – потужність сонячного випромінювання, що падає на сонячний елемент; FF – фактор заповнення ВАХ (коефіцієнт форми ВАХ), який дорівнює (рис. 6).
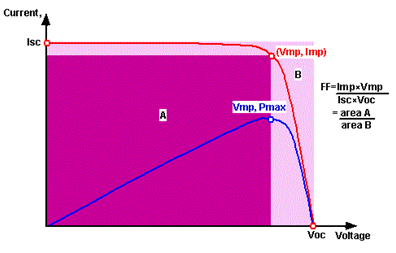
Рис.6. Визначення фактора заповнення FF ВАХ сонячного елементу
FF
=
 , (11)
, (11)
де Im та Um – густина струму та напруга, що відповідають найбільшій потужності приладу.
Звідси вихідна потужність фотоперетворювача дорівнює
P
= IU =
 .
(12)
.
(12)
Положення точки максимальної потужності на ВАХ можна знайти прийнявши, що dP/dU = 0 (умова екстремума функції) (рис. 6).
Звідси отримаємо значення струму та напруги у цій точці

 ,
(13)
,
(13)

 ,
(14)
,
(14)
де
= .
.
Таким чином, максимальна вихідна потужність фотоперетворювача визначається співвідношенням

 .
(15)
.
(15)
Густина фотоструму, що виробляється сонячним елементом визначається шириною забороненої зони поглинаючого матеріалу, його квантовим виходом та деякими іншими конструктивними особливостями приладу.
JL(Eg)
= q ,
(16)
,
(16)
де JL - густина фотоструму; - коефіцієнт поглинання світла матеріалом, який залежить від v; Q – квантовий вихід (число електронно-діркових пар, що утворюються в матеріалі при падінні на нього одного фотона світла).
Нижня межа інтегрування може бути знайдена з виразу h = Eg, де Eg – ширина забороненої зони поглинаючого матеріалу.
У першому наближенні можна вважати що сонце випромінює енергію як абсолютно чорне тіло з температурою Т = 5900 К. Добре відомо, що випромінювальна здатність абсолютно чорного тіла задається співвідношенням
f(,
T) =
 ,
(17)
,
(17)
Підставивши цей вираз у співвідношення (16) остаточно знайдемо значення світлового струму фотоперетворювача
IL(Eg)
= JLS
= q .
(18)
.
(18)
Отриманий вираз дозволяє знайти фотострум сонячного елемента на основі будь-яких напівпровідникових матеріалів.
На щастя густина струму фотоперетворювачів на основі шарів CdTe давно розрахована і дорівнює JL = 26 мА/см2 в умовах освітлення АМ1.
Повна потужність випромінювання сонця в умовах АМ1 на широтах, що відповідають місту Суми (сонце в зеніті), складає Рs = 925 Вт/см2, в умовах АМ2 (кут падіння сонячного випромінювання на поверхню землі 600) – 691 Вт/см2.
5 Довідниковий мінімум Основні формули, що використовуються у ргр
|
Nc
|
– ефективна густина станів у зоні провідності напівпровідника; |
|
N
|
– ефективна густина станів у валентній зоні напівпровідника, де mn, mp – ефективні маси електронів і дірок; k – стала Больцмана; T – температура; h – стала Планка; |
|
|
– концентрація носіїв заряду у власному напівпровіднику, де Eg - ширина забороненої зони матеріалу; |
|
n
= Nc |
- концентрація носіїв заряду у електронному напівпровіднику; |
|
p
=N |
концентрація носіїв заряду у дірковому напівпровіднику, де EF - положення рівня Фермі; |
|
np
= |
– закон діючих мас |
|
Uk
= Eg
-
|
|
|
Eg
-
|
- Uk – контактна різниця потенціалів на p-n – переході; Nd, Na – концентрації донорних та акцепторних домішок у матеріалі; q - заряд електрона |
|
φт
=
|
- температурний потенціал; |
|
|
- ширина збідненої області на переході з боку електронного матеріалу; U – прикладена зовнішня напруга |
|
|
- ширина збідненої області на переході з боку діркового матеріалу; |
|
E(x)
= -
|
- розподіл напруженості електричного поля вдовж переходу, n- область |
|
E(x)
= -
|
- розподіл напруженості електричного поля вдовж переходу, р- область |
|
|
- максимальне значення напруженості електричного поля на p-n переході |
|
|
- розподіл потенціалу електричного поля вдовж переходу, n- область |
|
|
- розподіл потенціалу електричного поля вдовж переходу, р- область |
|
|
- зв'язок між потенціалом та контактною різницею потенціалів на переході |
|
|
- бар’єрна ємність різкого переходу |
|
I
=
|
- вольт-амперна характеристика ідеалізованого діоду на p-n- переході |
|
|
- тепловий струм через ідеальний гомоперехід |
|
I
=
|
- вольт-амперна характеристика реального гетеропереходу |
|
|
- струм насичення гетеропереходу, А 2 |
|
|
- дифузійна довжина вільного пробігу електронів |
|
|
- дифузійна довжина вільного пробігу дірок |
|
FF
=
|
- фактор заповнення ВАХ сонячного елемента |
|
= |
- ККД фотоперетворювача |
Основні константи, що використовуються у ргр
|
k = 1,38110-23 Дж/К |
- стала Больцмана |
|
|
q = 1,60210-19 Кл |
- заряд електрона |
|
|
ε0 = 8,85410-12 Ф/м |
- електрична стала |
|
|
h = 6,626 10-34 Джс |
- стала Планка |
|
|
с = 2,999 108 м/с |
- швидкість світла у вакуумі |
|
|
ε = 16 |
- відносна діелектрична проникність германію (Т = 300 К) |
|
|
ε = 11,7 |
- відносна діелектрична проникність кремнію (Т = 300 К) |
|
|
ε = 12,9 |
- відносна діелектрична проникність GaAs (Т = 300 К) |
|
|
ΔEgGe = 0,72 еВ |
- ширина забороненої зони германію |
|
|
ΔEgSi = 1,12 еВ |
- ширина забороненої зони кремнію |
|
|
ΔEgGaAs = 1,44 еВ |
- ширина забороненої зони GaAs |
|
|
μn = 3800 см2/Вс |
- рухливість електронів у германії при Т = 300 К |
|
|
μn = 3000 см2/Вс |
- рухливість електронів у кремнії при Т = 300 К |
|
|
μn = 8500 см2/Вс |
- рухливість електронів у GaAs при Т = 300 К |
|
|
μp = 1820 см2/Вс |
- рухливість дірок у германії при Т =300 К |
|
|
μp = 500 см2/Вс |
- рухливість дірок у кремнії при Т = 300 К |
|
|
μp = 420 см2/Вс |
- рухливість дірок у GaAs при Т = 300 К |
|
|
mn1 = 0,22me |
- ефективна маса електрона в германії |
|
|
mn2 = 1,06me |
- ефективна маса електрона в кремнії |
|
|
mn3 = 0,067me |
- ефективна маса електрона в арсеніді галію |
|
|
mр1 = 0,39me |
- ефективна маса дірки в германії |
|
|
mр2 = 0,56me |
- ефективна маса дірки в кремнії |
|
|
mр3 = 0,45me |
- ефективна маса дірки в арсеніді галію |
|






 ln
ln =
=
 ln
ln .
.
 =
=
 =
=
 (
( -
x)
-
x) (
( +
x)
+
x) =
=
 =
=

 (x)=-
(x)=- (
( )2.
)2. (x)=-
(x)=- (
( )2
)2 =
qUk
=
qUk =
S(
=
S( )
) (
( )
)
 (
( )
) =
=
 (
( )
)


