Материал: LS-Sb92720
Если число фотонов, поглощенных в пределах структуры, является нулем, квантовые эффективности приравниваются также к нулю. Соответствующий числовой порог, определяющий поток фотонов равным нулю, задается в численных настройках (см. 2.3).
При запуске моделирования квантового выхода автоматически устанавливается граничное условие: прикладываемое напряжение равно нулю. Это необходимо для вычисления тока короткого замыкания структуры.
В результате расчета на график выводятся:
–внешняя квантовая эффективность «eqe», где учитываются все фотоны дополнительного освещения, включая отраженные и прошедшие сквозь структуру;
–внутренняя квантовая эффективность «iqe», где учитываются только поглощенные фотоны. Но при этом так же, как и в измерении, фотоны, которые поглощены контактами, тоже учитываются, несмотря на то что они не вносят вклад в фототок;
–скорректированная внутренняя квантовая эффективность «iqe1», где учитываются только фотоны освещения, поглощенные электрическими слоями;
–спектральная чувствительность «spectral response» [А/Вт].
Обратите внимание. По определению внешняя квантовая эффективность всегда должна быть меньше, чем внутренняя, и все квантовые эффективности меньше, чем единица. Если при моделировании это не так – значит дискретизация, по крайней мере, одного из слоев была выбрана не достаточно точно. Дело в том, что количество поглощенных фотонов уменьшается по экспоненциальному закону, тогда как при моделировании происходит линейная интерполяция между узлами сетки. Следовательно, если расстояние между узлами сетки слишком большое, поглощение фотонов будет завышено. Этой проблемы можно избежать, используя более точную дискретизацию.
26
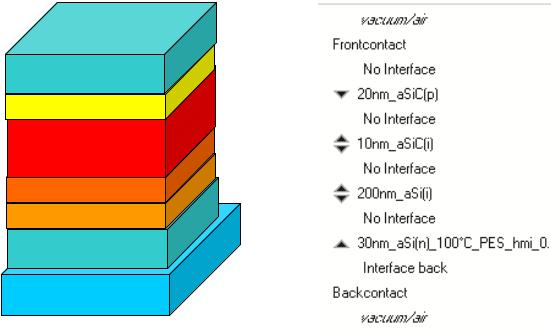
3. ПРИМЕР РАСЧЕТА p– i– n-СТРУКТУРЫ НА ОСНОВЕ a-SI:H
На рис. 3.1 представлена p–i–n- структура моделируемого a-Si:H солнечного элемента (CЭ). В табл. 3.1 приведены основные параметры для каждого слоя, используемые в моделировании.
ZnO 1.5 µm
(n)a-Si:H 10 nm
a-Si:H 200 nm
a-SiC:H buffer 10 nm (p) a-SiC:H 10 nm ZnO 1.5 µm
glass
a б
Рис. 3.1. Схематическое изображение p– i– n-структуры a-Si:H солнечного элемента (а) и структура СЭ, используемого в моделировании (б)
|
|
|
|
Таблица 3.1 |
|
Основные параметры слоев a-Si:H p– i– n СЭ |
|
||
|
|
|
|
|
Слой |
Толщина, нм |
Ширина щели |
Положение уровня |
Электронное |
подвижности, эВ |
Ферми, эВ |
сродство, эВ |
||
|
|
|
|
|
a-SiC:H (p) |
10 |
1.9 |
0.4 |
3.8 |
|
|
|
|
|
a-SiC:H (i) |
10 |
1.9 |
0.95 |
3.8 |
|
|
|
|
|
a-Si:H (p) |
200 |
1.72 |
0.85 |
3.9 |
|
|
|
|
|
a-Si:H (n) |
10 |
1.72 |
0.3 |
3.9 |
|
|
|
|
|
На практике степень легирования слоев a-Si:H определяется не концентрацией легирующей примеси в пленке, а положением уровня Ферми относительно ближайшей зоны. Дело в том, что высокая плотность состояний в щели подвижности приводит к значительному сдвигу положения уровня Ферми. При моделировании необходимо проводить подгонку значений концентрации доноров с целью обеспечения требуемого положения уровня Ферми в слое a-Si:H в условиях равновесия.
27
Для описания плотности состояний в щели подвижности слоев аморфных полупроводников использовался классический подход: два экспоненциальных распределения, описывающие состояния в хвостах зоны проводимости и валентной зоны; два дефекта в середине зоны с распределением Гаусса: один – донорного, другой – акцепторного типа, описывающие состояния в середине щели, обусловленные оборванными связями. В табл. 3.2 приведены параметры вводимых дефектных уровней, используемые при расчете для базовой модели. Графики распределения плотности состояний для всех слоев, представлены на рис. 3.2–3.5.
|
|
|
|
|
|
Таблица 3.2 |
|
|
Параметры дефектных уровней, используемые |
|
|||
|
|
при расчете для базовой модели |
|
|||
|
|
|
|
|
|
|
|
Параметр |
a-SiC:H (p) |
a-SiC:H (i) |
a-Si:H (i) |
|
a-Si:H (n) |
|
|
Хвост зоны проводимости (CBT) |
|
|||
|
|
|
|
|
|
|
|
σ , cм2 |
7 · 10–16 |
7 · 10–16 |
7 · 10–16 |
|
7 · 10–16 |
|
n |
|
|
|
|
|
|
σ , cм2 |
7 · 10–16 |
7 · 10–16 |
7 · 10–16 |
|
7 · 10–16 |
|
p |
|
|
|
|
|
|
EU, эВ |
0.068 |
0.05 |
0.03 |
|
0.068 |
|
N , cм–3 |
1.36 · 1020 |
1.36 · 1020 |
3 · 1019 |
|
1.36 · 1020 |
|
t |
|
|
|
|
|
|
|
Хвост валентной зоны (VBT) |
|
|||
|
|
|
|
|
|
|
|
σ , cм2 |
7 · 10–16 |
7 · 10–16 |
7 · 10–16 |
|
7 · 10–16 |
|
n |
|
|
|
|
|
|
σ , cм2 |
7 · 10–16 |
7 · 10–16 |
7 · 10–16 |
|
7 · 10–16 |
|
p |
|
|
|
|
|
|
EU, эВ |
0.1245 |
0.06 |
0.06 |
|
0.1245 |
|
N , cм–3 |
1.36 · 1020 |
6 · 1019 |
6 · 1019 |
|
1.36 · 1020 |
|
t |
|
|
|
|
|
|
Гауссовское распределение дефектов акцепторного типа (DBA) |
|||||
|
|
|
|
|
|
|
|
σ , cм2 |
3 · 10–15 |
3 · 10–15 |
3 · 10–15 |
|
3 · 10–15 |
|
n |
|
|
|
|
|
|
σ , cм2 |
3 · 10–14 |
3 · 10–14 |
3 · 10–14 |
|
3 · 10–14 |
|
p |
|
|
|
|
|
|
E, эВ |
1.3 |
1 |
1 |
|
0.78 |
|
σ, эВ |
0.23 |
0.15 |
0.15 |
|
0.23 |
|
N , cм–3 |
5 · 1019 |
3.76 · 1017 |
3.76 · 1015 |
|
5 · 1019 |
|
t |
|
|
|
|
|
g |
, cм–3 · эВ– |
8.7 · 1019 |
1 · 1018 |
1 · 1016 |
|
8.7 · 1019 |
|
max |
|
|
|
|
|
|
1 |
|
|
|
|
|
|
|
|
|
|
|
|
|
Гауссовское распределение дефектов донорного типа (DBD) |
|
||||
|
|
|
|
|
|
|
|
σ , cм2 |
3 · 10–14 |
3 · 10–14 |
3 · 10–14 |
|
3 · 10–14 |
|
n |
|
|
|
|
|
|
σ , cм2 |
3 · 10–15 |
3 · 10–15 |
3 · 10–15 |
|
3 · 10–15 |
|
p |
|
|
|
|
|
|
E, эВ |
1.1 |
0.8 |
0.8 |
|
0.58 |
|
σ, эВ |
0.23 |
0.15 |
0.15 |
|
0.23 |
|
N , cм–3 |
5 · 1019 |
3.76 · 1017 |
3.76 · 1015 |
|
5 · 1019 |
|
t |
|
|
|
|
|
g |
, cм–3 · эВ– |
8.7 · 1019 |
1.36 · 1018 |
1 · 1016 |
|
8.7 · 1019 |
|
max |
|
|
|
|
|
28

1
|
|
1021 |
|
|
|
|
|
|
|
|
|
|
|||
|
|
|
|
|
|
|
|
|
|
|
|
|
|
Ec |
|
эВ– 1 |
|
|
|
|
|
|
Ev |
|
|
|
|
|
|||
|
|
|
|
|
|
|
|
|
|
|
|
|
|
||
1019 |
|
|
|
|
|
|
|
|
|
|
|||||
см– 3 · |
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
||
g, |
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
1017 |
|
|
|
|
|
|
|
|
|
|
|||
|
|
|
|
0 |
|
|
0.5 |
|
1 |
|
1.5 |
|
|||
|
|
|
|
|
|
|
|
|
|
|
E, эВ |
|
|
||
|
|
|
|
|
|
|
|
|
|
|
|
|
|||
Рис. 3.2. Распределение плотности состояний в запрещенной зоне слоя a-SiC:H (p)
|
|
1020 |
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
Ec |
|
– 1 |
|
|
Ev |
|
|
|
|
||||
|
|
|
|
|
|
|
|
|
|
||
1017 |
|
|
|
|
|
|
|
|
|
||
см– 3 · эВ |
|
|
|
|
|
|
|
|
|
||
|
|
|
|
|
|
|
|
|
|
||
g, |
|
|
|
|
|
|
|
|
|
|
|
1014 |
|
|
|
|
|
|
|
|
|
||
|
|
|
|
|
|
|
|
|
|
|
|
|
|
0 |
|
|
|
|
|
|
|
|
|
|
|
|
|
|
0.5 |
E, |
1 |
|
1.5 |
|
|
|
|
|
|
|
|
|
эВ |
|
|
|
|
|
|
|
|
|
|
|
|
|
|||
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
1020 |
|
|
|
|
|
|
|
|
Ec |
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|||
–1 |
|
|
|
Ev |
|
|
|
|
|
|
||
эВ |
|
|
|
|
|
|
|
|
|
|
|
|
1018 |
|
|
|
|
|
|
|
|
|
|||
см–3 · |
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
||
g, |
|
1016 |
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
0 |
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
0.5 |
|
1 |
|
1.5 |
|
|
|
|
|
|
|
|
|
|
E, эВ |
|
|
||
|
|
|
|
|
|
|
|
|
|
|||
Рис. 3.3. Распределение плотности состояний в запрещенной зоне слоя a-SiC:H (i)
|
|
1021 |
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|||
|
|
|
|
|
|
Ev |
|
|
|
|
Ec |
||
эВ–1 |
|
|
|
|
|
|
|||||||
|
|
|
|
|
|
|
|
|
|
||||
|
|
|
|
|
|
|
|
|
|
|
|||
1019 |
|
|
|
|
|
|
|
|
|
|
|||
см–3 · |
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
||
g, |
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
1017 |
|
|
|
|
|
|
|
|
|
|
|
|
|
|
0 |
|
|
|
|
0.5 |
|
1 |
|
1.5 |
|
|
|
|
|
|
|
|
|
|
E, эВ |
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|||
Рис. 3.4. Распределение плотности |
Рис. 3.5. Распределение плотности |
состояний в запрещенной зоне |
состояний в запрещенной зоне |
слоя a-Si:H (i) |
слоя a-Si:H (n) |
На рис. 3.6 представлена зонная диаграмма, рассчитанная для заданной p– i– n-структуры a-Si:H СЭ в состоянии равновесия. Видно, что на протяжении всей толщины i-слоя a-Si:H поле достаточно высоко для эффективного разделения носителей заряда.
На первом этапе было исследовано влияние слоя широкозонного окна a-SiC:H на эффективность преобразования солнечного излучения. Было проведено моделирование вольт-амперных характеристик (ВАХ) СЭ при освещении AM1.5G для двух вариантов структур: 1) вариант, представленный в табл. 3.1, с широкозонным окном a-SiC:H p-типа; 2) вариант структуры, в ко-
29

E, эВ
|
|
|
|
тором широкозонный слой a-SiC:H |
–4 |
|
|
|
был заменен на слой легированного |
|
|
|
|
a-Si:H p-типа. Рассчитанная ВАХ, |
–5 |
|
|
|
представленная на рис. 3.7, показала, |
|
|
|
|
что введение широкозонного окна a- |
–6 |
|
|
|
SiC:H позволяет существенно повы- |
|
|
|
|
сить КПД СЭ, повышая при этом как |
–7 |
|
|
|
значение тока короткого замыкания |
0 |
1E-5 |
см |
2E-5 |
(Jsc), так и напряжения холостого хо- |
|
х, |
|
да (Voc). На рис. 3.8 представлены
расчетные спектры внешней квантовой эффективности для этих двух вариантов структур. Видно, что уменьшение Jsc для структуры без широкозонного окна обусловлено снижением чувствительности в коротковолновой области спектра. На рис. 3.9 показано, что увеличение ширины щели подвижности окна a-SiC:H с 1.9 до 2 эВ также позволяет повысить КПД СЭ, за счет снижения поглощения в этом слое и, следовательно, увеличения Jsc.
На следующем этапе было проведено исследование плотности состояний в собственном слое a-Si:H. Результаты для двух максимальных значений
|
0 |
|
|
|
|
|
|
0.8 |
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
(p)a-SiC:H |
|
|
|
|
|
– 0.002 |
– (p) a-SiC:H; |
|
|
|
|
(p)a-SiH |
|
|
|
|
||||
(p) a-Si:H |
|
|
|
|
|
|
|
|
|
|
|
|
||
|
- . |
(p) a-SiC:H |
|
|
|
|
|
|
|
|
|
|
|
|
|
– |
(p) a-Si:H |
|
|
|
0.6 |
|
|
|
|
|
|
||
|
|
|
|
|
|
|
|
|
|
|
||||
2– 0.004 |
|
|
|
|
|
|
|
|
|
|
|
|
|
|
J, A/см2 J, A/см |
- . |
|
|
|
|
|
|
|
|
|
|
|
|
|
- . |
|
|
|
|
|
EQEEQE |
0.4 |
|
|
|
|
|
|
|
– 0.006 |
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
- . |
|
|
|
|
|
|
0.2 |
|
|
|
|
|
|
– 0.008 |
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
– 0.01 |
|
|
|
|
|
|
|
|
– (p) a-SiC:H; |
|
|
||
|
|
|
|
|
|
|
|
|
– (p) a-Si:H |
|
|
|||
|
- . |
|
|
|
|
|
|
0 |
|
|
|
|
|
|
|
0 |
0.2 |
0.4 |
00.6 |
0.8 |
1 |
|
300 |
400 |
500 |
600 |
700 |
800 |
|
|
|
|
V,, BВ |
|
|
|
200 |
|||||||
|
|
|
|
|
|
|
|
λλ,, нм |
|
|
|
|||
|
|
|
|
|
|
|
|
|
|
|
|
|
||
|
Рис. 3.7. Расчетные ВАХ СЭ |
|
Рис. 3.8. Расчетные спектры внешней |
|||||||||||
|
при освещении AM1.5G для двух |
|
|
квантовой эффективности для двух |
||||||||||
вариантов структур: 1) с окном a-SiC:H |
вариантов структур: 1) с окном a-SiC:H |
|||||||||||||
|
p-типа; 2) со слоем a-Si:H p-типа |
|
|
p-типа; 2) со слоем a-Si:H p-типа |
||||||||||
30