Материал: LS-Sb92720

|
0 |
|
|
|
|
|
|
|
|
|
|
||
|
|
|
|
|
|
|
|
|
|
|
|||
|
- . |
|
|
|
|
|
|
|
|||||
|
|
|
|
a |
-–SiCaEg=2eV-SiC Eg = 1.9 эВ; |
|
|
||||||
|
|
|
|
|
|
a |
-SiC Eg=1.9eV |
|
|
|
|
|
|
|
– 0.002 |
|
|
– |
a-SiC Eg = 2 эВ |
|
|
|
|||||
|
|
|
|
|
|
|
|
|
|
||||
см2 |
– 0.004 |
|
|
|
|
|
|
|
|
|
|||
|
|
|
|
|
|
|
|
|
|||||
2 |
|
|
|
|
|
|
|
|
|
|
|
|
|
|
-0.004 |
|
|
|
|
|
|
|
|
|
|
||
A/ |
A/см |
|
|
|
|
|
|
|
|
|
|||
J, |
– 0.006-0.006 |
|
|
|
|
|
|
|
|
|
|||
J, |
|
|
|
|
|
|
|
|
|
||||
|
– 0.008 |
|
|
|
|
|
|
|
|
|
|||
|
-0.008 |
|
|
|
|
|
|
|
|
|
|
||
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
– 0-.001. |
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
||
|
|
|
|
0 |
0.22 |
|
0.4 |
00.6 |
0.88 |
11 |
1.22 |
||
|
|
|
|||||||||||
VV, BВ
Рис. 3.9. Расчетные ВАХ СЭ при освещении AM1.5 G для структур a-SiC:H с шириной щели Eg 1.9 и 2 эВ
плотности состояний в середине
|
0 |
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
– 0.002 |
|
|
|
|
– DOS 5e16; |
|
||
|
|
|
|
|
|
||||
|
|
|
|
|
– DOS 1e16 |
|
|||
|
|
|
|
|
|
|
|||
см2 |
– 0.004 |
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
||
|
|
|
|
|
|||||
|
|
|
|
|
|
|
|
|
|
J, A/ |
– 0.006 |
|
|
|
|
|
|
|
|
|
|
|
|
|
|||||
|
– 0.008 |
|
|
|
|
|
|
|
|
|
|
|
|
|
|
||||
|
|
|
|
|
|||||
–0.01 |
0.2 |
0.4 |
0.6 |
0.8 |
1 |
0 |
V, B
Рис. 3.10. Расчетные ВАХ СЭ при освещении AM1.5G для структур
сразличными значениями плотности состояний (DOS) в собственном
слое a-Si:H, gmax –
1016 и 5 · 1016 см–3 · эВ–1
щели подвижности (gmax) 1016 и
5 · 1016 см–3 · эВ–1 представлены на рис. 3.10. Видно, что увеличение плотности состояний в собственном слое аморфного кремния катастрофически влияет на эффективность преобразования солнечной энергии – ухудшаются все основные параметры ВАХ: Jsc, Voc и FF.
31
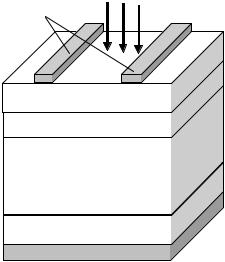
4. МОДЕЛЬ СОЛНЕЧНОГО ЭЛЕМЕНТА НА ОСНОВЕ ГЕТЕРОПЕРЕХОДА (n)a-Si:H/(p)c-Si
Альтернативным путем развития кремниевой солнечной энергетики является использование гетеропереходов между аморфным гидрогенизированным и кристаллическим кремнием (a-Si:H/c-Si), которые обладают всеми преимуществами СЭ на основе кристаллического кремния, в то время как могут быть изготовлены полностью при низких температурах и при этом достигать очень высоких значений КПД (более 24 %). Схематическое изображение структуры СЭ на основе гетероперехода (n)a-Si:H/(p)c-Si представлено на рис. 4.1. Основной особенностью таких гетероструктур является то, что для формирования выпрямляющего перехода на пластину c-Si p- или n-типа проводимости наносится очень тонкий (≤10 нм) слой сильно легированного a-Si:H n- или p-типа соответственно. Слой a-Si:H играет роль эммитрера, а также обеспечивает пассивацию поверхности c-Si. Толщина слоя a-Si:H должна быть минимальной для уменьшения поглощения в этом слое (и следовательно, потери на рекомбинацию), но в то же время достаточной для формирования гетероперехода. Сверху на сформированный гетеропереход наносится слой прозрачного проводящего оксида (TCO), который играет роль как просветляющего покрытия, так и проводящего слоя, поскольку латеральная проводимость пленок a-Si:H достаточно низка. Для формирования встроенного поля на тыльном невыпрямляющем контакте на пластину c-Si наносится сильнолегированный слой a-Si:H того же типа проводимости, что и c-Si.
Контактная |
hν |
Изготовление СЭ завершается нанесением |
||||||||
металлических электродов на обе стороны |
||||||||||
сетка |
|
|
|
|||||||
|
|
|
гетероструктр (сверху в виде сетки). |
|||||||
|
|
|
|
|
||||||
|
|
|
|
|
Свойства границ раздела гетероперехо- |
|||||
|
|
|
|
|
дов a-Si:H/c-Si играют очень важную, воз- |
|||||
|
|
|
|
|
||||||
|
|
TCO |
|
можно |
решающую, роль |
в работе таких |
||||
|
|
|
устройств. КПД a-Si:H/c-Si СЭ во многом |
|||||||
(n)a-Si:H Eg 1.7 эВ |
|
|||||||||
|
(p) c-Si |
|
зависит от плотности поверхностных состо- |
|||||||
|
|
яний |
(определяющей поверхностную ре- |
|||||||
Eg = 1.12 эВ |
|
|||||||||
|
комбинацию) на границе раздела a-Si:H/c-Si. |
|||||||||
|
|
|
|
|
||||||
(p)a-Si:H Eg 1.7 эВ |
|
Для расчета |
зависимости характери- |
|||||||
|
||||||||||
|
стик |
СЭ |
на |
основе |
гетероперехода |
|||||
Тыльный контакт |
|
|||||||||
|
||||||||||
|
a-Si:H/c-Si от параметров границы раздела |
|||||||||
Рис. 4.1. Схематическое изображение |
||||||||||
предложена |
теоретическая модель, опи- |
|||||||||
структуры СЭ на основе |
санная далее. |
|
|
|||||||
гетероперехода (n)a-Si:H/(p)c-Si |
|
|
||||||||
32
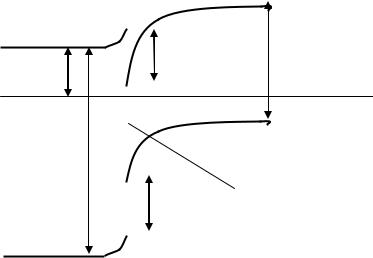
В табл. 4.1 приведены основные параметры слоев, используемые при расчете, а на рис. 4.2 представлена зонная диаграмма, соответствующая модели гетероперехода (n)a-Si:H/(p)c-Si, используемой в расчете.
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
Таблица 4.1 |
Основные параметры слоев, используемых при расчете |
|
||||||||||||||
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
Параметр |
|
|
c-Si |
Интерфейсный |
|
|
|
a-Si:H |
|||||||
|
|
|
|
|
|
слой |
|
|
|
||||||
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
Ширина зоны, эВ |
1.12 |
1.12 |
|
|
|
1.74 |
|||||||||
Уровень легирования, см–3 |
1 × 1015 |
1 × 1015 |
|
|
|
… |
|||||||||
Положение уровня Ферми |
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
относительно потолка |
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
валентной зоны/ дна |
0.28 |
|
|
|
|
– |
|
|
|
0.28 |
|||||
зоны проводимости |
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
в квазинейтральной области, эВ |
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
Электронное сродство, эВ |
4.05 |
4.05 |
|
|
|
3.9 |
|||||||||
Толщина, нм |
300 000 |
1 |
|
|
|
10 |
|||||||||
(n)a-Si:H |
|
|
|
|
|
|
(p)c-Si |
EС |
|||||||
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
Eg = 1.12 эВ |
|
|||
|
|
|
|
|
|
|
|
|
|
|
|
||||
EC – EF = 0.28 эВ |
|
|
|
DEC = 0.15 эВ |
|
||||||||||
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
EF |
Eg = 1.74 эВ |
|
|
|
|
|
|
|
|
|
|
|
|
|
|
EV |
|
|
|
|
|
|
|
|
|
|
|
|
|
|
||
|
|
|
|
|
|
Интерфейсный слой |
|
||||||||
|
|
|
|
|
|
|
|
||||||||
|
|
|
DEV |
|
|||||||||||
|
|
|
|
|
|
|
|
|
|
|
|
||||
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
Рис. 4.2. Зонная диаграмма, используемая при расчете гетероперехода (n)a-Si:H/(p)c-Si
Свойства границы раздела a-Si:H/c-Si задавались введением «интерфейсного» слоя c-Si толщиной 1 нм, расположенного между a-Si:H и c-Si. Такой подход имеет определенный физический смысл, и его применимость к гетерогранице a-Si:H/c-Si подтверждается результатами структурных исследований, проведенных с помощью просвечивающей электронной микроскопии высокого разрешения [4]. Как видно из представленного на рис. 4.3 изображения среза гетероперехода a-Si:H/c-Si, на границе раздела между слоем a-Si:H и подложкой c-Si можно выделить переходную область порядка 2…3 нм. Очевидно, что данную область можно описать слоем с высокой концентрацией дефектов.
33
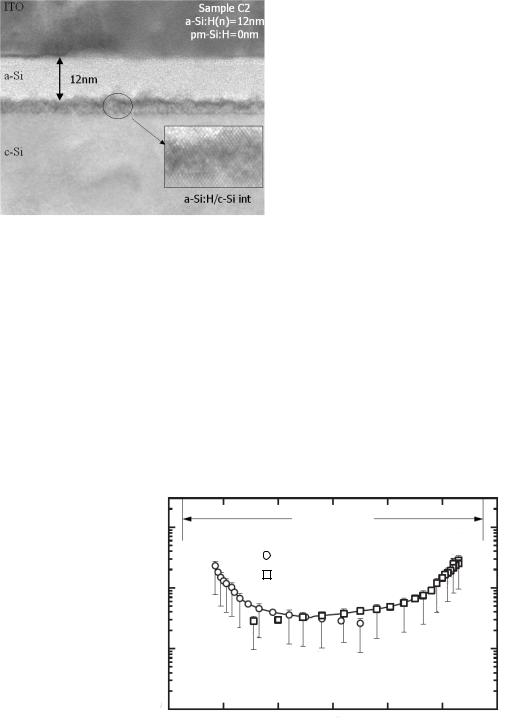
Однако информация о распределении плотности состояний на границе a-Si:H/c-Si в литературе практически отсутствует. В связи с этим особый интерес представляет полученное с помощью метода поверхностной фотоЭДС распределение Dit (E), представленное на рис. 4.4 [5]. Видно, что Dit не сильно зависит от энергетического положения. Учитывая этот факт, а также скудность информации по распределению плотности поверхностных состояний на границе a-Si:H/c-Si, было предложено использовать в модели постоянное распределение плотности состояний git(E) = = const в интерфейсном слое. Плотность
поверхностных состояний определялась как Dit = git dit, где dit = 1 нм. При этом вводимые дефекты были донорного типа в нижней половине запрещенной зоны и акцепторного – в верхней (рис. 4.5, а). Сечения захвата для электронов и дырок по умолчанию были равны 1 × 10–14 см2.
Dit, см– 2 × эВ–1
1013
1012
1011
1010
Eg c-Si
– ( i)a-Si:H/(p)c-Si;
– ( i)a-Si:H/(n)c-Si
–0.4 |
–0.2 |
0 |
0.2 |
0.4 |
E–E i, эВ
Рис. 4.4. Распределение Dit (E) на границах (i)a-Si:H/(p)c-Si
и (i)a-Si:H/(n)c-Si, полученное с помощью метода фотоЭДС, где Ei – положение уровня Ферми в собственном c-Si
Для описания плотности состояний в щели подвижности слоев аморфных полупроводников использовался классический подход, упомянутый ранее: два экспоненциальных распределения, описывающие состояния в хво-
34

стах зоны проводимости (CBT) и валентной зоны (VBT) с характеристическими энергиями kTC и kTV; два дефекта в середине щели подвижности с распределением Гаусса: донорного (DBD) и акцепторного (DBA) типов, описывающие состояния в середине щели, обусловленные оборванными связями. Схематическое изображение распределения плотности состояний в щели подвижности a-Si:H показано на рис. 4.5, б. Параметры плотности состояний для хвостов зон и дефектов в середине щели подвижности, используемые в расчете по умолчанию, представлены в табл. 4.2 и 4.3 соответственно.
|
|
|
git |
– |
|
акцептор; |
|
Dit |
|
|
– |
|
донор |
||
|
|
|
|
||||
|
|
|
|
|
|
|
|
|
|
|
|
VBT |
|
|
CBT |
|
|
|
|
DBD |
|
DBA |
|
Донор |
Акцептор |
|
gmax |
|
|
|
|
EV |
Eg/2 |
EC |
EV |
E |
|
E |
EC |
|
|
|
|
DBD |
|
DBA |
|
|
а |
|
|
|
б |
|
|
Рис. 4.5. Схематическое изображение распределения плотности состояний: а – в интерфейсном слое; б – в слоях a-Si:H
|
|
Таблица 4.2 |
|
Параметры ПС в хвостах зон a-Si:H |
|
Параметр |
Хвост EC (CBT) |
Хвост EV (VBT) |
sn, cм2 |
7 × 10–16 |
7 × 10–16 |
sp, cм2 |
7 × 10–16 |
7 × 10–16 |
kTC / kTV, эВ |
0.068 |
0.1245 |
Nt, cм–3 |
1.36 × 1020 |
1.36 × 1020 |
|
|
Таблица 4.3 |
|
Параметры ПС в середине щели подвижности a-Si:H |
|
Параметр |
Гауссиан акцепторного типа (DBA) |
Гауссиан донорного типа (DBD) |
sn, cм2 |
3 × 10–15 |
3 ×10–14 |
sp, cм2 |
3 × 10–14 |
3 × 10–15 |
EDB, эВ |
0.78 |
0.58 |
s, эВ |
0.23 |
0.23 |
Nt, cм–3 |
5 × 1019 |
5 × 1019 |
gmax, cм–3 × эВ–1 |
8.7 × 1019 |
8.7 × 1019 |
35