Материал: FXUXsqe9Fl
21
ются в настоящий момент основой массового производства высокоэффективных фотопреобразователей. Однако конструкция трехпереходного GaInP/GaAs/Ge СЭ содержит большое количество слоев с различным составом, что обуславливает исключительную роль границ раздела в данных структурах (рис. 14).
Если свойства границ раздела гетеропереходов на основе GaAs и тройных соединений AlGaAs, применяемые в первых СЭ на основе на соединений АIIIBV, исследованы в достаточно полной мере, то гетеропереходы на основе тройных и четверных соединений фосфидов третьей группы (GaInP, AlInP и AlGaInP), применяющиеся при изготовлении многопереходных СЭ сравнительно недавно, требуют дальнейших исследований. Примером является проблема формирования верхнего перехода p–n полярности на основе AlInP/GaInP гетероструктур, для которого характерно наличии изгиба на нагрузочной ВАХ в области VOC, приводящего к уменьшению FF, а, следова-
тельно, и КПД СЭ [3, 4]. Характерные экспериментальные ВАХ для изготовленных на подложках GaAs p- и n-типа проводимости солнечных элементов, представлены на рис. 15а. Наибольшее значение Jsc, VOC, и FF, приводя-
щие к наибольшему КПД получены для n–p -структур с (n)AlInP окном. Структура p-n с окном (p)AlInP обладает меньшими значениями JSC и VOC,
но главная ее особенность заключается в том, что на вольт-амперных характеристиках наблюдается четко выраженный перегиб, который приводит к значительному падению FF (0.75) и, следовательно, КПД. Эта особенность AlInP/GaInP служит существенным препятствием для использования многопереходных СЭ p–n полярности при преобразовании концентрированного излучения.
Проведенный анализ влияния Dit на характеристики СЭ на основе
GaInP показал, что поверхностные состояния на границе раздела «контактный слой (GaAs)/широкозонное окно (AlInP, AlGaAs)» не оказывают влияния на характеристики СЭ. Однако поверхностные состояния на границе раздела «широкозонное окно (AlInP, AlGaAs)/ эммитер (GaInP)» могут оказывать существенное влияние на параметры СЭ. Рост Dit на этом гетероинтерфейсе приводит к падению тока JSC и VOC, и как следствие, к снижению КПД.
Для гетероинтерфейса AlInP/GaInP влияние поверхностных состояний ска-
зывается при Dit > 1011 см– 2×эВ– 1, в то время как для границы AlGaAs/GaInP
резкое уменьшение JSC и VOC начинается уже при Dit > 108 см– 2×эВ– 1, что обусловлено сильным изгибом зон, приводящим к потоку неосновных носителей заряда к этой гетерогранице.

22
Для экспериментального определения значения Dit на границе раздела широкозонное окно/эмиттер (p-AlInP/p-GaInP) была разработана методика, основанная на изменении изгиба зон в приповерхностной области за счет вариации потока внешней подсветки. Проведенная оценка Dit на границе
(p)AlInP/(p)GaInP дает значение 1010 см-2×эВ-1 (при DEc=0.24 эВ и sn=10-14
см2), что указывает на слабое влияние плотности поверхностных состояний на свойства СЭ на основе гетероперехода AlInP/GaInP
|
0.015 |
|
|
|
|
0.01 |
n-p (AlInP) |
|
|
|
p-n (AlInP) |
|
|
|
|
|
|
|
|
|
0.005 |
p-n (AlGaAs) |
|
|
2 |
|
|
|
|
|
|
|
|
|
А/см |
0 |
|
|
|
J, |
|
|
|
|
|
-0.005 |
|
|
|
|
-0.01 |
|
|
|
|
-0.015 |
0.5 |
1 |
1.5 |
|
0 |
|
0.015 |
|
|
|
|
0.01 |
n-p (AlInP) |
|
|
|
p-n (AlInP) |
|
|
|
|
0.005 |
p-n (AlGaAs) |
|
|
2 |
|
|
|
|
|
|
|
|
|
А/см |
0 |
|
|
|
J, |
|
|
|
|
|
-0.005 |
|
|
|
|
-0.01 |
|
|
|
|
-0.015 |
0.5 |
1 |
1.5 |
|
0 |
|
V, В |
|
|
|
V, В |
|
|
|
|
|
б) |
|
|
|
а) |
|
|
|
|
|
Рис. 15. Характерные экспериментальные (а) и расчетные (б) ВАХ при освещении |
||||||
AM1.5D для трех типов изготовленных GaInP солнечных элементов: n-p и p–n- структуры |
||||||
|
с окном AlInP, p– n-структура с окном Al0.8Ga0.2As . |
|
||||
|
D = 0 см–2 ·эВ–1 |
Теоретический анализ |
экспери- |
|||
|
ментальных ВАХ (рис. 15б) показал, |
|||||
–4 |
it |
|
|
|||
|
|
|
||||
|
D = 1012 |
см–2 ·эВ–1 |
что особенности поведения ВАХ свя- |
|||
–5 |
it |
|
|
|
|
|
|
E |
|
заны с различиями в зонных диа- |
|||
-4 |
3.8 10 -5 |
C |
||||
2.8 10 -5 |
|
|||||
AlInP |
|
|
|
|
|
|
EэВ, |
|
EF |
граммах для структур. Большая вели- |
|||
–6 |
p–n GaInP |
|
|
чина разрыва валентных зон (DEV) на |
||
|
|
|
||||
|
|
|
|
|||
–7 |
|
EV |
границе p-GaAs/p-AlInP (контактный |
|||
Рис. 16. Расчетная зонная диаграмма при |
слой/широкозонное окно) p–n струк- |
|||||
равновесии для p–n -структуры с окном |
туры приводит к формированию па- |
|||||
|
(p)AlInP |
|
|
разитного |
потенциального |
барьера |
(порядка 0.54 эВ) для основных носителей заряда (дырок), движущихся от |
||||||
эмиттера к переднему контакту (рис. 16). Этот барьер ограничивает транс- |
||||||
порт дырок и приводит к образованию перегиба на ВАХ при освещении. |
||||||
Для независимого экспериментального подтверждения выдвинутого |
||||||
предположения была разработана методика определения эффективной высо- |
||||||
ты потенциального барьера для основных носителей заряда на основе резуль- |
||||||
татов измерений спектров полной проводимости. Упрощенный подход к ана- |
||||||
23
лизу спектров полной проводимости с помощью эквивалентной схемы, предполагая, что в изотипном гетеропереходе транспорт носителей главным образом определяется переносом через потенциальный барьер и проводимость может быть выражена исходя из приближения термоэлектронной эмиссии, демонстрирует возможность определения эффективной высоты по-
тенциального барьера по положению максимумов зависимостей Gp/ω(T), со-
ответствующих точке перегиба Cp(T). Экспериментально с помощью спек-
троскопии полной проводимости было подтверждено существование и определена высота эффективного потенциального барьера для основных носите-
лей заряда на границе раздела p-GaAs/p-AlInP, равная 0.6±0.05 эВ, что соот-
ветствует значению, полученному в результате моделирования и находится в хорошем соответствии со значением EV на границе раздела GaAs/AlInP, на-
ходящимся, согласно [5], [6], в диапазоне от 0.54 до 0.63 эВ.
Был предложен способ избежать ограничения применения AlInP/GaInP структур p–n полярности для преобразования концентрированного излучения за счет использования двухслойного широкозонного окна, состоящего из слоев Al0.8Ga0.2As и (Al0.6Ga0.4)0.51In0.49P. Данная комбинация позволяет с одной стороны снизить барьер для дырок, а с другой стороны уменьшить влияние плотности поверхностных состояний на границе раздела широкозонное окно/эмиттер. Экспериментально с помощью спектроскопии полной проводимости, а также ВАХ продемонстрировано, что высота эффективного потенциального барьера с использованием двухслойного широкозонного окна, состоящего из слоев Al0.8Ga0.2As и (Al0.6Ga0.4)0.51In0.49P, равна 0.2±0.07 эВ и достаточно мала для эффективного транспорта основных носителей заряда.
Рассмотренная проблема формирования паразитного потенциального барьера для основных носителей заряда за счет разрывов валентной зоны между фосфидами и арсенидами металлов III-группы p-типа проводимости может быть представлена в более общем виде. Было продемонстрировано возникновение паразитного барьера на границе раздела изотипных гетеропереходов AlGaInP/Al0.4Ga0.6As для среднего перехода на основе GaAs на границе тыльный потенциальный барьер/p-слой туннельного диода. Наличие потенциального барьера было подтверждено экспериментально с помощью измерений спектроскопии полной проводимости и вольтамперных характеристик в условиях освещения при низкой температуре (100 К). Выявленный потенциальный барьер приводил к появлению перегиба на нагрузочной ВАХ структур и уменьшению ее КПД (рис. 17а). Предложенный способ уменьшить высоту потенциального барьера для основных носителей заряда за счет

24
использования в качестве тыльного потенциального барьера слой p-Al0.3Ga0.7As позволил избавиться от перегиба на нагрузочной вольтампер-
ной характеристике (рис. 16б) и повысить величину КПД трехпереходного
GaInP/GaAs/Ge солнечного элемента с 33.6 % до 34.6 %.
|
0.2 |
|
|
|
|
0.2 |
|
|
|
|
0 |
|
|
|
|
0 |
|
|
|
|
|
|
|
|
|
|
|
|
|
2 |
–0.2 |
|
|
|
2 |
–0.2 |
|
|
|
см |
|
|
|
см |
|
|
|
|
|
|
|
|
|
–0.4 |
|
|
|
||
А/ |
|
|
|
|
А/ |
|
|
|
|
|
|
|
|
|
|
|
|
||
J, |
–0.4 |
|
|
|
J, |
–0.6 |
|
|
|
|
|
1...1000 крат |
|
|
1...1000 крат |
|
|||
|
–0.6 |
|
|
|
|
||||
|
|
|
|
|
–0.8 |
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
–0.8 |
|
|
|
|
–1 |
|
|
|
|
0 |
1 |
2 |
3 |
|
0 |
1 |
2 |
3 |
|
|
|
V, В |
|
|
|
|
V, В |
|
|
|
|
а |
|
|
|
б |
|
|
Рис. 17. Экспериментальные ВАХ при разной интенсивности концентрированного сол- |
|||||||||
нечного освещения трехпереходных GaInP/GaAs/Ge СЭ в которых GaAs-переход выпол- |
|||||||||
|
|
|
нен с BSF-слоями AlGaInP (а) и AlGaAs (б) |
|
|
||||
С целью определения дальнейших путей повышения КПД многопереходных СЭ был проведен теоретический анализ потенциальных преимуществ использования анизотипных гетеропереходов. Был продемонстрирован способ снижения рекомбинационных потерь в слое эмиттера для среднего перехода на основе GaAs, используя слой широкозонного эмиттера (GaInP, AlInP или AlGaAs). Снижение рекомбинационных потерь достигается за счет уменьшения концентрации неосновных носителей заряда поскольку поглощение в широкозонном слое минимально, а диффузия неосновных носителей заряда ограничена потенциальным барьером, сформированным за счет разрывов зон. В случае, когда характеристики СЭ на основе GaAs гомоперехода ограничены рекомбинацией в n+ GaAs эмиттере, предложенная конструкция может позволить увеличить напряжение холостого хода и КПД. Анализ влияния плотности Dit на границе раздела широкозонный эмиттер/база на характеристики СЭ показал, что эффективность работы (n)AlInP/(p)GaAs и (n)AlGaAs/(p)GaAs гетеропереходов не зависит от Dit вплоть до 1011 см–
2×эВ– 1 (sn=10-14 см2) демонстрируя высокий потенциал этих гетеропереходов для применения в многопереходных солнечных элементах. В то время как (n)GaInP/(p)GaAs гетеропереходы обладают сильной чувствительностью к плотности поверхностных состояний, что может ограничивать их примене-
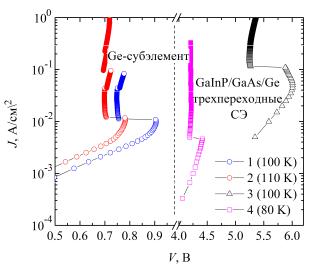
25
ние для солнечных элементов. Предложенный принцип использования анизотипных гетероперходов может быть применен для всех субэлементов многопереходных СЭ за исключением верхнего перехода
В главе 4 рассмотрены свойства границ раздела между соединениями АIIIBV и IV группы на примере GaInP/Ge гетероперехода, используемого в качестве нижнего перехода трехпереходных GaInP/GaAs/Ge СЭ. В случае нижнего Ge-субэлемента эпитаксиальные слои АIIIBV, выращенные на Geподложке (обычно с помощь МОС ГФЭ), используются как источник легирующей примеси для формирования p–n- перехода в Ge, а также как широкозонное окно для Geсубэлемента. Следовательно, в дополнение к p– n-переходу в Ge, граница раздела между соединениями АIIIBV и Ge также влияет на свойства транспорта носителей заряда.
Электронные свойства границ раз-
дела между соединениями АIIIBV и
IV группы еще не достаточно глубоко изучены, особенно в случае, когда при формировании этой гетерограницы происходит взаимная
диффузия компонентов, составляющих полупроводниковые слои. Явления на границах раздела могут сильно влиять на перенос носителей в Ge переходе, также как и на весь многопереходный СЭ.
Проведенные исследования свойств границ раздела (n)GaInP/(n–p )Ge гетеропереходов показали, что на границе раздела (n)GaInP/(n)Ge возникает паразитный потенциальный барьер для основных носителей заряда. Этот потенциальный барьер приводит к возникновению S-образности ВАХ при низких температурах, что также было обнаружено для трехпереходых СЭ, изготовленных на разных установках МОС ГФЭ (рис. 18).
Теоретический расчет, проведенный для модели с потенциальным барьером (рис. 19), позволяет в полной мере описать особенности экспериментальных ВАХ. Наличие паразитного потенциального барьера на гетерогранице (n)GaInP/(n)Ge было подтверждено с помощью двух независимых измерений: спектроскопии полной проводимости и C-V профилирования. Оце-