Материал: Проектирование КМОП-КНС-ИМ с поликремниевыми затворами
Проектирование КМОП-КНС-ИМ с поликремниевыми затворами
Содержание
Введение
1. Разработка технологического процесса изготовления КМОП-КНС-ИМ с поликремниевыми затворами
1.1 Подготовка поверхности подложки
.2 Эпитаксия
.3 Термическое оксидирование
.4 Нанесение фоторезиста
.5 Совмещение и экспонирование фоторезиста
.6 Проявление и задубливание фоторезиста
.7 Травление SiO2
.8 Удаление фоторезиста
.9 Локальное травление
.10 Удаление SiO2
.11 Термическое оксидирование
.12 Вторая фотолитография
.13 Ионное легирование фосфором
.14 Удаление SiO2
.15 Термическое оксидирование
.16 Наращивание поликристаллического кремния
.17 Третья фотолитография
.18 Нанесение ФСС
.19 Четвертая фотолитография
.20 Нанесение БСС
.21 Пятая фотолитография
.22 Диффузия
.23 Удаление ФСС и БСС
.24 Термическое оксидирование
.25 Шестая фотолитография
.26 Напыление Al
.27 Седьмая фотолитография
2. Технологические операции изготовления КМОП-КНС-ИМ с поликремниевыми затворами
2.1 Гетероэпитаксия
.2 Термическое оксидирование
.3 Первая фотолитография
.4 Локальное травление
.5 Удаление SiO2
.6 Термическое оксидирование
.7 Вторая фотолитография
.8 Ионное легирование фосфором
.9 Удаление SiO2
.10 Термическое оксидирование
.12 Наращивание поликристаллического кремния
.12 Третья фотолитография
.13 Нанесение ФСС
.14 Четвертая фотолитография
.15 Нанесение БСС
.16 Пятая фотолитография
.17 Диффузия
.18 Удаление ФСС и БСС
.19 Термическое оксидирование
.20 Шестая фотолитография
.21 Напыление Al
.22 Седьмая фотолитография
3. Технологическая операция “Снятие фоторезиста”
3.1 Назначение и сущность операции
.2 Оборудование
.3 Материалы и оснастка
.4 Подготовка рабочего места
.5 Контрольный процесс
.6 Технологический процесс
Заключение
Литература
Введение
В способе формирования КМОП-структур с поликремниевым затвором на полупроводниковой пластине первого типа проводимости формируют области второго типа проводимости. Формируют окисный слой, затем проводят его селективное травление в областях каналов p- и n-канальных транзисторов и областях стоков и истоков p-канальных транзисторов. Формируют подзатворный диэлектрик в вытравленных областях, осаждают слой поликремния, формируют на нем фоторезистивную маску, удаляют незащищенный маской поликремний, легируют примесью второго типа проводимости области стоков и истоков p-канальных транзисторов. Формируют маску для легирования примесью первого типа проводимости путем удаления слоя окисла над областями стоков и истоков n-канальных транзисторов, а легирование поликремния проводят одновременно с легированием областей истока и стока n-канальных транзисторов, после чего проводят окисление поликремниевых затворов.
Изобретение относится к микроэлектронике, в частности к способам создания полупроводниковых интегральных КМОП-схем.
Известен способ изготовления КМОП-структур, включающий формирование на полупроводниковой пластине первого типа проводимости областей второго типа проводимости (карманов), формирование окисного слоя, формирование в вытравленных областях подзатворного диэлектрика. Осаждение слоя поликристаллического кремния, легирование поликремния, формирование фоторезистивной маски на поликремнии, соответствующей топологическому рисунку затвора, удаление незащищенного маской поликремния, удаление фоторезистивной маски, формирование фоторезистивной маски, травление подзатворного диэлектрика в областях стоков и истоков р-канальных транзисторов, удаление маски, осаждение окисной пленки, легированной примесью, создающей тип проводимости, противоположный типу проводимости "кармана", формирование фоторезистивной маски и удаление части окисного слоя за пределами "кармана", удаление маски фоторезиста и проведение селективной диффузии примеси из окисной пленки в подложку с целью создания областей стоков и истоков транзисторов, расположенных в области "карманов", введение примеси в подложку, используя окисную пленку в качестве маски с целью формирования областей стоков и истоков транзисторов, расположенных за пределами "кармана", удаление окисной пленки, осаждение диэлектрического слоя на всю поверхность подложки. Недостатком данного способа является большая длительность формированного КМОП-структур и высокий расход дорогостоящих веществ, обусловленные необходимостью неоднократного травления и осаждения окисных слоев.
1. Разработка технологического процесса изготовления КМОП-КНС-ИМ с поликремниевыми затворами
1.1 Подготовка поверхности подложки

Рисунок 1 - Подготовка поверхности подложки
1.2 Эпитаксия

Рисунок 2 - Эпитаксия
1.3 Термическое оксидирование

1.4 Нанесение фоторезиста

Рисунок 4 - Нанесение фоторезиста
1.5 Совмещение и экспонирование фоторезиста

Рисунок 5 - Совмещение и экспонирование фоторезиста
1.6 Проявление и задубливание фоторезиста

Рисунок 6 - Проявление и задубливание фоторезиста
1.7 Травление SiO2

Рисунок 7 - Травление SiO2
1.8 Удаление фоторезиста

Рисунок 8 - Удаление фоторезиста
1.9 Локальное травление

Рисунок 9 - Локальное травление
1.10 Удаление SiO2

Рисунок 10 - Удаление SiO2
1.11 Термическое оксидирование

Рисунок 11 - Термическое оксидирование
1.12 Вторая фотолитография

Рисунок 12 - Вторая фотолитография
1.13 Ионное легирование фосфором

Рисунок 13 - Ионное легирование фосфором
1.14 Удаление SiO2

Рисунок 14 - Удаление SiO2
1.15 Термическое оксидирование

Рисунок 15 - Термическое оксидирование
1.16 Наращивание поликристаллического кремния

Рисунок 16 - Наращивание поликристаллического кремния
1.17 Третья фотолитография
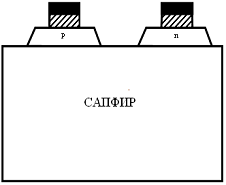
Рисунок 17 - Третья фотолитография
1.18 Нанесение ФСС
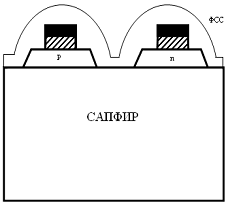
Рисунок 18 - Нанесение ФСС
1.19 Четвертая фотолитография
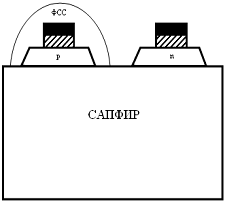
Рисунок 19 - Четвертая фотолитография
1.20 Нанесение БСС
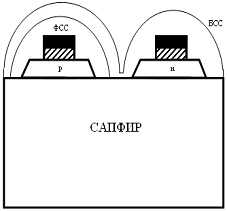
Рисунок 20 - Нанесение БСС
1.21 Пятая фотолитография
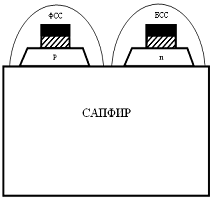
Рисунок 21 - Пятая фотолитография
1.22 Диффузия
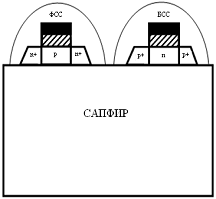
Рисунок 22 - Диффузия
1.23 Удаление ФСС и БСС

Рисунок 23 - Удаление ФСС и БСС
1.24 Термическое оксидирование

Рисунок 24 - Термическое оксидирование
1.25 Шестая фотолитография

Рисунок 25 - Шестая фотолитография
1.26 Напыление Al

Рисунок 26 - Напыление Al
1.27 Седьмая фотолитография

Рисунок 27 - Седьмая фотолитография
2 Технологические операции изготовления КМОП-КНС-ИМ с поликремниевыми затворами
.1 Гетероэпитаксия
Данная операция предназначена для наращивания слоя кремния на сапфире.
Для начала с помощью вакуумного пинцета переместить пластины из транспортной кассеты в кварцевую лодочку и нажать кнопку «пуск». На программаторе задать температуру в реакторе 750ºC и продуть камеру азотом.
Операцию проводить 20 минут.
После окончания процесса с помощью вакуумного пинцета переместить пластины из кварцевой лодочки в транспортировочную кассету.
Заполнить сопроводительный лист и передать партию на следующую операцию.
2.2 Термическое оксидирование
Данная операция предназначена для создания оксидной пленки на поверхности кремниевой подложки.
Для начала поместить пластины из транспортировочной кассеты в пазы кварцевой кассеты - лодочки и лодочку с пластинами установить на площадку загрузочного устройства установки. Запрограммировать: предварительную температуру 1050 ºC, рабочую температуру 1200 ºC, загрузка пластин со скоростью 30 см/мин, нагрев печи со скоростью 20 ºC/мин, подача сухой - влажный - сухой O2, время выдержки 1 час, охлаждение печи 8 ºC/мин, выгрузка пластин 30 см/мин.
Запустить программатор.
С запуском программатора автоматически выполняются технологические переходы оксидирования: продувка камеры азотом, нагрев рабочей зоны до предварительной температуры 1050ºC, загрузка лодочки с пластинами в рабочую зону установки кварцевым толкателем со скоростью 30 см/мин, нагрев печи со скоростью 20ºC/мин до рабочей температуры 1200 ºC, подача парогазовой смеси сухой - влажный - сухой O2, выдержка пластин в течении 1 часа, охлаждение печи со скоростью 8 ºC/мин, выгрузка пластин кварцевым толкателем со скоростью 30 см/мин.
После выгрузки пластин, переставить их в транспортировочную кассету. Заполнить сопроводительный лист.
2.3 Первая фотолитография
Данная операция предназначена для вскрытия окон, через которые проводят локальную диффузию. Для получения, скрытого n-слоя.
Технологический процесс выполнения фотолитографии описан ниже.
Нанесение фоторезиста
Данная операция предназначена для получения соответствующего фотошаблону расположения окон, для доступа травящих веществ к пластине кремния.
В начале процесса нужно пересыпать пластины из транспортировочной кассеты в рабочую, затем поставить рабочую кассету на платформу устройства загрузки выгрузки. В устройстве загрузки выгрузки пластина по пассикам перемещается на полки каретки. Пластина нажимает на рычаг датчика. По сигналу датчика каретка с пластиной перемещается к вакуумному столику центрифуги, с которого упорами каретки предварительно выгружена предыдущая пластина. При движении каретки назад, с помощью фиксатора пластина останавливается. Дальнейшее движение каретки приводит к тому, что полки выезжают из-под пластины, которая опускается на вакуумный столик. Далее на подложку наносят несколько капель фоторезиста, и мгновенно включается центрифуга, так как вязкость фоторезиста быстро меняется из-за испарения растворителя. При вращении центрифуги, жидкий фоторезист растекается по поверхности пластины под действием центробежных сил. Применение пластин кремния с периферийной фаской и работа при частотах вращения центрифуги, больших 2000 об/мин, позволяет получить более плоскую поверхность фотослоя.
После нанесения фоторезиста, пластина по пассикам перемещается в кассету.
Термообработка (первая сушка)
Данная операция предназначена для удаления растворителя из пленки фоторезиста.
В начале процесса нужно поставить кассету в термостат, затем закрыть дверцу термостата и нажать кнопку «Пуск». Основными параметрами процесса сушки является температура и время. Для равномерного испарения растворителя и снижения внутренних механических напряжений в фотослое сушку выполняют в два этапа: (15 - 20) мин при (18 - 20)ºC, (30 - 60) мин при (90 - 120) ºC.
После сушки пластины помещаются в пазы кассеты.
Совмещение и экспонирование фоторезиста
В начале процесса установить рабочую кассету с пластинами на платформу загрузки установки ЭМ-576, установить пустую кассету на платформу выгрузки установки ЭМ-576.
Подложки из кассеты по пневмомолотку поступают на позицию предварительной ориентации, где производится базирование подложки по ее базовому срезу.
После завершения предварительной ориентации подложка вместе со столиком поднимается вверх и прижимается к опорным выступам калибратора, подложка фиксируется вакуумом на калибраторе, переносится им на рабочую позицию и закрепляется на вакуумном подложкодержателе. Производится глубокое совмещение. При больших перемещениях совместить фигуры совмещения. Выполнить очное совмещение. В пределах существенно меньших перемещений с помощью фигур совмещения. После чего нужно:
устранить зазор между фотошаблоном и пластиной;
провести экспонирование.
После выполнения операций совмещения и экспонирования подложка по пневмомолотку подается в приемную кассету;
Проявление фоторезиста
Данная операция предназначена для удаления фоторезиста с засвеченных областей.
Для начала нужно погрузить кассету с пластинами в раствор проявителя, затем в качестве проявителей применить слабые водные и водно-глицериновые щелочные растворы KOH, NaOH, Na3PO4*12H2O. Если слой проэкспонирован не полностью, раствор окрашивается в малиновый цвет, так как часть молекул кислоты превращается в соль натрия, а соединяется с неразрешенными молекулами НХД, образуя краситель.
В конце промыть пластины в потоке деионизованной воды.
Термообработка (вторая сушка)
Данная операция предназначена для полного удаления растворителя из пленки фоторезиста.
Для начала поместим пластины в устройство термообработки, затем проводится вторая сушка для удаления проявителя, воды , повышения химической стойкости и адгезии фотомаски к подложке. Чтобы не произошло ухудшение качества фотомаски. Сушку проводят в два - три этапа с постепенным подъемом температуры до максимальной. Максимальная температура второй сушки 150 ºC, общее время 1,5 часа.
Травление SiO2
Данная операция предназначена для передачи изображения с фотомаски на диоксид кремния путем травления.
Для начала погрузим кассету с пластинами в раствор HF: NH4F:H2O. Затем диссонирующий в растворе фторид аммония связывает газообразный тетрафторид кремния в устойчивый ион, что предотвращает бурное выделение пузырьков тетрафторида кремния, которые оказывают гидромеханическое воздействие на фотомаску и способствует ее отслаиванию.