Материал: Физические основы электроники

|
|
|
|
|
|
|
qUвн |
|
|
|
|
|
|
|
|
|
|
|
|
|
qUвн |
|
|
|
|
|
|
|
|
I |
p n |
qν |
p |
e |
kT p |
|
|
|
qν |
n |
p 0 |
e kT |
n |
p 0 |
|
|
|
||||||||||
|
|
|
p |
n 0 |
|
|
|
|
n 0 |
|
|
|
|
|
n |
|
|
|
|
|
|
|
|
|||||
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
qUвн |
|
|
|
|
|
|
|
|
qUвн |
|
|
|
|
|
|
|
|
|
|
||||
|
qν |
p |
e kT |
|
1 |
qν |
n |
n |
p |
e kT |
1 |
|
|
|
|
|
|
(1.16) |
||||||||||
|
|
|
p n 0 |
|
|
|
|
|
|
|
|
0 |
|
|
|
|
|
|
|
|
|
|
|
|
||||
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
||
|
|
|
|
|
|
|
|
|
qUвн |
|
|
|
|
|
|
qUвн |
|
|
|
|
|
|||||||
|
|
|
|
|
|
|
|
|
kT |
|
|
|
|
|
|
kT |
|
|
|
|
|
|
||||||
|
q νp pn 0 νnnp 0 e |
|
|
|
1 |
Io e |
|
|
|
1 . |
|
|
|
|
||||||||||||||
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
||
|
Обратный ток Io можно выразить следующим образом: |
|
||||||||||||||||||||||||||
|
|
|
Io q νp pn 0 νnnp 0 |
qDp pn0 |
|
qDnnp0 |
, |
|
|
|
|
|||||||||||||||||
|
|
|
|
|
|
|
|
|
||||||||||||||||||||
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
Lp |
|
|
|
|
Ln |
|
|
|
|
|
|
|
где Dn, p – коэффициент диффузии дырок или электронов; |
Ln, p |
– диф- |
||||||||||||||||||||||||||
фузионная длина дырок или электронов. Так как параметры Dn, |
p , pn , |
|||||||||||||||||||||||||||
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
0 |
np , |
Ln, p |
Dn, pτn, p очень сильно зависят от температуры, обратный |
||||||||||||||||||||||||||
0 |
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
ток Iо иначе называют тепловым током.
При прямом напряжении внешнего источника (U вн 0 ) экспонен-
qUвн
циальный член e kT в выражении (1.16) быстро возрастает, что приводит к быстрому росту прямого тока, который, как уже было отмечено, в основном определяется диффузионной составляющей.
При обратном напряжении внешнего источника (U вн 0 ) экспо-
ненциальный член много меньше единицы и ток р–n-перехода практически равен обратному току Io , определяемому в основном дрейфовой
составляющей. Вид этой зависимости представлен на рис. 1.19. Первый квадрант соответствует участку прямой ветви вольт-ам-
перной характеристики, а третий квадрант – обратной ветви. При увеличении прямого напряжения ток р–n-перехода в прямом направлении вначале возрастает относительно медленно, а затем начинается участок быстрого нарастания прямого тока, что приводит к дополнительному нагреванию полупроводниковой структуры. Если количество выделяемого при этом тепла будет превышать количество тепла, отводимого от полупроводникового кристалла либо естественным путем, либо с помощью специальных устройств охлаждения, то могут произойти в полупроводниковой структуре необратимые изменения, вплоть до разрушения кристал-
31
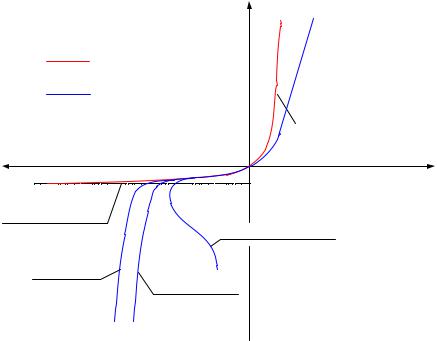
лической решетки. Поэтому прямой ток р–n-перехода необходимо ограничивать на безопасном уровне, исключающем перегрев полупроводниковой структуры. Для этого необходимо использовать ограничительное сопротивление, последовательно подключенное с p–n-переходом.
|
Iпр |
|
Теоретическая ВАХ |
|
|
Реальная ВАХ |
|
|
|
|
Диффузионный ток |
|
|
I In диф I p диф |
Uобр |
Io |
Uпр |
Дрейфовый ток |
Тепловой пробой |
|
I In др I p др |
||
Лавинный пробой Туннельный
пробой
Iобр
Рис. 1.19. Вольт-амперная характеристика p–n-перехода
При увеличении обратного напряжения, приложенного к р–n-переходу, обратный ток изменяется незначительно, т. к. дрейфовая составляющая тока, являющаяся превалирующей при обратном включении, зависит в основном от температуры кристалла, а увеличение обратного напряжения приводит лишь к увеличению скорости дрейфа неосновных носителей, без изменения их количества. Такое положение будет сохраняться до величины обратного напряжения, при котором начинается интенсивный рост обратного тока – так называемый пробой р–n-перехода.
1.7.4. Виды пробоев p–n-перехода
Возможны обратимые и необратимые пробои. Обратимый пробой – это пробой, после которого p–n-переход сохраняет работоспособность. Необратимый пробой ведет к разрушению структуры полупроводника.
Существуют четыре типа пробоя: лавинный, туннельный, тепловой и поверхностный. Лавинный и туннельный пробои объединятся под названием электрический пробой, который является обратимым. К необратимым относят тепловой и поверхностный.
32

Лавинный пробой (рис. 1.20) свойственен полупроводникам со значительной толщиной р–n-перехода, образованного слаболегированными полупроводниками. При этом ширина обедненного слоя гораздо больше диффузионной длины носителей. Пробой происходит под действием
сильного электрического поля с напряженностью E 8 12 104 смВ .
В лавинном пробое основная роль принадлежит неосновным носителям, образующимся под действием тепла в р–n-переходе.
Эти носители испытывают со стороны электрического поля р–n-пере- хода ускоряющее действие и начинают ускоренно двигаться вдоль силовых линий этого поля. При определенной величине напряженности неосновные носители заряда на длине свободного пробега l (рис. 1.20) могут разогнаться до такой скорости, что их кинетической энергии может оказаться достаточно, чтобы при очередном соударении с атомом полупроводника ионизировать его, т. е. «выбить» один из его валентных электронов и перебросить его в зону проводимости, образовав при этом пару «электрон–дырка». Образовавшиеся носители тоже начнут разгоняться в электрическом поле, сталкиваться с другими нейтральными атомами, и процесс, таким образом, будет лавинообразно нарастать. При этом происходит резкий рост обратноготокаприпрактическинеизменномобратномнапряжении.
Параметром, характеризующим лавинный пробой, является коэффициент лавинного умножения M, определяемый как количество актов лавинного умножения в области сильного электрического поля. Величина обратного тока после лавинного умножения будет равна
|
I MI0 , |
|
|
|
||||
M |
I |
|
|
1 |
|
, |
(1.17) |
|
I0 |
|
|
|
n |
||||
|
|
|
|
|
|
|||
|
|
1 |
|
U |
|
|
||
|
|
|
|
|||||
|
|
|
|
Uп |
|
|||
где I0 – начальный ток; U – приложенное напряжение; Uп |
– напряже- |
|||||||
ние лавинного пробоя; n – коэффициент, равный 3 для Ge , 5 – для Si . Туннельный пробой происходит в очень тонких р–n-переходах, что
возможно при очень высокой концентрации примесей ( N 1019 см 3 ),
когда ширина перехода становится малой (порядка 0,01 мкм), и при небольших значениях обратного напряжения (несколько вольт), когда возникает большой градиент электрического поля. Высокое значение напряженности электрического поля, воздействуя на атомы кристаллической решетки, повышает энергию валентных электронов и приводит к их туннельному «просачиванию» сквозь «тонкий» энергетический барьер
33
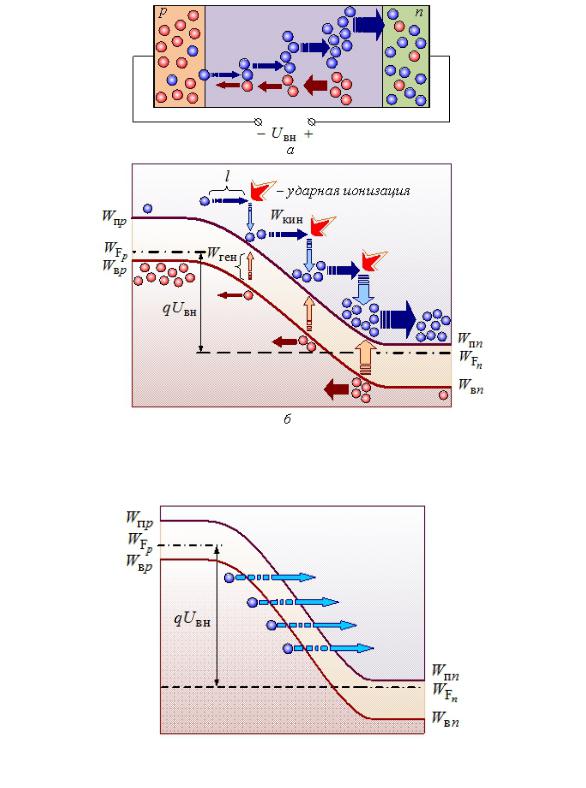
(рис. 1.21) из валентной зоны p-области в зону проводимости n-области. Причем «просачивание» происходит без изменения энергии носителей заряда. Для туннельного пробоя также характерен резкий рост обратного тока при практически неизменном обратном напряжении.
Рис. 1.20. Схема, иллюстрирующая лавинный пробой в p–n-переходе:
а – распределение токов; б – зонная диаграмма, иллюстрирующая лавинное умножение при обратном смещении перехода
Рис. 1.21. Зонная диаграмма, иллюстрирующая туннельный пробой p–n-перехода при обратном смещении
34
Если обратный ток при обоих видах электрического пробоя не превысит максимально допустимого значения, при котором произойдет перегрев и разрушение кристаллической структуры полупроводника, то они являются обратимыми и могут быть воспроизведены многократно.
Тепловым называется пробой р–n-перехода, обусловленный ростом количества носителей заряда при повышении температуры кристалла. С увеличением обратного напряжения и тока возрастает тепловая мощность, выделяющаяся в р–n-переходе, и соответственно температура кристаллической структуры. Под действием тепла усиливаются колебания атомов кристалла и ослабевает связь валентных электронов с ними, возрастает вероятность перехода их в зону проводимости и образования дополнительных пар носителей «электрон–дырка». Если электрическая мощность в р–n-переходе превысит максимально допустимое значение, то процесс термогенерации лавинообразно нарастает, в кристалле происходит необратимая перестройка структуры и р–n-переход разрушается.
Для предотвращения теплового пробоя необходимо выполнение условия
Pрасс UобрIобр Pрасс max , |
(1.18) |
где Pрасс max – максимально допустимая мощность рассеяния.
Поверхностный пробой. Распределение напряженности электрического поля в р–n-переходе может существенно изменить заряды, имеющиеся на поверхности полупроводника. Поверхностный заряд может привести к увеличению или уменьшению толщины перехода, в результате чего на поверхности перехода может наступить пробой при напряженности поля, меньшей той, которая необходима для возникновения пробоя в толще полупроводника. Это явление называют поверхностным пробоем. Большую роль при возникновении поверхностного пробоя играют диэлектрические свойства среды, граничащей с поверхностью полупроводника. Для снижения вероятности поверхностного пробоя применяют специальные защитные покрытия с высокой диэлектрической постоянной.
1.7.5. Емкость р–n-перехода
Изменение внешнего напряжения на p–n-переходе приводит к изменению ширины обедненного слоя и соответственно накопленного в нем электрического заряда (это также обусловлено изменением концентрации инжектированных носителей заряда вблизи перехода). Исходя их этого, p–n-переход ведет себя подобно конденсатору, емкость которого определяется как отношение изменения накопленного в p–n-переходе заряда к обусловившему это изменение приложенному внешнему напряжению.
35