Материал: whDdES57Rc

|
11 |
|
|
|
|
|
|
Для того, чтобы предотвратить неконтролируемое образование анод- |
|||||||
ного слоя, ОУ1 подключен к электрохимической ячейке ЭХЯ через герконо- |
|||||||
вое реле ГР, которое управлялось при помощи источника-измерителя ИИ (NI |
|||||||
PXI-4132). Последний использовался для синхронизации времени переключе- |
|||||||
ния реле с временем начала работы генератора сигнала. |
|
|
|
|
|||
Ток через структуру регистрировался при помощи преобразователя то- |
|||||||
ка в напряжение ПТН на базе операционного усилителя ОУ2 (NE5534). На- |
|||||||
пряжение на выходе ОУ2 и напряжение на электроде сравнения измерялось |
|||||||
при помощи цифрового осциллографа Ос (NI PXI-5102), при этом электрод |
|||||||
сравнения подключался через высокоскоростной ОУ3 (BUF634). |
|
|
|||||
Управление оборудованием и обработка измеренного сигнала осу- |
|||||||
ществлялись с использованием программы, написанной в среде LabVIEW. |
|||||||
Сдвиг по фазе между тестовым напряжением и током через структуру опре- |
|||||||
делялся из аппроксимации измеренных сигналов функцией вида sin ωt. При |
|||||||
определении разности фаз из измеренного тока вычитались плавно меняю- |
|||||||
щаяся постоянная составляющая тока, а также вклад от гармоник текстового |
|||||||
сигнала, возникающих из-за нелинейного отклика системы при больших пря- |
|||||||
мых смещениях. |
|
|
|
|
|
|
|
Результаты работы установ- |
|
800 |
|
|
|
|
|
ки продемонстрированы на приме- |
|
|
Эксперимент |
|
|
||
|
|
Моделирование |
|
||||
|
4 |
600 |
|
||||
ре полупроводниковых структур на |
|
|
|
|
|
||
см− |
|
|
|
|
|
||
|
n = 1 · 10 |
15 |
см |
−3 |
|||
|
|
||||||
|
|
|
|
||||
основе арсенида индия. Эпитакси- |
−2 |
|
|
|
|||
|
|
1 |
|
|
|
||
альные структуры были выращены |
мкФ |
400 |
|
|
|
|
|
|
|
|
|
|
|||
|
|
|
|
|
|
||
|
, |
|
|
|
|
|
|
методом хлоргидридной газофазной |
2 |
|
|
|
|
|
|
1/C |
200 |
|
2 |
|
|
|
|
эпитаксии на сильнолегированных |
|
|
|
|
|||
|
|
|
|
|
|
|
|
n+-InAs подложках. Вольт-фарадные |
|
0 |
|
|
|
|
|
|
|
−0.1 |
0.0 |
|
0.1 |
||
характеристики были измерены в |
|
−0.2 |
|
||||
|
|
|
V, В |
|
|
|
|
|
|
|
|
|
|
|
|
слаболегированных эпитаксиальных |
Рис. 5 – Сравнение вольт-фарадных ха- |
||||||
слоях. |
рактеристик измеренных в двух режи- |
||||||
В качестве электролита ис- |
мах: 1 — режим глубокого обеднения и |
||||||
пользовался водный раствор 0.1 М |
|
|
2 —стационарный |
|
|||
|
|
|
|
|
|
|
|
NaOH. Контакт между электролитом и образцом создавался при помощи |
|||||||
уплотнительного кольца площадью 0.1 см2. Равновесные ВФХ измерялись при |
|||||||
помощи LCR-метра Agilent E4980A. Измерения проводились при комнатной |
|||||||
температуре. |
|
|
|
|
|
|
|

12
Результаты измерений представлены на рис. 5. Обе вольт-фарадные характеристики были измерены при частоте зондирующего сигнала 300 Гц и амплитуде 30 мВ. Частота выбиралась такой, чтобы, во-первых, на время измерения приходилось более 10 периодов изменения сигнала, а во-вторых, реактивная составляющая адмиттанса должна быть много больше, чем его активная составляющая.
В стационарных измерениях наблюдается спад зависимости 1/C2 от V, связанный с ростом концентрации неосновных носителей заряда и началом инверсии. Это приводит к невозможности корректного определения концентрации примеси из вольт-фарадных измерений. В неравновесных CV инверсии носителей заряда не происходит. Из линейной аппроксимации измеренной зависимости 1/C2 от V в области напряжений, соответствующих глубокому обеднению (при напряжениях смещения более 0.05 В), зарегистрирована концентрация основных носителей заряда 1 · 1015 см−3. Это значение находится в хорошем согласии с концентрацией примеси, полученной из результатов измерения магнитосопротивления в этом же образце.
Четвертая глава посвящена особенностям применения метода электрохимического вольт-фарадного профилирования к структурам на базе широкозонных полупроводников и материалов с глубокой примесью. Рассматриваются причины возникновения частотной зависимости барьерной емкости в таких материалах и ее применение для концентрационного профилирования структур с поляризационным легированием.
Большая энергия активации примеси, характерная для многих широкозонным материалов, приводит к тому, что при комнатной температуре только небольшая часть примеси ионизована. Это приводит к возникновению частотной зависимости дифференциальной емкости в таких материалах. На низких частотах емкость будет больше из-за того, что основной вклад в нее будет давать приращение заряда за счет полной ионизации примеси. На частотах, превышающих скорость эмиссии с примесного уровня, примесь не будет успевать ионизироваться и емкость упадет. Помимо неполной ионизации примеси на частотную зависимость емкости могут влиять и эффекты связанные с последовательным сопротивлением структуры.
Эффекты последовательного сопротивления и неполной ионизации примеси рассмотрены на примере образцов n-SiC и p-SiC. На рисунке 6 приведены вольт-фарадные характеристики для обоих образцов в координатах Мотта-Шоттки, измеренные в диапазоне частот от 20 Гц до 2 МГц. В обоих
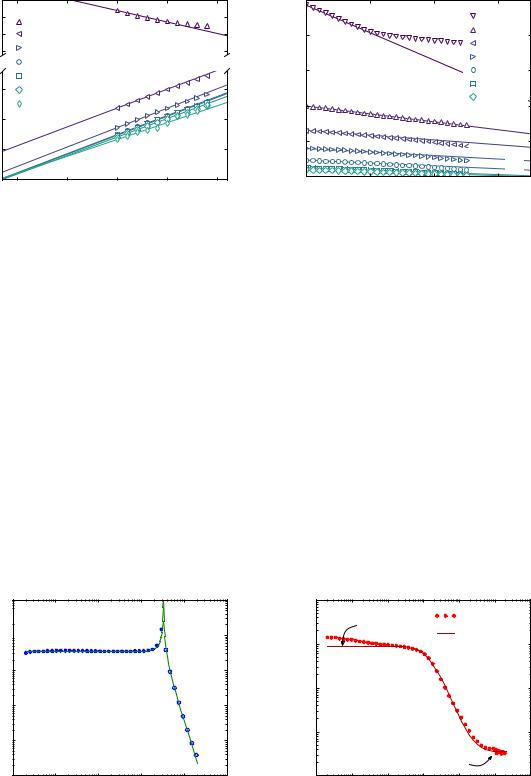
13
1/C2, нФ−2мм−4
40
30
20
10
1.5
1.0
0.5
0.0
|
|
100 |
|
|
||
50 |
кГц |
|
|
40 |
кГц |
|
|
80 |
20 |
кГц |
|||
10 |
кГц |
−4 |
||||
10 |
кГц |
|||||
5 |
кГц |
|
||||
мм |
|
5 |
кГц |
|||
1 |
кГц |
60 |
||||
500 Гц |
2 |
1 |
кГц |
|||
нФ− |
|
100 Гц |
||||
100 Гц |
|
|||||
|
20 Гц |
|||||
50 Гц |
, |
40 |
|
|
||
|
|
2 |
|
|
|
|
|
|
1/C |
20 |
|
|
|
|
|
|
|
|
||
|
|
|
|
(а) |
0 |
|
|
(б) |
|
|
|
|
|
|
|
|
|
−3 |
−2 |
−1 |
0 |
1 |
−2 |
−1 |
0 |
1 |
|
|
V, В |
|
|||||
|
|
V, В |
|
|
|
|
|
|
|
|
|
|
|
|
|
|
Рис. 6 – Вольт-фарадные характеристики в координатах Мотта-Шоттки для: (a) n-SiC и (б) p-SiC
случаях приведена емкость, рассчитанная с использованием последовательной эквивалентной схемы. На графике приведены только часть частот до 50 кГц из ограничений масштабирования. ВФХ для n-SiC (рис. 6, а) практически совпадают на частотах до 5 кГц, что говорит о том, что основным вкладом в измеряемый импеданс дает барьерная емкость. Однако, при частотах свыше 40 кГц можно наблюдать изменение знака тангенса угла наклона ВФХ, что приводит изменению знака рассчитываемой концентрации. Для второго образца p-SiC ВФХ приведены на рисунке 6, б. Здесь вольт-фарадные характеристики в координатах Мотта-Шоттки плавно смещаются при увеличении частоты до 10 кГц. На более высоких частотах емкость начинает резко падать, что приводит к росту зависимости 1/C2 − V .
n, p, см−3
1019



 эксп. 1018
эксп. 1018 
 теор.
теор.
1017
1016
1015 |
|
|
|
|
|
|
1014 |
|
|
|
|
(а) |
|
102 |
103 |
104 |
105 |
106 |
||
101 |
f, Гц
p, см−3
1018 |
|
|
|
|
|
|
|
|
NA |
|
эксп. |
|
|||
|
|
теор. |
|
||||
1017 |
|
|
|
|
|||
|
|
|
|
|
|
||
1016 |
|
|
|
|
|
|
|
1015 |
|
|
|
|
|
|
|
1014 |
|
NA− − ND+ |
(б) |
||||
102 |
103 |
104 |
105 |
106 |
107 |
||
101 |
|||||||
f, Гц
Рис. 7 – Частотная дисперсия измеренной концентрации для образцов: (a) n- SiC и (б) p-SiC. Изменение знака концентрации здесь показано незалитыми кружками
14
Изменение угла наклона на графике Мотта-Шоттки при разных частотах удобно отобразить в виде изменения концентрации, рассчитанной из CV (рис. 7). В работе отмечается, что на частотной зависимости концентрации различие между влиянием последовательно сопротивления и неполной ионизацией глубокой примеси видно лучше. Для образца n-SiC (рис. 7, а) концентрация практически не меняется в диапазоне частот до 30 кГц. После
30 кГц концентрация начинет резко части и далее меняет знак, что показано незалитыми точками. Подобная экспериментальная зависимость хорошо описывается выражением, учитывающим влияние последовательного сопротивления, приведенным в работе. Полученное при моделировании значение последовательного сопротивления RS порядка 500 Ом, скорее всего, связано с сопротивлением электролита.
Совершенно другая частотная зависимость наблюдается в образце p-SiC. Здесь, на низких частотах примесь оказывается полностью ионизованной за счет приложенного напряжения смещения. На частотах более 10 кГц измеряемая концентрация начинает падать. Частота 10 кГц приблизительно соответствует скорости эмиссии глубокого примесного уровня Al в SiC при комнатной температуре. На более высоких частотах концентрация становится равной равновесной концентрации при заданной температуре, и, так как, данный образец был компенсирован алюминием, на высоких частотах концентрация будет равна разности NA− − ND+. Влияние последовательного сопротивления в данном случая не наблюдается из-за того, что барьерная емкость начинает снижаться до достижения критической частоты 1/(CRS), что приводит к сдвигу самой частоты.
Применение эффекта частотной зависимости измеряемой емкости показано на примере исследования структур AlGaN с поляризационным легированием. В подобных структурах, обычные вольт-фарадные измерения не позволяют получить профиль концентрации на большой глубине из-за того, что изменение напряжения смещения на 1 В дает лишь небольшое увеличение ширины ООЗ (порядка 5 нм). В работе показано, что измерение ВФХ на разных частотах, позволяет построить профиль концентрации в полупроводниках с глубокой примесью без необходимости изменять напряжение смещения, а за счет частотной зависимости ширины области объемного заряда, вызванной запаздыванием отклика от глубокой примеси.
15
В заключении приведены основные результаты работы:
1. Показано, что электрохимическое травление полупроводниковых p+-p структур при постоянном напряжении смещения может привести к неравномерному травлению из-за того, что скорость травления p+-слоя значительно выше чем скорость травления слаболегированного слоя. Это может привести к ошибочному росту концентрации на измеряемом ECV профиле.
2.Обоснована необходимость изменения частоты измерения дифференциальной емкости при исследовании структур с резким профилем распределения примеси в методе электрохимического вольт-фарадного профилирования.
3.В узкозонных полупроводниках диапазон смещений, при котором можно измерять концентрацию, достаточно узкий из-за раннего начала режима инверсии. Из-за этого обычные ECV измерения, в частности, дают за-
вышенное значение концентрации в n-InAs с концентрацией примеси меньше 1 · 1018 см−3.
4.Разработан метод неравновесных вольт-фарадных измерений в системе электролит-полупроводник, который позволяет проводить корректные измерения концентрации примеси в n-InAs начиная с 1 · 1015 см−3.
5.Предложенная методика измерения вольт-фарадных характеристик
всистеме электролит-полупроводник в широком диапазоне частот позволяет расширить информативность метода электрохимического вольт-фарадного профилирования за счет дополнительной возможности изучения динамических характеристик глубокой примеси.
6.Показано, что исследование частотной дисперсии измеряемой в CV методе концентрации позволяет разделить вклад последовательного сопротивления и неполной ионизации примеси в широкозонных полупроводниках.
7.Анализ теории барьерной емкости в полупроводниках с глубокой примесью показал, что угол наклона вольт-фарадных характеристик в координатах Мотта-Шоттки, измеренных на низких частотах, пропорционален полной концентрации электрически активной примеси.
8.Показано, что частотная дисперсия емкости в структурах с поляризационным легированием может быть использована для построения профиля концентрации в случае, если изменение ширины области объемного заряда в диапазоне прикладываемый напряжений оказывается недостаточным для построения профиля концентрации обычными вольт-фарадными методами.