Материал: Расчет электронно-дырочного перехода
Расчет электронно-дырочного перехода
Министерство образования и науки Российской Федерации
Федеральное государственное бюджетное образовательное учреждение высшего профессионального образования
«Южно-Уральский государственный университет»
(Национальный исследовательский университет)
Факультет «Компьютерных технологий, управления и радиоэлектроники»
Кафедра «Конструирование и
производство радиоаппаратуры»
ПОЯСНИТЕЛЬНАЯ ЗАПИСКА К КУРСОВОЙ РАБОТЕ
по дисциплине «Физика твердого тела»
Расчёт электронно-дырочного перехода
Руководитель В.А. Бухарин
Автор проекта студент группы КТУР-281
М.В. Колыхматов
Челябинск 2016
Исходные данные
Электронно-дырочный переход формируется диффузией
фосфора в кремниевую подложку p-типа с концентрацией исходной примеси Nисх. Поверхностные концентрации примеси
фосфора N0Д. Глубина залегания p-n-перехода X. Определить вольтамперную
характеристику, барьерную и диффузионную ёмкости, пробивное напряжение
электронно-дырочного перехода.
Таблица 1
Исходные данные p-n перехода
№
вар. Nисх, ![]() N0Д,
N0Д,
мкм
6
Содержание пояснительной записки:
1) Аннотация.
) Оглавление.
) Анализ технического задания.
) Введение.
) Описание технологии изготовления электронно-дырочного
перехода
) Расчётная часть.
) Конструкция диода современной твердотельной САПР
) Классификация разработанного электронно-дырочного перехода
по граничной частоте и рассеиваемой мощности.
) Основные особенности использования диодных структур в
интегральных схемах.
) Заключение.
) Список литературы.
Календарный план
электронный дырочный переход диодный
Наименование разделов
курсовой работы
Срок выполнения разделов
работы
Отметка руководителя о
выполнении
Выдача задания к курсовой
работе
03.02.2016
Изучение литературы по теме
электронно-дырочного перехода
24.02.2016
Расчёт вольтамперной
характеристики, барьерной и диффузионной ёмкости, пробивного напряжения
электронно-дырочного перехода в черновом виде
24.03.2016
Расчет вольтамперной
характеристики, барьерной и диффузионной ёмкости, пробивного напряжения
электронно-дырочного перехода в чистовом виде
21.04.2016
Оформление работы
19.05.2016
АННОТАЦИЯ
Колыхматов М. В. Расчёт электронно-дырочного перехода. - Челябинск:
ЮУрГУ, КТУР, 2016, с. 32, 19 илл., Библиография литературы - 11 наименований,
приложение -1.
В данной работе ставилась задача изучить литературу по теме
электронно-дырочного перехода, определить вольтамперную характеристику,
барьерную и диффузионную ёмкости, пробивное напряжение, граничную частоту, максимальную
мощность рассеивания электронно-дырочного перехода.
В работе были рассчитаны характеристики полупроводникового диода,
изготовленного по диффузионной технологии. Рассмотрены технологии изготовления,
принцип действия, физические процессы в полупроводниковых диодах. Изучено
применение диодных структур в интегральных схемах. Дано наглядное изображение
полупроводникового диода.
ОГЛАВЛЕНИЕ
ЗАДАНИЕ
ВВЕДЕНИЕ
. АНАЛИЗ ТЕХНИЧЕСКОГО ЗАДАНИЯ
. ТЕХНОЛОГИИ ИЗГОТОВЛЕНИЯ ЭЛЕКТРОННО-ДЫРОЧНОГО ПЕРЕХОДА
. РАСЧЕТНАЯ ЧАСТЬ
. ИСПОЛЬЗОВАНИЕ ДИОДНЫХ СТРУКТУР В ИНТЕГРАЛЬНЫХ СХЕМАХ
. ЗАКЛЮЧЕНИЕ
. БИБИОГРАФИЧЕСКИЙ СПИСОК
ПРИЛОЖЕНИЯ
Полупроводниковый диод - это электро-преобразовательный полупроводниковый
прибор с одним электрическим переходом и двумя выводами, в котором используются
свойства р-n- перехода.
Полупроводниковые диоды классифицируются:
1) по назначению: выпрямительные, высокочастотные и
сверхвысокочастотные (ВЧ- и СВЧ- диоды), импульсные, полупроводниковые
стабилитроны (опорные диоды), туннельные, обращенные, варикапы и др.;
2) по конструктивно - технологическим особенностям: плоскостные и
точечные;
) по типу исходного материала: германиевые, кремниевые, арсенидо -
галлиевые и др.
Рисунок 1 Устройство точечных диодов Для изготовления германиевых точечных диодов к пластинке германия
приваривают проволочку из вольфрама, покрытого индием. Индий является для
германия акцептором. Полученная область германия р-типа является эмиттерной.
Для изготовления кремниевых точечных диодов используется кремний n- типа и проволочка, покрытая
алюминием, который служит акцептором для кремния.
В плоскостных диодах р-n-переход
образуется двумя полупроводниками с различными типами электропроводности,
причем площадь перехода у различных типов диодов лежит в пределах от сотых
долей квадратного миллиметра до нескольких десятков квадратных сантиметров
(силовые диоды).
Плоскостные диоды изготовляются методами сплавления (вплавления) или
диффузии (2).
Рисунок 2 Устройство плоскостных диодов, изготовленных сплавным (а) и
диффузионным методом (б)
В пластинку германия n-типа
вплавляют при температуре около 500°С каплю индия (рис. 2, а) которая, сплавляясь с германием,
образует слой германия р-типа. Область с электропроводностью р-типа имеет более
высокую концентрацию примеси, нежели основная пластинка, и поэтому является
эмиттером. К основной пластинке германия и к индию припаивают выводные
проволочки, обычно из никеля. Если за исходный материал взят германий р-типа,
то в него вплавляют сурьму и тогда получается эмиттерная область n- типа.
Диффузионный метод изготовления р-n-перехода основан на том, что атомы примеси диффундируют в
основной полупроводник (рис. 2, б). Для создания р-слоя используют диффузию
акцепторного элемента (бора или алюминия для кремния, индия для германия) через
поверхность исходного материала.
1. АНАЛИЗ ТЕХНИЧЕСКОГО ЗАДАНИЯ
В ходе работы необходимо будет рассчитать полупроводниковый диод. В
задании на курсовое проектирование приведены только основные величины, которых
недостаточно для полного расчета параметров полупроводникового диода. Поэтому,
в расчетной части будут указаны дополнительные величины и их значения,
необходимые для проведения расчёта. Исходя из задания, следует, что
полупроводниковый диод изготавливается по диффузионной технологии.
Диффузия - это взаимное проникновение соприкасающихся
веществ друг в друга вследствие теплового движения частиц вещества. Диффузия
происходит в направлении падения концентрации вещества и ведёт к равномерному
распределению вещества по всему занимаемому им объёму (к выравниванию
химического потенциала вещества). Коэффициент диффузии в твёрдых телах крайне
чувствителен к дефектам кристаллической решётки, возникшим при нагреве,
напряжениях, деформациях и других воздействиях. Увеличение числа дефектов
(вакансий) облегчает перемещение атомов в твёрдом теле и приводит к росту
коэффициента диффузии, для которого в твёрдых телах характерна резкая
(экспоненциальная) зависимость от температуры. В результате диффузии носителей
в полупроводниках возникает электрический ток, перемещение носителей заряда в
полупроводниках обусловлено неоднородностью их концентрации. Для создания
полупроводникового диода в одну из поверхностей германия вплавляют индий.
Вследствие диффузии атомов индия в глубь монокристалла германия в нем
образовывается р-n-переход, по
которому может идти значительный ток при минимальном сопротивлении. Диффузия
имеет широкое применение в повседневной жизни, используется практические во
всех отраслях промышлености - от легкой до тяжелой.
Исторически первые полупроводниковые диоды изготавливались с помощью иглы
(контакта), с помощью которой выбирали микрокристалл, образующий с основной
массой p-n- переход. Эти диоды были относительно высокочастотными, но работали
с малыми мощностями.
Первые силовые полупроводниковые диоды назывались купроксные и селеновые
выпрямители. В первых - медная пластина со слоем закиси меди с нанесенной
поверх металлизацией (выпрямляющий контакт Cu-Cu2O).
Во вторых - металлическая пластина, покрытая слоем закристаллизованного
селена, поверх которого нанесен слой легирующего металла (переход p-Se - n-Se).
Точечные диоды - малые емкости, высокие рабочие частоты, малые мощности:
Рисунок 3 Точечный диод
Сплавные диоды - высокие рабочие токи и напряжения, но значительные
емкости и низкие рабочие частоты:
Рисунок 4 Сплавной диод
Планарная диффузионная технология:
Рисунок 5 Планарная диффузионная технология
Планарная эпитаксиальная и эпитаксиально-диффузионная технология:
Рисунок 6 Планарная эпитаксиальная и эпитаксиально-диффузионная
технология
Меза-диффузионная и меза-эпитаксиальная технологии - уменьшение площади
перехода (для уменьшения емкостей и увеличения рабочих частот) специальным
травлением:
Рисунок 7 Меза-диффузионная и меза-эпитаксиальная технологии
Локос-технология - уменьшение площади перехода локальным объемным
Рисунок 8 Локос-технология
Процесс диффузии выражается формулой [7, с. 260]:
где
Диффузия
фосфора в кремниевую подложку проводится при температуре 1000 - 1200о C. В
данной работе диффузия для фосфора производится при температуре 1400 К. Энергия
активации - минимальное количество энергии, которое должны получить электроны
донорной примеси, для того чтобы попасть в зону проводимости. По формуле (2)
рассчитываем коэффициенты диффузии фосфора. [11, с. 11]:
где
Значения
для Подставив
все значения в формулу (2), получаем коэффициент диффузии фосфора:
Учитывая,
что на глубине залегания p-n перехода X = 2 Подставив в формулу (3) известные величины, получим:
t = 5.5294 После
окончания процесса диффузии фосфора в кремниевую подложку концентрация примеси
на поверхности кристалла стала равной Для
того, чтобы определить концентрацию сформировавшейся донорной примеси на
расстоянии глубины залегания p-n перехода, обусловленной диффузией фосфора,
воспользуемся формулой процесса диффузии (1):
Суммарная
концентрация доноров после процесса диффузии на глубине залегания эмиттерного
перехода равна На
рисунке (9) представлен график распределения примесей после диффузии:
Рисунок
9 Зависимость концентрации от глубины p-n перехода
На
рисунке (10) представлено результирующее распределение N(x) в
логарифмированном масштабе.
Рисунок
10 Логарифмированный график функции N(x)
Ширина
плавного перехода находится по формуле [1, с. 25]:
где
????0 -
диэлектрическая постоянная, ????0=8,85∙10-12
Ф/м;
???? - относительная диэлектрическая проницаемость, ???? = 12;
Uполн - полное
напряжение на переходе, в данном случае Для
расчета ширины p-n-перехода необходимо найти градиент концентрации
донорной примеси, определяющейся как первая производная от концентрации
соответствующей примеси и выражаются следующей формулой:
После
подстановки численных значений в формулу (6) получаем:
Также
необходимо найти Где
X - глубина залегания перехода, X=2 Рисунок
11 Решение трансцендентного уравнения
Получаем
Получив
неизвестные переменные, рассчитаем ширину p-n
перехода по формуле (5):
Для
того чтобы построить вольт-амперную характеристику диода, воспользуемся
известной формулой Шокли:
где
где
Время
жизни неосновных носителей найдём по формулам [1, c. 30]:
где
Средняя
тепловая скорость электронов определяется по формуле [5, c.48]:
где
Эффективная
масса носителей заряда определяется по формулам [9, с. 238]:
где
Подставив
известные значения в формулы (15) и (16), получаем:
Подставляя
в формулу (14) найденные значения, определяем тепловые скорости электронов и
дырок:
Сечения
захвата рекомбинационных центров для электронов и дырок:
После
подстановки всех неизвестных переменных в формулы (12) и (13) получаем:
Подставляем
получившиеся значения в формулы (11) и (12) получим диффузионные длины
носителей заряда:
Концентрации
основных и неосновных носителей заряда можно найти следующим способом:
где
Подставив
значения получим:
Подставляя
в формулу (9) найденные значения, определяю ток насыщения:
На
рисунке (12) представлена вольт-амперная характеристика идеального диода.
Рисунок
12 Вольт-амперная характеристика диода
где
В
результате подстановки найденных нами переменных, подставим значения в формулу
(23), в итоге:
Расчёт
барьерной емкости буду вести по формуле [7, c. 147]:
где
ε = 11,8 - относительная диэлектрическая проницаемость кремния;
U -
напряжение смещения перехода, В.
Рисунок 13 Зависимость барьерной емкости от обратного напряжения
При нулевом напряжении смещения барьерная емкость равна 0,2859 нФ.
Диффузионная емкость описывается следующим выражением [2, с. 103]:
где
На
рисунке (13) показана зависимость диффузионной емкости от прямого напряжения.
Рисунок 13 Зависимость диффузионной емкости от прямого напряжения
Диффузионная
емкость растет с увеличением времени жизни неосновных носителей Найдём
граничную частоту полученного p-n перехода. Для этого воспользуемся следующей формулой:
где
Рассчитаем
сопротивление n-области
где
Удельное
сопротивление n-области находится по следующей формуле:
где
Удельную
проводимость можно найти по формуле:
где
Nд-
концентрация доноров на границе ОПЗ, N=Nисх;
Получим:
Произведём
тепловой расчёт.
Интегральная микросхема (ИМС) - это конструктивно законченное изделие
электронной техники, выполняющее определенную функцию преобразования информации
и содержащее совокупность электрически связанных между собой электрорадиоэлементов
(ЭРЭ), изготовленных в едином технологическом цикле. Термин «интегральная
микросхема» отражает: объединение значительного числа транзисторов, диодов,
конденсаторов, резисторов и соединяющих проводников в единую конструкцию
(конструктивная интеграция); выполнение схемой функций преобразования
информации, более сложных по сравнению с функциями отдельных ЭРЭ
(схемотехническая интеграция); выполнение в едином технологическом цикле
одновременно всей схемы и межсоединений и одновременное формирование групповым
методом большого числа одинаковых ИМС (технологическая интеграция).
Процесс создания полупроводниковой микросхемы сводится к формированию в
приповерхностном слое полупроводниковой пластины элементов (транзисторов,
диодов, резисторов) и к последующему их объединению в функциональную схему
пленочными проводниками по поверхности пластины (межсоединения).
Для характеристики типа применяемых в ИМС транзисторов, а также
технологических методов их изготовления пользуются понятием структура ИМС. В
общем случае структура ИМС определяет последовательность слоев в составе
микросхемы по нормали к поверхности кристалла, различающихся материалов,
толщиной и электрофизическими свойствами. Так, в практике производства ИМС
используют структуры на биполярных транзисторах (в частности,
диффузионно-планарные, эпитаксиально-планарные и др.) на МДП-приборах,
структуры И²Л и т. д. Заданная структура ИМС позволяет установить состав
и последовательность технологических методов обработки пластины и определить
технологические режимы для каждого метода.
На рисунке 14 представлен фрагмент ИМС с диффузионно-планарной
структурой, включающий биполярный транзистор и резистор. Для одновременного
формирования транзистора и резистора необходимо, чтобы р-область резистора и
изолирующая его n-область имели
глубину и электрофизические свойства, одинаковые с областями соответственно
базы и коллектора транзистора. Аналогичное соответствие должно обеспечиваться
для всех элементов, входящих в состав ИМС. Оно является главным признаком и
непременным условием применения интегральной технологии и позволяет
минимизировать число технологических операций, составляющих цикл обработки.
Таким образом, интегральная технология представляет собой совокупность
методов обработки, позволяющую при наличии структурного подобия
(технологической совместимости) различных элементов ИМС формировать их
одновременно в едином технологическом процессе.
Важно отметить, что выпускаемые в составе той или иной серии ИМС
различного функционального назначения имеют единую структуру и, следовательно,
единую базовую технологию. Для базовой технологии характерны не только
определенная технологическая последовательность обработки и определенный
комплект оборудования, но и постоянная, отработанная настройка оборудования, т.
е. жесткие технологические режимы. Последнее является существенным для
экономичности и эффективности процесса производства ИМС.
Очевидно, что базовая технология не зависит от размеров элементов в
плане, их взаимного расположения и рисунка межсоединений. Все эти свойства
конкретной ИМС определяются в процессе топологического проектирования, а
обеспечиваются фотолитографией - процессом избирательного травления
поверхностных слоев с применением защитной фотомаски.
Рисунок 14 Фрагмент ИМС с диффузионно-планарной структурой: T - транзистор; R - резистор
Топология микросхемы - чертеж, определяющий форму, размеры и взаимное
расположение элементов и соединений ИМС в плоскости, параллельной плоскости
кристалла. Поскольку элементы и соединения формируются путем последовательного
отдельных слоев (коллекторный слой, базовый слой и т. д.), различают общую и
послойную топологию. По чертежу базового слоя, например, может быть разработан
чертеж фотошаблона, с помощью которого создают окисную маску для избирательной
диффузии примеси р-типа.
При заданном наборе элементов топология ИМС (точнее, рисунок
межсоединений) определяет ее функциональные свойства. Можно представить себе
кристалл, содержащий некоторый универсальный набор элементов (очевидно, с
некоторой избыточностью) и сплошной слой металлизации. Такие кристаллы в
составе общей пластины могут быть «доработаны» по желанию заказчика до
конкретных функциональных ИМС в зависимости от рисунка межсоединений,
выполненного с помощью соответствующего фотошаблона. Описанная универсальная
пластина-заготовка, получившая название базового кристалла, позволяет
обеспечить экономичность производства ИМС более узкого, специального
применения, выпускаемых в небольших количествах.
Рисунок 15 Фрагменты общей (а) и послойной (базового слоя) (б) топологии
ИМС: 1 - дефекты, возникшие на этапе металлизации; 2 - дефекты, возникшие на
этапе диффузии примеси
Применение полупроводниковых интегральных микросхем, однако, ограничено
рядом причин. Одна из них заключается в том, что производство полупроводниковых
ИМС оказывается целесообразным лишь в крупносерийном и массовом производстве,
когда становятся экономически оправданными значительные затраты на подготовку
производства (главным образом на проектирование и изготовление комплекта
фотошаблонов). Другая причина лежит в ряде ограничений на параметры элементов и
ИМС в целом: невысокая точность диффузионных резисторов (±10%) и отсутствие
возможности их подгонки, невозможность получать конденсаторы достаточно больших
емкостей, температурные ограничения, ограничения по мощности и др.
Наряду с полупроводниковыми ИМС поэтому разрабатывают и выпускают
комбинированные гибридные интегральные микросхемы. Технологической основой
таких ИМС являются процессы нанесения резисторов, конденсаторов, проводников и
контактов в виде пленок соответствующих материалов на диэлектрическую пассивную
подложку. Поскольку активные элементы - транзисторы, диоды - не могут быть
изготовлены по пленочной технологии, их изготовляют по известной
полупроводниковой технологии, а затем монтируют на общей подложке (рисунок 16).
Рисунок 16 Фрагмент гибридной ИМС: R - резистор, С - конденсатор, ПП - кристалл
полупроводникового прибора
Гибридная пленочная интегральная микросхема - ИМС, которая наряду с
пленочными элементами, полученными с помощью интегральной технологии, содержит
компоненты, имеющие самостоятельное конструктивное оформление. В зависимости от
метода нанесения пленочных элементов на подложку различают тонкопленочные
(напыление в вакууме) и толстопленочные (трафаретная печать) гибридные ИМС. Стремление расширить область применения полупроводниковых ИМС привело к
созданию другого типа комбинированных микросхем (рисунок 16). При их
изготовлении полупроводниковую технологию совмещают с тонкопленочной
технологией для создания некоторых пассивных элементов, к которым предъявляются
повышенные требования по точности и температурной стабильности.
Рисунок 17 Фрагмент совмещенной ИМС: Т - транзистор, R - пленочный резистор
Совмещенная интегральная микросхема - это комбинированная интегральная
полупроводниковая микросхема, в которой некоторые элементы (обычно пассивные)
наносят на поверхность пластины (кристалла) методами пленочной технологии.
Изучены общие сведения по диодам, физические принципы работы, технологии
получения p-n перехода, использование диодных структур в интегральных
микросхемах и другие особенности полупроводниковых приборов.
По разработанной методике был рассчитан p-n переход, полученный
диффузионным методом.
1. Королёв, В.Л. Конструирование полупроводниковых
интегральных схем: учеб. пособие для студентов специальности 230.- «
Конструирование и технология радиоэлектронных средств» / В.Л. Королев, Л.Д.
Карпов. КрПИ. Красноярск, 1992, 118 с.
2. Тугов, Н.М. Полупроводниковые приборы: учебник для
вузов/ Н.М. Тугов, Б.А. Глебов, Н.А. Чарыков; под ред. В.А. Лабунцова. М.:
Энергоатомиздат, 2016. 576 с.
. Коледов Л.А. Технология и конструкции микросхем,
микропроцессоров и микросборок: учебник для вузов/ Л.А. Коледов. М.: Радио и связь, 1989. 400 с.
4. Епифанов, Г.И. Физические основы микроэлектроники / Г.И.
Епифанов. Москва: Советское радио, 1971. 276 с.
5. Пономарев, М.Ф. Конструкции и расчеты микросхем и
микроэлементов: учебник для вузов / М.Ф. Пономарев. ЭВА. М.: Радио и связь,
1982. 288 с.
. Росадо, Л. Физическая электроника и
микроэлектроника: учеб. пособие для студентов/ Л. Росадо. М.: Высшая школа,
1991.
. Степаненко, И. П. Основы теории транзисторов и
транзисторных схем / И.П. Степаненко. Москва: Энергия, 1977. 672 с.
8. Сугано, Т. Введение в
микроэлектронику: пер. с япон. / Т. Сугано, Т. Икома, Е. Такэиси. М.: Мир,
1988. 320 с.
9. Трутко, А. Ф. Методы расчёта транзисторов / А.Ф. Трутко.
Москва: Энергия, 1971. 272 с.
10. Шахгильдяна В.В. Проектирование
радиопередающих устройств: Учеб. пособие для вузов / Под ред. В.В.Шахгильдяна. М.: Связь, 1976.
11. Королёв В. Л., Карпов Л. Д. Конструирование
полупроводниковых интегральных схем: Учеб. пособие для студентов специальности
2303. « Конструирование и
технология радиоэлектронных средств» / КрПИ. Красноярск, 1992, 118 с.
ПРИЛОЖЕНИЯ
Рисунок 18 Общий вид диода
Рисунок 19 Диод без корпуса
![]() X,
X,
![]()
![]() 2
2
ВВЕДЕНИЕ


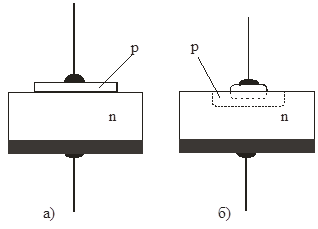
2. ТЕХНОЛОГИИ
ИЗГОТОВЛЕНИЯ ЭЛЕКТРОННО-ДЫРОЧНОГО ПЕРЕХОДА
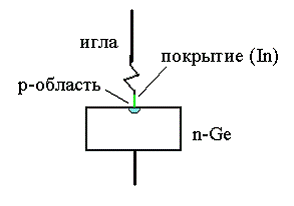

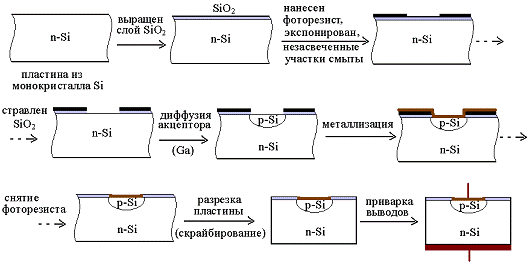
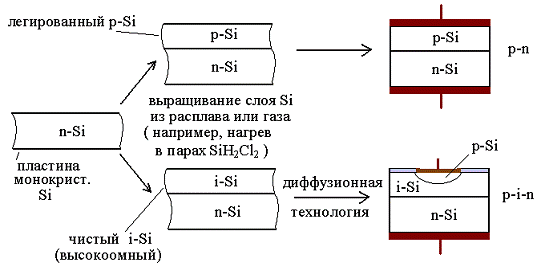


3.
РАСЧЕТНАЯ ЧАСТЬ
![]()
![]() , (1)
, (1)
![]()
![]() -
концентрация примеси на расстоянии
-
концентрация примеси на расстоянии ![]()
![]() от
поверхности диффузии по истечении времени диффузии
от
поверхности диффузии по истечении времени диффузии ![]()
![]() , см-3;
, см-3;
![]()
![]() -
концентрация примеси в начальной точке на поверхности, см-3;
-
концентрация примеси в начальной точке на поверхности, см-3;
![]()
![]() - коэффициент диффузии, см2/с;
- коэффициент диффузии, см2/с;
![]()
![]() -
расстояние от поверхности диффузии, см;
-
расстояние от поверхности диффузии, см;
![]()
![]() - время
диффузии, с.
- время
диффузии, с.
![]()
![]() , (2)
, (2)
![]()
![]() -
предэкспоненциальный множитель диффузии, м2∙с;
-
предэкспоненциальный множитель диффузии, м2∙с;
![]()
![]() -
энергия активации электрона, эВ;
-
энергия активации электрона, эВ;
![]()
![]() -
постоянная Больцмана;
-
постоянная Больцмана; ![]()
![]() = 8.61∙10-5
эВ/К;
= 8.61∙10-5
эВ/К;![]()
![]()
![]()
![]() -
температура диффузии;
-
температура диффузии; ![]()
![]() = 1400
К.
= 1400
К.
![]()
![]() и
и ![]()
![]() фосфора
приведены в приложении 3 [ 1, c.107]:
фосфора
приведены в приложении 3 [ 1, c.107]:
![]()
![]() = 10,5см2/с;
= 10,5см2/с;
![]()
![]() = 3,7 эВ.
= 3,7 эВ.
![]()
![]() м2/с.
м2/с.
![]()
![]() 10-6
м должно выполняться условие Nисх=5
10-6
м должно выполняться условие Nисх=5![]()
![]() 1016
см-3, Nод=2
1016
см-3, Nод=2![]()
![]() 1018
см-3, для определения времени диффузии фосфора необходимо
провести преобразования формулы (1) и получим:
1018
см-3, для определения времени диффузии фосфора необходимо
провести преобразования формулы (1) и получим:
![]()
![]() , (3)
, (3)
![]()
![]() 103
103
![]() с.
с.
![]() .
.
![]()
![]() . (4)
. (4)
![]() .
.
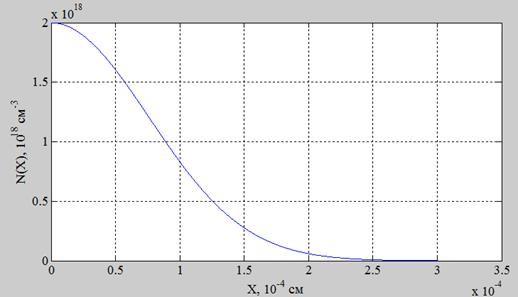
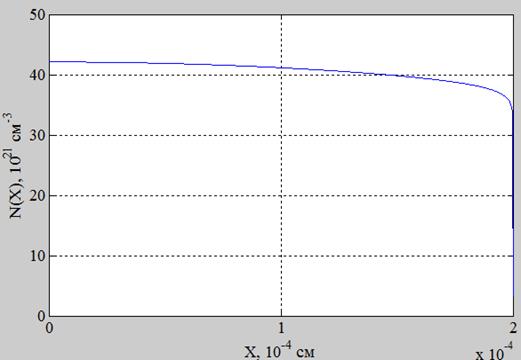

 (5)
(5)
![]() ;
;![]() -
градиент концентрации примеси в плавном p-n-переходе.
-
градиент концентрации примеси в плавном p-n-переходе.
![]()
![]() (6)
(6)
![]() =1,8444
=1,8444![]()
![]() 1021
1021
![]() - контактную разность потенциалов. Она может быть
найдена из решения трансцендентного уравнения [11, с. 25]:
- контактную разность потенциалов. Она может быть
найдена из решения трансцендентного уравнения [11, с. 25]:

 , (7)
, (7)
![]()
![]() 10-6
м;
10-6
м;
![]() -
концентрация носителей заряда в собственном (нелегированном) полупроводнике,
-
концентрация носителей заряда в собственном (нелегированном) полупроводнике, ![]() =
=![]() см -3.
см -3.
![]() -
параметр, зависящий от отношения
-
параметр, зависящий от отношения ![]() ,
, ![]() =40 Решим уравнение графическим методом.
=40 Решим уравнение графическим методом.

![]() =0,7096 В.
=0,7096 В.
![]() 3,1118
3,1118![]()
![]() 10-5
м
10-5
м
![]()
![]() , (8)
, (8)
![]()
![]() -
температура, 300 К;- площадь перехода, 10-8 м;
-
температура, 300 К;- площадь перехода, 10-8 м;
![]()
![]() -
постоянная Больцмана, 1,38∙10-23 Дж/К;
-
постоянная Больцмана, 1,38∙10-23 Дж/К;
![]()
![]() - заряд
электрона, 1,6∙10-19 Кл;
- заряд
электрона, 1,6∙10-19 Кл;
![]()
![]() - ток
насыщения, который определяется формулой [4, с. 276]:
- ток
насыщения, который определяется формулой [4, с. 276]:
![]()
![]() (9)
(9)
![]() =12 см2/с,
=12 см2/с, ![]() =12 см2/с
коэффициенты диффузии неосновных носителей есть физические константы
полупроводника (прил. 5) [1, с. 108];
=12 см2/с
коэффициенты диффузии неосновных носителей есть физические константы
полупроводника (прил. 5) [1, с. 108];
![]() ,
,![]() - концентрации основных и неосновных носителей
заряда;
- концентрации основных и неосновных носителей
заряда;
![]() и
и ![]() - диффузионные длины носителей заряда, которые мы
можем найти по формулам:
- диффузионные длины носителей заряда, которые мы
можем найти по формулам:
![]()
![]() , (10)
, (10)
![]()
![]() , (11)
, (11)
![]()
![]() , (12)
, (12)
![]()
![]() , (13)
, (13)
![]()
![]() ,
, ![]()
![]() -
средние тепловые скорости электронов и дырок;
-
средние тепловые скорости электронов и дырок;
![]()
![]() ,
, ![]()
![]() - сечения захвата рекомбинационных центров для
электронов и дырок.
- сечения захвата рекомбинационных центров для
электронов и дырок.
![]()
![]() , (14)
, (14)
![]() - постоянная Больцмана, Дж/К;
- постоянная Больцмана, Дж/К;
![]()
![]() = 300 -
абсолютная температура, К;
= 300 -
абсолютная температура, К;
![]()
![]() - эффективная масса носителей заряда, кг.
- эффективная масса носителей заряда, кг.
![]()
![]() ,, (15)
,, (15)
![]()
![]() , (16)
, (16)
![]()
![]() -
эффективная масса электронов, кг;
-
эффективная масса электронов, кг;
![]()
![]() -
эффективная масса дырок, кг;
-
эффективная масса дырок, кг;
![]()
![]() - масса
покоя электрона, кг.
- масса
покоя электрона, кг.
![]()
![]() = 2,36∙10-31
кг,
= 2,36∙10-31
кг,
![]()
![]() = 4,459∙10-31
кг.
= 4,459∙10-31
кг.
![]()
![]() м/с =2,2911·107 см/с,
м/с =2,2911·107 см/с,
![]()
![]() м/с =1,6689·107 см/c.
м/с =1,6689·107 см/c.
![]() =
7,065*10-19
=
7,065*10-19
![]() =
7,065*10-21
=
7,065*10-21
![]() = 4,4509·10-12 с,
= 4,4509·10-12 с,
![]() =1,2356·10-10 с.
=1,2356·10-10 с.
![]() =
7,1334·10-6
=
7,1334·10-6
![]() =
6,4814·10-5
=
6,4814·10-5
![]()
![]() , (17)
, (17)
![]()
![]() , (18)
, (18)
![]()
![]() - собственная
концентрация,
- собственная
концентрация, ![]()
![]() = 1,5∙1016
м-3.
= 1,5∙1016
м-3.
![]()
![]() = 4500
см-3;
= 4500
см-3;
![]()
![]() = 112,5
см-3.
= 112,5
см-3.
![]() = 4,0797·10-10, А
= 4,0797·10-10, А
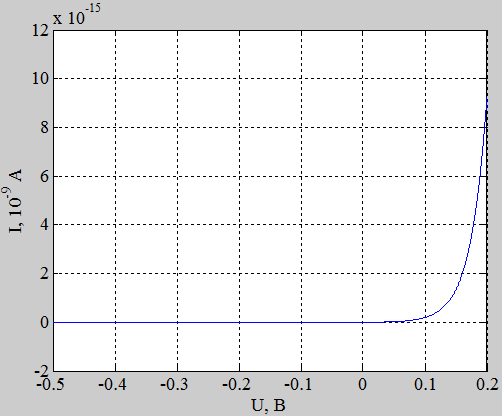
 (19)
(19)
![]() - ширина запрещенной зоны полупроводника,
- ширина запрещенной зоны полупроводника, ![]() =1.11 эВ;
=1.11 эВ;
![]() -
градиент концентрации примесей.
-
градиент концентрации примесей.
![]() =
29,3339, В
=
29,3339, В
 ,
(20)
,
(20)
![]()
![]() -
площадь соответствующего перехода, 10-4 см2;
-
площадь соответствующего перехода, 10-4 см2;
![]()
![]() ширина
соответствующего перехода, см;
ширина
соответствующего перехода, см;
![]()
![]() = 0,7096
- диффузионный потенциал для кремния, В;
= 0,7096
- диффузионный потенциал для кремния, В;
![]()
![]() -
электрическая постоянная, Ф/см;
-
электрическая постоянная, Ф/см;

![]()
![]() , (21)
, (21)
![]()
![]() - время
жизни дырок,
- время
жизни дырок, ![]()
![]() =
= ![]()
![]() ;
;
![]()
![]() - время
жизни электронов,
- время
жизни электронов, ![]()
![]() =
= ![]()
![]() ;
;
![]()
![]() -
температурный потенциал,
-
температурный потенциал, ![]()
![]() = 0,0255
В при Т = 300 К.
= 0,0255
В при Т = 300 К.

![]()
![]() ,
, ![]()
![]() или
диффузионной длины
или
диффузионной длины ![]()
![]() ,
,![]()
![]() , так как
при этом происходит увеличение числа накопленных избыточных носителей в
областях. Диффузионная емкость зависит от частоты. С повышением частоты емкость
уменьшается, так как скопление избыточных зарядов не успевает за изменением
напряжения на p-n- переходе.
, так как
при этом происходит увеличение числа накопленных избыточных носителей в
областях. Диффузионная емкость зависит от частоты. С повышением частоты емкость
уменьшается, так как скопление избыточных зарядов не успевает за изменением
напряжения на p-n- переходе.
![]()
![]() ,
(22)
,
(22)
![]()
![]() -
граничная частота, Гц;
-
граничная частота, Гц;
![]()
![]() - сопротивление
n-области, Ом;
- сопротивление
n-области, Ом;
![]()
![]() - барьерная ёмкость,
- барьерная ёмкость, ![]()
![]() = 0,33559
нФ.
= 0,33559
нФ.
![]()
![]() ,
(23)
,
(23)
![]()
![]() - сопротивление
p-области, Ом;
- сопротивление
p-области, Ом;
![]()
![]() - удельное сопротивление p-области, Ом∙м;
- удельное сопротивление p-области, Ом∙м;
![]()
![]() - толщина n-области, l=10 -6 м;
- толщина n-области, l=10 -6 м;
![]()
![]() -
площадь p-n перехода, S=1∙10-8 м2.
-
площадь p-n перехода, S=1∙10-8 м2.
![]()
![]() ,
(26)
,
(26)
![]()
![]() - удельное сопротивление n-области, Ом∙м;
- удельное сопротивление n-области, Ом∙м;
![]()
![]() - удельная проводимость, См.
- удельная проводимость, См.
![]()
![]() ,
(27)
,
(27)
![]()
![]() - удельная проводимость, См;
- удельная проводимость, См;
![]()
![]() -
подвижность электронов,
-
подвижность электронов, ![]()
![]() см2/В∙с.
см2/В∙с.
![]()
![]() = 12
= 12 ![]()
![]() .
.
![]()
![]() = 0,0833
Ом∙м.
= 0,0833
Ом∙м.
![]()
![]() = 8,333 Ом.
= 8,333 Ом.
![]()
![]() =3,5758
=3,5758![]() МГц.
МГц.
4.
ИСПОЛЬЗОВАНИЕ ДИОДНЫХ СТРУКТУР В ИНТЕГРАЛЬНЫХ СХЕМАХ


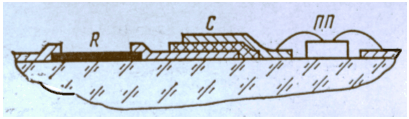

5. ЗАКЛЮЧЕНИЕ
6.
БИБИОГРАФИЧЕСКИЙ СПИСОК

