Материал: СТ6
1.2. Контакт вырожденных электронных и дырочных полупроводников.Туннельный диод
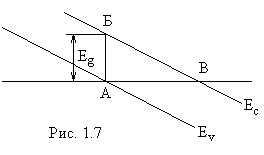 В
очень сильных электрических полях
становится возможным механизм образования
свободных носителей заряда, называемый
туннельным эффектом или эффектом Зинера.
Как известно, у полупроводника,
находящегося во внешнем электрическом
поле с напряженностью
В
очень сильных электрических полях
становится возможным механизм образования
свободных носителей заряда, называемый
туннельным эффектом или эффектом Зинера.
Как известно, у полупроводника,
находящегося во внешнем электрическом
поле с напряженностью
![]() ,
имеет наклон энергетических зон
(рис.1.7). Наклон зон тем больше, чем
больше напряженность электрического
поля
,
имеет наклон энергетических зон
(рис.1.7). Наклон зон тем больше, чем
больше напряженность электрического
поля
![]() .
На рис.1.7 представлена зонная структура
собственного полупроводника при наличии
сильного электрического поля. В этом
случае возможен переход электрона из
валентной зоны в зону проводимости
благодаря туннельному эффекту. Вероятность
туннельного перехода зависит от высоты
и ширины потенциального барьера. В
данном случае высота потенциального
барьера АБ
представляет
собой шину запрещенной зоны
.
На рис.1.7 представлена зонная структура
собственного полупроводника при наличии
сильного электрического поля. В этом
случае возможен переход электрона из
валентной зоны в зону проводимости
благодаря туннельному эффекту. Вероятность
туннельного перехода зависит от высоты
и ширины потенциального барьера. В
данном случае высота потенциального
барьера АБ
представляет
собой шину запрещенной зоны
![]() .
.
Эффективная
ширина барьера АВ=∆х
может быть определена из разности
потенциальной энергии электрона в зоне
проводимости в точке В
и в валентной зоне - в точке А.
Так как потенциальная энергия с точностью
до аддитивной постоянной есть
![]() ,
то эффективная ширина барьера
,
то эффективная ширина барьера
![]() .
.
Следовательно, ширина потенциального барьера зависит от напряженности электрического поля. Переход электрона из точки А в точку В связан с переходом сквозь треугольный потенциальный барьер АБВ. Из квантовой механики известно, что вероятность перехода для барьера треугольной формы имеет вид:
![]() .
(1.3)
.
(1.3)
Из
выражения (1.3) следует, что вероятность
туннельного перехода из зоны в зону
растет экспоненциально с ростом
напряженности электрического поля
![]() .
Кроме того, вероятность туннельного
перехода будет больше у полупроводников
с малыми значениями ширины запретной
зоны
.
Кроме того, вероятность туннельного
перехода будет больше у полупроводников
с малыми значениями ширины запретной
зоны
![]() и эффективной массы
и эффективной массы
![]() .
.
Вероятность туннельного перехода одна и та же для переходов как из валентной зоны в зону проводимости, так и из зоны проводимости в валентную зону. Но поскольку в валентной зоне электронов намного меньше, чем в зоне проводимости, то будет иметь место преимущественный переход электронов из валентной зоны в зону проводимости. Поэтому туннельный эффект может приводить к значительному увеличению концентрации свободных носителей зарядов.
В p-n переходе, образованном двумя областями невырожденного электронного и дырочного полупроводников, ток обуславливается прохождением электронов над потенциальным барьером. В случае вырожденного полупроводника с концентрацией примесей в обеих областях порядка 1018-1020 см-3 переходный слой будет очень тонкий и возможно прохождение электронов через p-n переход в результате туннельного эффекта, поэтому вольтамперная характеристика будет принципиально отличаться от характеристики диода (рис.1.8).
 Благодаря
возникновению туннельного эффекта
наблюдается резкий рост тока при
обратной полярности напряжения (к
p-области
присоединен отрицательный вывод
источника), а на участке прямого смещения
появляется область отрицательного
дифференциального сопротивления
(рис.1.9). Значительный туннельный ток
возникает в p-n
переходах
толщиной около 10нм, когда при контактной
разности 1В напряженность поля в переходе
приближается к 10В/см. Такая толщина
перехода для большинства полупроводников
наблюдается при концентрации примеси,
лежащей в указанном выше диапазоне.
Благодаря
возникновению туннельного эффекта
наблюдается резкий рост тока при
обратной полярности напряжения (к
p-области
присоединен отрицательный вывод
источника), а на участке прямого смещения
появляется область отрицательного
дифференциального сопротивления
(рис.1.9). Значительный туннельный ток
возникает в p-n
переходах
толщиной около 10нм, когда при контактной
разности 1В напряженность поля в переходе
приближается к 10В/см. Такая толщина
перехода для большинства полупроводников
наблюдается при концентрации примеси,
лежащей в указанном выше диапазоне.
Рассмотрим ход вольт-амперной характеристики туннельного диода на различных участках. На рисунке 1.9 приведена упрощенная энергетическая диаграмма контакта вырожденных полупроводников при отсутствии внешнего смещения. Штриховкой показаны состояния, занятые электронами.
 Значения
Значения
![]() и
и
![]() характеризуют степень вырождения
соответствующих областей полупроводника
и определяют суммарное перекрытие
разрешенных энергетических зон. Благодаря
наличию такого перекрытия электроны
могут переходить из одной области в
другую за счет туннелирования сквозь
потенциальный барьер, форма которой
близка к треугольной. Вероятность
туннелирования определяется формулой
(1.3) и слабо зависит от формы потенциального
барьера, ее можно также считать независящей
от направления движения электрона. При
отсутствии внешнего смещения суммарный
ток через p-n
переход равен нулю, что соответствует
точке 1 на рис1.8.
характеризуют степень вырождения
соответствующих областей полупроводника
и определяют суммарное перекрытие
разрешенных энергетических зон. Благодаря
наличию такого перекрытия электроны
могут переходить из одной области в
другую за счет туннелирования сквозь
потенциальный барьер, форма которой
близка к треугольной. Вероятность
туннелирования определяется формулой
(1.3) и слабо зависит от формы потенциального
барьера, ее можно также считать независящей
от направления движения электрона. При
отсутствии внешнего смещения суммарный
ток через p-n
переход равен нулю, что соответствует
точке 1 на рис1.8.
Теперь
допустим, что к p-n
переходу приложено обратное смещение.
В этом случае (рис.1.10) все энергии в
n-области
снижаются относительно p-области,
и поток электронов из p-области
в n-область
резко возрастает, так как увеличивается
количество заполненных уровней в
полупроводнике p-типа,
против которой при той же энергии лежат
свободные уровни в зоне проводимости
материала n-типа.
Поток электронов в обратном направлении
при этом уменьшается. Суммарный ток
электронов обозначен с трелкой
на рис.1.10, этому режиму соответствует
точка 2 на рис.1.8. Увеличение обратного
напряжения сопровождается ростом
туннельного тока.
трелкой
на рис.1.10, этому режиму соответствует
точка 2 на рис.1.8. Увеличение обратного
напряжения сопровождается ростом
туннельного тока.
При небольших положительных напряжениях (рис.1.11) возрастает количество электронов, туннелирующих из n-области в p-область (эти переходы указаны стрелкой) при одновременном снижении встречного потока (точка 3 на рис.1.8).
При
дальнейшем повышении прямого напряжения
перекрытие разрешенных зон проходит
через максимум и начинает уменьшаться,
это приводит к снижению туннельного
тока (точка 4 на рис.1.8). Увеличение
входного напряжения до величины
![]() ,
когда
,
когда
![]() совпадает
с
совпадает
с
![]() ,
приводит к уменьшению туннельного тока
до нуля.
,
приводит к уменьшению туннельного тока
до нуля.
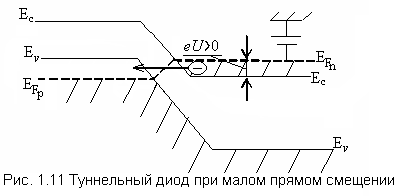 Однако
по мере повышения прямого смещения на
p-n
переходе высота потенциального барьера
понижается, и будет возрастать диффузионный
ток основных носителей заряда, способных
преодолеть снижающийся потенциальный
барьер. Ток будет увеличиваться по тому
же закону, что и в обычном диоде (точка
5 на рис.1.8). Соответствующая зонная
диаграмма представлена на рис. 1.12.
Однако
по мере повышения прямого смещения на
p-n
переходе высота потенциального барьера
понижается, и будет возрастать диффузионный
ток основных носителей заряда, способных
преодолеть снижающийся потенциальный
барьер. Ток будет увеличиваться по тому
же закону, что и в обычном диоде (точка
5 на рис.1.8). Соответствующая зонная
диаграмма представлена на рис. 1.12.
Из рисунка 1.13 следует, что наибольшее различие в вольт-амперной характеристике, рассчитанной теоретически и измеренной экспериментально, проявляются в области минимума тока, где его реальная величина существенно превосходит сумму расчетных значений для туннельной и диффузионной составляющих. В этой области существенное влияние оказывает изменение плотности состояний вблизи краев запрещенной зоны вырожденного полупроводника. Этот эффект проявляется в возникновении хвостов плотности

состояний, заходящих в запрещенную зону. Учет данного явления показывает, что туннельный ток не спадет до нуля при
![]() ,
,
так как при этом еще наблюдается перекрытие разрешенных состояний в n- и p- областях. Вторым существенным фактором, объясняющим увеличение реального тока в области минимума ВАХ туннельного диода, является наличие в запрещенной зоне полупроводника глубоких примесных уровней, которые обеспечивают избыточный туннельный ток при прямом смещении. Протекающий туннельный ток зависит от суммарной концентрации примесных состояний и их расположения в запрещенной зоне полупроводника.
 Благодаря
наличию участка отрицательного
дифференциального сопротивления
туннельный диод может быть использован
для усиления и генерации колебаний.
Принципиальным недостатком этих
приборов, ограничивающим их практическое
применение, является малая выходная
мощность, что связано с незначительным
изменением тока и напряжения на участке
отрицательного дифференциального
сопротивления. Наличие избыточного
тока отрицательно сказывается на
параметрах диода, так как приводит к
снижению перепада тока на рабочем
участке ВАХ.
Благодаря
наличию участка отрицательного
дифференциального сопротивления
туннельный диод может быть использован
для усиления и генерации колебаний.
Принципиальным недостатком этих
приборов, ограничивающим их практическое
применение, является малая выходная
мощность, что связано с незначительным
изменением тока и напряжения на участке
отрицательного дифференциального
сопротивления. Наличие избыточного
тока отрицательно сказывается на
параметрах диода, так как приводит к
снижению перепада тока на рабочем
участке ВАХ.
2. Описание установки и методики эксперимента
Экспериментальная установка схематично изображена на рис.2.1. p-n переход с сопротивлением R подключают к источнику напряжения e и помещают в термостат.
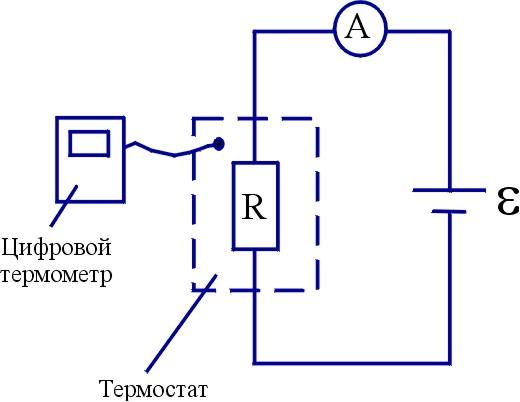
Рис.2.1. Блок-схема экспериментальной установки
В установке предусмотрена возможность плавного измерения температуры термостата и ее измерения цифровым термометром.
Ток
через р-п
переход зависит от приложенного внешнего
напряжения
![]() следующим
образом:
следующим
образом:
![]() ,
(2.1)
,
(2.1)
где
![]() - ток насыщения при обратном включении
р-п перехода,
- ток насыщения при обратном включении
р-п перехода,
![]() ,
В
– константа, зависящая от температуры,
А
– константа, не зависящая от температуры.
,
В
– константа, зависящая от температуры,
А
– константа, не зависящая от температуры.
Эксперимент
следует проводить при малых значениях
напряжения
![]() .
В этом случае exp(eU/kT)<<1,
и выражение (2.1) можно записать :
.
В этом случае exp(eU/kT)<<1,
и выражение (2.1) можно записать :
![]() .
(2.2)
.
(2.2)
Прологорифмировав (2.2), имеем
![]() .
(2.3)
.
(2.3)
По результатам эксперимента можно построить график зависимости (2.3). Эта зависимость представлена на рис. 2.2.

Рис.2.2. Зависимость логарифма тока от величины обратной
Температуре p-n перехода
Поскольку константа С слабо зависит от температуры при измерениях в небольшом диапазоне температур, то выражению (2.3) соответствует линейная зависимость (рис.2.2). Измеряя тангенс угла наклона этого графика, можно определить eDj = EFp – EFn .
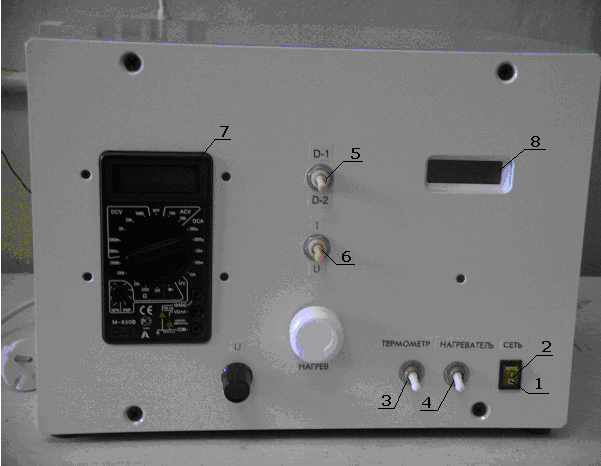
Лабораторная установка, выполненная в виде настольного прибора рис.2.3, на лицевой панели которого находятся тумблер 1 «сеть», фотодиод 2 включения сети, тумблер 3 включения термометра, тумблер включения нагревателя 4, переключатель 5 диодов Д1-Д2», тумблер 6 переключения «U|I» , табло мультиметра7, табло термометра 8.
3. Порядок выполнения работы
1. Включить вилку прибора в сеть.
2. Включить тумблер 1 «сеть». При этом на панели прибора должен загореться красный фотодиод 2.
3. Включить термометр тумблером 4.
4. Поставить переключатель 5 «Д1-Д2» в положение Д1, соответствующее первому диоду.
5. Меняя напряжение на диоде и измеряя его мультиметром 6, на котором установлен предел 2000т по шкале DCV, установить напряжение на диоде 0.
6.
Переключить мультиметр в положении
2000![]() по шкале DCA,
а тумблер 6 – в положение I,
измерить ток через диод. Он должен быть
0.
по шкале DCA,
а тумблер 6 – в положение I,
измерить ток через диод. Он должен быть
0.
7. Изменяя напряжение через 0,1 мВ, фиксировать значения тока, как описано в п.п.5-6.
Полученную вольтамперную характеристику занести в таблицу 1. Измерения производить во всем диапазоне изменения напряжения.
Таблица 1
ДИОД 1
|
U, мВ |
|
|
|
|
|
I, мА |
|
|
|
|
ДИОД 2
|
U, мВ |
|
|
|
|
|
I, мА |
|
|
|
|
8. Поставить переключатель 5 «Д1-Д2» в положение Д2, соответствующее второму диоду. Повторить п.п.5-7.
9. Включить тумблер «нагрев». Повторить п.п. 4-8 для температуры диодов, выбранной в интервале 50-70С.
10. Построить вольтамперные характеристики диодов при двух температурах.
11. При постоянном напряжении (например, 3В), подаваемом на диод, снять зависимость тока от температуры. Измерять напряжение и ток для диодов Д1 и Д2, как описано в п.п.4,5,6. Фиксировать значения тока при изменении температуры на каждые 5К. Результаты измерений свести в таблицу 2.
Таблица 2
ДИОД 1
|
U, мВ |
T, К |
I,мА |
|
|
|
|
|
|
|
|
|
|
|
|
ДИОД 2
|
, U, мВ |
T, К |
I,мА |
|
|
|
|
|
|
|
|
|
|
|
|