Курсовая работа (т): Расчёт электронно-дырочного перехода
Расчёт электронно-дырочного перехода
Федеральное агентство по образованию Российской Федерации
Государственное образовательное учреждение высшего профессионального образования
«Южно-Уральский государственный университет»
Факультет «Приборостроительный»
Кафедра
«Конструирование и производство радиоаппаратуры»
ПОЯСНИТЕЛЬНАЯ ЗАПИСКА
К КУРСОВОЙ РАБОТЕ
по дисциплине «Физика твердого тела»
ЮУрГУ-210400.2013.894 ПЗ КР
Расчёт
электронно-дырочного перехода
Руководитель
В.А. Бухарин
Автор проекта
студент группы ПС-259
Е.Н
Злыднев
Челябинск 2013г.
ЗАДАНИЕ
на курсовую работу студента
Злыднева Евгения Николаевича
Группа ПС-259
1. Дисциплина «Физика твердого тела»
. Тема работы: «Расчёт электронно-дырочного перехода»
. Срок сдачи студентом законченной работы: 7 июня 2013 года
. Перечень вопросов, подлежащих разработке
4.1 Исходные данные:
Электронно-дырочный переход
формируется диффузией фосфора в кремниевую подложку p-типа с концентрацией
исходной примеси Nисх.
Поверхностные концентрации примеси фосфора N0Д.
Глубина залегания p-n-перехода X.
Определить вольтамперную характеристику, барьерную и диффузионную ёмкости,
пробивное напряжение электронно-дырочного перехода.
|
№ вар. |
Nисх, |
N0Д, |
X, мкм |
|
2 |
5*1016 |
4*1018 |
1,5 |
4.2 Содержание пояснительной записки:
1) Аннотация,
) Оглавление,
) Анализ технического задания,
) Введение,
) Описание технологии изготовления электронно-дырочного перехода
) Расчётная часть,
) Конструкция диода современной твердотельной САПР
) Классификация разработанного электронно-дырочного перехода по граничной частоте и рассеиваемой мощности.
) Основные особенности использования диодных структур в интегральных схемах,
) Заключение,
) Список литературы.
Календарный план
|
Наименование разделов курсовой работы |
Срок выполнения разделов работы |
Отметка руководителя о выполнении |
|
Выдача задания к курсовой работе |
6 марта |
|
|
Изучение литературы по теме электронно-дырочного перехода - 25% |
13 марта |
|
|
Расчёт вольтамперной характеристики, барьерной и диффузионной ёмкости, пробивного напряжения электронно-дырочного перехода в черновом виде - 50% |
30 марта |
|
|
Расчет вольтамперной характеристики, барьерной и диффузионной ёмкости, пробивного напряжения электронно-дырочного перехода в чистовом виде - 75% |
10 мая |
|
|
Оформление работы - 100% |
7 июня |
|
Руководитель работы __________________________ /В.А. Бухарин/
Студент /Е.Н.
Злыднев /
АННОТАЦИЯ
Злыднев Е.Н. Расчёт электронно-дырочного
перехода. - Челябинск: ЮУрГУ, ПС, 2013, с. 19, 8 илл., Библиография литературы
- 7 наименований.
Рассмотрены технология изготовления, принцип действия, физические процессы в полупроводниковых диодах. Предложен способ расчета входных и выходных характеристик, статических и динамических параметров.
ВВЕДЕНИЕ
Полупроводниковый диод, двухэлектродный электронный прибор на основе полупроводникового (ПП) кристалла. Понятие "Полупроводниковый диод" объединяет различные приборы с разными принципами действия, имеющие разнообразное назначение. Система классификации П. д. соответствует общей системе классификации полупроводниковых приборов. В наиболее распространённом классе электропреобразовательных полупроводниковых диодов различают: выпрямительные диоды, импульсные диоды, стабилитроны, диоды СВЧ. Среди оптоэлектронных полупроводниковых диодов выделяют фотодиоды, светоизлучающие диоды и ПП квантовые генераторы.
Наиболее многочисленны П. д., действие которых
основано на использовании свойств электронно-дырочного перехода (р-n-перехода).
Если к р-n-переходу диода приложить напряжение в прямом направлении (т. н.
прямое смещение), т. е. подать на его р-область положительный потенциал, то
потенциальный барьер, соответствующий переходу, понижается и начинается
интенсивная инжекция дырок из р-области в n-область и электронов из n-области в
р-область - течёт большой прямой ток. Если приложить напряжение в обратном
направлении (обратное смещение), то потенциальный барьер повышается и через
р-n-переход протекает лишь очень малый ток неосновных носителей заряда
(обратный ток).

1. АНАЛИЗ ТЕХНИЧЕСКОГО ЗАДАНИЯ
Из задания следует, что полупроводниковый диод изготавливается по диффузионной технологии.
Диффузия - это процесс, с помощью которого на поверхности или внутри пластины полупроводника получают p- или n- области путем введения акцепторных или донорных примесей. Проникновение примесей внутрь пластины проводника происходит за счет диффузии атомов примеси. Источником примеси диффузанта может быть либо жидкость, либо газ (пар). В первом случае поверхность пластины контактирует со расплавом, содержащем в качестве компонента необходимую примесь, во втором случае - с парами примеси или с потоком инертного газа-носителя, содержащего пары примеси. Второй метод имеет большее распространение.
Диффузия примесей имеет под собой ту же
теоретическую базу, что и диффузия подвижных носителей заряда. Существенное
отличие состоит, конечно, в отсутствие рекомбинации, а с количественной стороны
в несравненно меньших коэффициентах диффузии, а значит, и скоростях движения.
. ТЕХНОЛОГИИ ИЗГОТОВЛЕНИЯ ЭЛЕКТРОННО-ДЫРОЧНОГО
ПЕРЕХОДА
Существует большое количество способов создания
p-n перехода. На рисунке 2.1 представлены схемы сплавной, диффузионной и
эпитаксиально-диффузионной технологий.
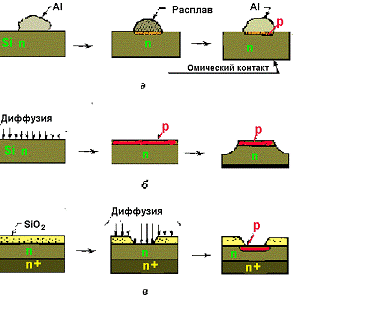
Рисунок 2.1 - Схемы изготовления p-n перехода
различными технологическими способами
При сплавной технологии электронно-дырочный переход образуется на границе раздела исходного кристалла и рекристаллизованной полупроводниковой области, в которую происходило вплавление (рисунок 2.1а). На рисунке 2.1б показан способ изготовления p-n перехода диффузией акцепторной примеси в кристалл n-типа. Особенность технологии, показанной на рисунке 2.1в, в том, что диффузия осуществляется в кристалл с полупроводниковой пленкой n типа, выращенной на кристалле n+ типа специальной эпитаксиальной технологией, позволяющей сохранить структуру кристалла в пленке.
При заданной (желаемой) глубине диффузии время
соответствующего процесса
![]() где (1)
где (1)
X - глубина диффузии
D - коэффициэнт диффузии
Выбрав температуру диффузии Т=1100, из графика определим коэффициент диффузии:
D=![]()
Поставив значения в формулу (1) рассчитали время диффузии:
![]() = 5625 с. = 93.75 мин.
= 5625 с. = 93.75 мин.
Обычно выбирают такую температуру диффузии, которая обеспечивает время процесса не менее 10-20 мин. В этом случае можно получить заданную величину диффузионного слоя с высокой точностью, поскольку прекращение нагрева с погрешностью, составляющей несколько, даже десятки секунд, оказывали малосущественным.
Диффузия примесей имеет под собой ту же теоретическую базу, что и диффузия подвижных носителей заряда. Существенное отличие состоит, конечно, в отсутствии рекомбинации, а с количественной стороны - в несравненно меньших коэффициентах диффузии, а значит, и скоростях движения
В отсутствие рекомбинации (т = ∞)
любое из уравнений диффузии применительно к концентрации примеси N запишется в
виде 2-го закона Фика:
![]()
где N = N(x; t) - распределение концентрации примеси
В случае ограниченного источника примеси, распределение примеси описывается функцией Гаусса

где ![]() - полное количество атомов примеси
(на единицу площади) которое остается постоянным в процессе диффузии.
- полное количество атомов примеси
(на единицу площади) которое остается постоянным в процессе диффузии.
При x=0, распределение примеси
примет вид :

Из этого выражения найдем полное
количество атомов примеси:
![]()
В итоге получим:
![]()
Практически величина ![]() обеспечивается
путем предварительной диффузии («загонки») примеси на небольшую глубину из
неограниченного внешнего источника, после чего источник отключается и следует
автономная «разгонка» накопленных атомов.
обеспечивается
путем предварительной диффузии («загонки») примеси на небольшую глубину из
неограниченного внешнего источника, после чего источник отключается и следует
автономная «разгонка» накопленных атомов.
Вольт - амперная характеристика
диода определяется формулой:
![]()
где ![]() - температурный потенциал
- температурный потенциал
![]() - тепловой ток;
- тепловой ток;
Температурный потенциал можно найти с помощью формулы:
![]()
где T- температура; T=300 К;
![]() - постоянная Больцмана; k =
- постоянная Больцмана; k = ![]() ;
;
![]() - заряд электрона; q =
- заряд электрона; q = ![]() Кл;
Кл;
Поставляя значения в формулу, получили:
![]()
Тепловой ток определяется из
выражения:
I0 = ![]() (трутко)
(трутко)
где b - отношение подвижности электронов и дырок, b = 2.81
S - площадь
перехода, S = ![]() м2
м2
![]() - собственная проводимость
полупроводника,
- собственная проводимость
полупроводника, ![]()
![]() ,
,![]() - проводимость соответствующих
слоев,
- проводимость соответствующих
слоев,
Определим их с помощью графика, при Nприм= 10-17 см-3
![]() ,
, ![]() Ом м
Ом м
Ln, Lp -
диффузионные длины носителей заряда, которые можно найти с помощью формул:
![]()
![]()
где Dp, Dn - коэффициенты диффузии дырок и электронов
![]() (королев)
(королев)
![]()
![]() ,
, ![]() - время жизни дырок и электронов
- время жизни дырок и электронов
![]() ,
, ![]() = 2.5 * 10-3 сек (королев)
= 2.5 * 10-3 сек (королев)
В итоге получили
![]()

ВАХ
Барьерная емкость

где - относительная диэлектрическая проницаемость кремния , = 11.8;
- электрическая постоянная, ????0 = 8,85419·10-12 Ф/м;
S - площадь
перехода, S = ![]() м2;
м2;
![]() - высота потенциального барьера
определяется формулой
- высота потенциального барьера
определяется формулой

где b - отношение подвижности электронов и дырок, b = 2.81
![]() ,
, ![]() - удельные сопротивления
соответствующих слоёв, для кремния
- удельные сопротивления
соответствующих слоёв, для кремния
Определим их с помощью графика, при Nприм= 10-17 см-3
![]() ,
, ![]() Ом м
Ом м
Подставляя в числовые значения, в итоге получили:
![]() = 0.76 В
= 0.76 В
l -ширина
перехода

Поставляя значения получаем
l = ![]()

Барьерная емкость
Диффузионная емкость
![]()
. ИСПОЛЬЗОВАНИЕ ДИОДНЫХ СТРУКТУР В ИНТЕГРАЛЬНЫХ
СХЕМАХ
Диоды в микросхемах предназначены либо для того, чтобы выводить транзисторы из насыщения (фиксация транзисторов), либо для выполнения логических функций.
Любой из р-п переходов транзисторной структуры
может быть использован для формирования диодов, но только два перехода
база-эмиттер и база-коллектор действительно удобны для схемных применений. Пять
возможных вариантов использования p-n
переходов транзистора в качестве диода показаны на рис. 4.1. Параметры
интегральных диодов приведены в табл. 4.1. Из анализа таблицы видно, что
варианты различаются по электрическим параметрам. Пробивные напряжения Uпр
больше у тех вариантов, в которых используется коллекторный переход. Обратные
токи Iобр меньше у тех вариантов, в которых используется только эмиттерный
переход, имеющий наименьшую площадь. Емкость диода между катодом и анодом Сд у
варианта с наибольшей площадью переходов максимальна (Б-ЭК). Паразитная емкость
на подложку С0 (считается, что подложка заземлена) минимальна у варианта Б-Э.
Время восстановления обратного тока tв
характеризующее время переключения диода из открытого в закрытое состояние,
минимально у варианта БК- Э, так как у этого варианта заряд накапливается
только в базе.

Оптимальными для микросхем вариантами являются
БК-Э и Б-Э, причем чаше используется БК-Э. Пробивные напряжения (7...8 В)
достаточны для использования этих вариантов в низковольтных микросхемах.