Материал: Радиационные эффекты в диэлектриках
Изучение свойств радиационных дефектов показало, что некоторые их типы термически устойчивы и влияют на электрические свойства кремния подобно рекомбинационным центрам, обусловленным золотом. Эти свойства радиационных дефектов лежат в основе использования их в технологии быстродействующих полупроводниковых приборов вместо золота или платины.
С точки зрения радиационной технологии, практический интерес представляют дефекты с температурой отжига выше 250 0С. Это обусловлено необходимостью обеспечить в рабочем диапазоне температур (-60 - +125 0С) стабильность параметров полупроводниковых приборов, созданных с использованием радиационной технологии. Как показали наши исследования, подбирая режимы облучения и термической обработки в кремниевые р-n-структуры, можно вводить отдельные типы радиационных дефектов с термостабильностью 450 0С, что важно для силовых быстродействующих приборов.
Кроме того, радиационные дефекты, являющиеся эффективными центрами рекомбинации, в меньшей степени влияют на снижение концентрации основных носителей, поскольку дают, в отличие от золота, сравнительно мелкие энергетические уровни в запрещенной зоне кремния, что очень важно, так как при существенном улучшении динамических параметров не будет происходить заметных ухудшений статических характеристик приборов и, следовательно, больших внутренних энергопотерь.
Особо следует отметить простоту введения в кристаллы с р-n-переходами и приборы на стадии технологического цикла радиационных дефектов нужной концентрации при высокой равномерности их распределения по структуре. Скорость введения радиационных дефектов зависит от вида и энергии излучения, температуры облучения, примесей в образце. Поэтому для каждого типа изделий важно подобрать вид радиации и режим радиационной обработки.
При облучении быстрыми электронами или гамма-квантами Со60 радиационные дефекты вводятся равномерно по объему образца. Эти излучения целесообразно использовать для облучения р-n-структур, имеющих достаточно обширные активные области, куда следует вводить дефекты. Это структуры транзисторов, диодных матриц, силовых полупроводниковых приборов и др.
Применение в радиационной технологии тяжелых частиц (протонов и альфа-частиц) целесообразно в тех случаях, когда необходимо локальное введение радиационных дефектов, главным образом в приповерхностном слое структур. Это позволяет уменьшить время жизни неосновных носителей заряда только в тех областях, где происходит их накопление, снижающее быстродействие приборов. Энергия протонного или альфа-излучения выбирается, исходя из глубины слоя, в который требуется ввести радиационные дефекты. Например, пробег протонов в кремнии составляет около 1,2 мкм на каждые 100 кэВ (при Еp≤ 1 МэВ). Локальное облучение протонами применяется также для создания с помощью радиационных дефектов полуизолирующих областей, где снижена концентрация основных носителей.
Облучение быстрыми электронами (Еe=4
МэВ) уменьшает накопленный заряд Q неравновесных носителей в базе р-n-структуры
на основе кремния с удельным сопротивлением 0,5 Ом∙см - рисунок 4. В
результате облучения диодных структур дозой 5∙10 15 эл/см 2
произошло снижение накопленного заряда более чем на порядок и, таким образом,
увеличение быстродействия при неизменности статических параметров. Увеличение
прямого падения напряжения (cтатический параметр) на диоде начинает происходить
при большей дозе (6∙10 15 эл/см 2). Поэтому
оптимальную дозу и режим облучения подбирают таким образом, чтобы достигалось
максимальное увеличение быстродействия, но статические параметры заметно не
ухудшились.
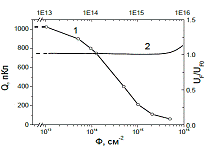
Рисунок 4- изменение накопленного заряда Q (1) и
падения напряжения U (2) р-n-структуры в зависимости от величины флюенса Ф
быстрых электронов
Р-n-структуры на стадии изготовления или готовые приборы после радиационно-технологической обработки подвергаются стабилизирующему термическому отжигу (~300 0С), во время которого устраняются нетермостабильные радиационные дефекты. Облучение может вестись при повышенных температурах («горячее» облучение), тогда нет необходимости в стабилизирующем термическом отжиге после облучения.
Исследовалось процентное распределение диодов по
времени восстановления обратного сопротивления, пропорционального времени
переключения (рисунок 5, изготовленных с введением золота (а), без золота (б,г)
и после облучения (в) быстрыми электронами (Е e
=
4 МэВ, Ф=5 ∙ 10 15эл/см 2). В случае изготовления
диодов без золота время их восстановления находится в пределах 50-110 нс. При
введении золота оно снизилось до 12-30 нс. Использование радиационной
технологии позволило снизить время восстановления диодов до 4-14 нс и, таким
образом, существенно увеличить их быстродействие. При этом большинство из них в
процентном отношении имеет повышенное быстродействие (4-7 нс).

Рисунок 5 - гистограммы процент-ного
распределения диодных матриц по быстродействию.

Рисунок 6 - соотношение между временем обратного
восстановления trr
диодных структур и временем жизни ННЗ при trr≤0,3
мкс.
Мощные диоды, тиристоры, биполярные транзисторы, в том числе новый их тип - с изолированным затвором - широко применяются в различной промышленной и бытовой аппаратуре (в мощных переключающих устройствах, источниках питания, автомобильной электронике и других областях), нуждаются в повышении их быстродействия и минимизации коммутационных энергетических потерь. Наиболее эффективным способом решения этой задачи является использование в технологии их изготовления проникающих излучений (быстрых электронов, гамма-квантов).
Было установлено, что прямое падение напряжения
p-n-структур монотонно возрастает с увеличением флюенса электронного облучения,
а время жизни неосновных носителей заряда - уменьшается - рисунок 7.
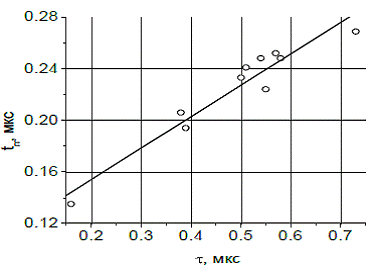
Рисунок 7 - зависимости времени жизни ННЗ и
прямого падения напряжения диодных структур от флюенса электронов с Е = 4 МэВ.
При больших флюенсах быстрых электронов значение UF начинает выходить за пределы ТУ (Uf ≤1,3 В при значении прямого тока 2 А). Как следует из рис. 8, минимально достижимое значение τ облучаемых диодных структур равно 0,15÷0,17 мкс, так как при этом величина Uf становится равной 1,3 В. Эти значения исследуемых параметров достигаются при Фe=7,5∙10 14 см -2.
Аналогичный характер поведения τ
и
Uf
наблюдается и при облучении диодных структур гамма-квантами Со 60.
Однако здесь минимально достижимое значение τ облучаемых
диодных структур гамма-квантами равно 0,3÷0,32 мкс,
что соответствует Фγ= (1,4 ÷1.5)1017кв/см
2 - рисунок 8.Сравнение этих значений с аналогичными данными,
полученными при электронном облучении, показывает, что радиационная обработка
диодных структур электронами эффективнее, чем гамма-квантами. Данный
экспериментальный факт может быть обусловлен различием во вводимых типах
радиационных дефектов. В случае гамма-облучения практически не вводятся
дивакансии. Значения обратных токов диодных структур не выходят за нормы ТУ в
исследуемом диапазоне флюенсов электронного облучения. Для исследования термической
стабильности параметров проводился изохронный (20 мин) отжиг облученных диодных
структур при Тотж = 373÷623 К
- рисунок 9.
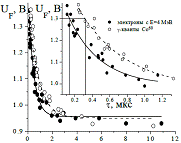
Рисунок 8 - зависимость U
F(τ)
для
диодных структур, облучаемых электронами с Е = 4 МэВ и гамма-квантами Сo
60
При отжиге все параметры приборов испытывают обратные изменения, т.е. значение прямого падения напряжения уменьшается, а значение времени обратного восстановления возрастает.
Однако до Тотж = 523 К эти изменения весьма
незначительны. Наиболее эффективное восстановление τ
и
UF
начинается
при более высоких температурах. При Тотж= 623 К значение времени жизни ННЗ
выходит за пределы ТУ.
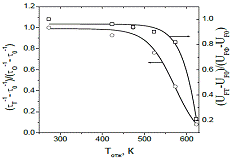
Рисунок 9 - изменение в процессе изохронного
отжига времени жизни ННЗ и прямого падения напряжения диодных структур,
облученных флюенсом электронов Фe=7∙1014
см -2. UFT;
UF0;
UFФ
- значение прямого падения напряжения после отжига, до и после облучения
соответственно. Обозначения для τ аналогичны.
Результаты нестационарной емкостной
спектроскопии глубоких уровней - DLTS-спектроскопии (Deep Layer Transient
Spectroscopy) диодных структур показали, что при перезарядке ловушек основными
носителями заряда на спектре облученных электронами образцов возникают пики Е1-Е4,
а при перезарядке неосновными - минимум H1- рисунок 10-а. Пику Е1 соответствует
глубокий уровень с Ес-0,19 эВ и сечением захвата σ
= 2,7∙10
-14 см 2 (комплекс вакансия-кислород), Е2 - Ес-0,25
эВ σ
= 6,7∙10
-15см 2 (комплекс вакансия-вакансия), Е3 - Ес-0,36
эВ σ
= 8,1∙10
-16 см 2 и минимуму H1 - донорный уровень с Еv+0,36
эВ σ
= 2,3∙10
-15 см 2 (комплекс углерод внедрения-кислород внедрения).
Наложение пиков Е3 и Е4 не позволяет определить параметры ловушки Е4. Отжиг
облученных р-n-структур при Тотж = 573 К приводит к исчезновению пиков Е2 и Е4-
рисунок 10-б, что позволяет соотнести оба пика с комплексом вакансия-вакансия.
Обращает на себя внимание также значительное уменьшение амплитуды пиков Е1 и
Н1. Все это объясняет резкое восстановление параметров облученных образцов при
данных температурах отжига -рисунок 9. Природа термостабильной ловушки Е3 на
данный момент остается до конца не выясненной. Можно предположить, что этот
уровень относится к более сложным кислородосодержащим комплексам.

Рисунок 10 -DLTS-спектры облученных (а) и
отожженных при Тотж= 573 К в течение 30 минут (б) диодных структур. Штриховая
линия - перезарядка ловушек неосновными носителями, а сплошная - основными.
Следует отметить, что электронное облучение можно применять и для улучшения динамических параметров диодов, изготовленных на кремнии р-типа. Так, исследуемые диоды изготавливались на кремниевых пластинах р-типа с удельным сопротивлением 18 Ом∙см. Р-n-переход формировался диффузией фосфора на глубину 8 мкм. После создания омических контактов все количество приборов было разделено на три группы. Первая и вторая облучались разными флюенсами электронов при комнатной температуре и отжигались при 700 К в течение 8 минут. Третья группа не подвергалась радиационно-термической обработке.
В таблице 2 представлены результаты радиационно-термической обработки диодных n+-p-p+-структур. Отжиг облученных структур проводился в течение 8 минут. Исследования необлученных образцов показали, что средние значения времени обратного восстановления диодных структур составляли 920 нс, прямого падения напряжения - 917 мВ, обратного напряжения - 233 В.
С ростом флюенса электронного облучения Ф
происходит уменьшение trr. Так, уже при Ф=6∙10 15 см -2
среднее значение trr составляет 165 нс. Следует отметить при этом
некоторый рост прямого падения напряжения и деградации обратной ВАХ диодов.
Однако при указанном флюенсе электронов значения статических параметров
остаются в пределах Ur
≥200
В и Uf≤1,2
В.
Таблица 2 Влияние радиационно-термической обработки на параметры мощных диодов, изготовленных на кремнии р-типа:

Из анализа полученных данных следует, что в результате проведенной радиационно-термической обработки значение trr уменьшилось в 5÷8 раз.
При этом значения Uf остаются не только в нормативных рамках, но еще имеется достаточный запас (~0,2 В) для еще большего повышения флюенса электронного облучения. После облучения n+-р-p+-структур электронами на DLTS-спектрах возникают пики, соответствующие перезарядке глубоких уровней, расположенных в нижней половине запрещенной зоны кремния- рисунок 11. Пик Е1 соответствует ловушке с глубоким уровнем Ev+0,20 эВ и сечением захвата σ = 8,1∙10-16см2(комплекс дивакансия), пик Е2 - Ev+0.31 эВ и σ= 4,9∙10-14 см 2 и пик Е3 - Ev+0,35 эВ и σ= 4,5∙10 -15см2(комплекс углерод внедрения - кислород внедрения СiOi). Природа ловушки Е2 на сегодняшний день остается пока до конца не выясненной. Она отжигается при температуре отжига Тотж = 650 К.
Результаты DLTS-спектроскопии показывают, что
основным рекомбинационным центром в облученных образцах является комплекс СiOi.
Согласно литературным данным он отжигается при 673 К 23]. Это подтверждается и
нашими измерениями. Так, при Тотж = 673 К в течение 30 минут амплитуда пика Е3
уменьшилась более чем в 10 раз - рисунок 11. В то же время, как отмечалось
выше, после стабилизирующего отжига облученных диодов при 700 К в течение 8
минут trr
остается значительно меньше исходного значения.
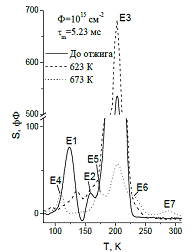
Рисунок 11- DLTS-спектры облученных и отожженных
при Т = 623 и 673 К в течение 30 минут образцов на кремнии р-типа .
Следует отметить, что в процессе изохронного отжига образцов при 650-690 К возникает ряд более термостабильных ловушек Е4-Е7. Пик Е4 соответствует ловушке с глубоким уровнем Ev+0,24 эВ и сечением захвата σ= 1,3∙10 -12 см 2 и Е7 - Ev+0,58 эВ и σ= 1,9∙10 -14 см 2. Параметры ловушек Е5 и Е6 определить не удается из-за перекрытия пиков Е5, Е6 и Е3. Большие значения сечений захвата у ловушек Е4 и Е7 позволяют их отнести к термостабильным - рисунок 11 и весьма эффективным центрам рекомбинации неосновных носителей заряда в базовой области исследуемых диодов, что и объясняет высокую термическую стабильность параметров облученных диодов.
Таким образом, полученные результаты свидетельствуют о возможности использования радиационно-термической обработки в технологии изготовления мощных кремниевых диодов. Эффективность использования радиационной технологии полупроводников можно также продемонстрировать на примере изготовления мощных кремниевых тиристоров, в том числе выключаемых по электроду управления (запираемых).
Исследовались зависимости остаточного падения
напряжения на тиристоре Ut
от времени выключения tq
для двух различных способов радиационной обработки - рисунок 12.
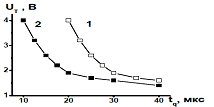
Рисунок 12 - зависимость Ut
(tq)
для мощных кремниевых тиристоров (номинальный ток 50 А, блокируемое напряжение
<2000 B). 1- обычное облучение; 2- локальное облучение .
Кривая 1 соответствует зависимости при обычном облучении тиристоров электронами с энергией 4 МэВ при комнатной температуре флюенсами 1∙1014-1∙1015 см-2. Аналогичная зависимость (кривая 2) получена при облучении тиристоров через специальную маску, позволяющую создавать в объеме полупроводниковой структуры изолированные сквозные участки с малым временем жизни неосновных носителей заряда. За счет этого удается сместить кривую зависимости UT(tq) в сторону больших значений времени выключения, обеспечивая таким образом более высокий уровень быстродействия при тех же значениях потерь в проводящем состоянии. Это обусловлено тем, что при введении зон повышенной рекомбинации в базовые области p-n-p-n-структуры, основной ток в проводящем режиме протекает по участкам структуры с низкой концентрацией радиационных дефектов. При выключении прибора рекомбинация заряда, оставшегося в базовой области структуры после закрытия центрального р-n-перехода, протекает более эффективно за счет ухода неравновесных носителей в зоны повышенной рекомбинации.
Как видно на рисунке 12, за счет этого удается добиться почти двукратного увеличения быстродействия при тех же значениях остаточного падения напряжения (по ТУ не более 2,5 В).
Одним из наиболее перспективных способов
выключения тиристоров является подача в одну из базовых областей (обычно
p-типа) управляющего импульса отрицательной полярности (запирание). Коэффициент
запирания Кзап, определяемый как отношение амплитуды запираемого
анодного тока к амплитуде импульса запирающего тока, является основным параметром,
влияющим на эффективность процесса запирания. Очевидным является стремление
разработать структуры и приборы на их основе с высокими значениями Кзап.
Однако, предлагаемые для этого технологические методы усложняют процесс
изготовления структуры. Было установлено, что параметры Кзап и Ut
при облучении возрастают, однако скорости их роста различны - рисунок 13. Так,
при Ф= (2-3)∙1014 см-2 Кзап
увеличивается в 3-4 раза, при этом Ut
растет заметно меньше (в полтора-два раза).