Материал: Радиационные эффекты в диэлектриках
Радиационные эффекты в диэлектриках
ВВЕДЕНИЕ
Вопреки сложившимся представлениям о том, что
проникающая радиация вызывает в полупроводниках и полупроводниковых приборах
только радиационные повреждения, приводящие их в негодность, во многих случаях
радиация может служить эффективным технологическим инструментом, который
позволяет получать качественные полупроводниковые материалы, существенно
усовершенствовать и удешевить производство многих типов полупроводниковых
приборов, улучшить их качество, а также экономить драгоценные металлы, используемые
при их производстве. В технологических процессах изготовления полупроводниковых
приборов перспективно использование большинства видов проникающих излучений:
быстрых электронов, гамма-квантов, нейтронов, протонов, альфа-частиц и др. В
технологии ядерного легирования полупроводниковых материалов используются
медленные нейтроны и высокоэнергетичные электроны (Е.50 МэВ). Применение
радиации в технологических процессах базируется на радиационных эффектах,
которые они вызывают в полупроводниках и структурах с р-n-переходами. Это,
главным образом, радиационные эффекты: эффекты смещений, ядерные превращения,
ионизационные эффекты.
1. РАДИАЦИОННЫЕ ЭФФЕКТЫ
.1 Эффекты смещений и радиационное
дефектообразование
Эффекты смещений приводят к образованию в кристалле
радиационных дефектов. Радиационный дефект может возникнуть в том случае, если
энергия бомбардирующей частицы достаточна для смещения атома из узла
кристаллической решетки в междоузлие. Например, атом кремния смещается, если он
получит от бомбардирующей частицы энергию примерно 15-20 эВ. Эта энергия
называется пороговой энергией смещения (Еd). Для случая облучения
быстрыми электронами, наиболее часто применяемыми в радиационной технологии,
выражения для определения максимальной энергии, передаваемой атому быстрым
электроном, имеет вид:
![]()
где Еmax - наибольшая кинетическая энергия смещенного атома; Еэ - кинетическая энергия электрона; m - масса покоя электрона; с - скорость света, M - масса ядра атома полупроводника. Энергия электрона, при которой возможно начало смещения атомов, в кремнии составляет около 150 кэВ и в германии - 300 кэВ. При облучении проводников гамма-квантами, которые также используются в радиационной технологии, вероятность образования смещений в результате непосредственного взаимодействия гамма-кванта с ядром атома очень мала. Смещения в данном случае будут возникать за счет электронов, образующихся в полупроводнике главным образом в результате комптон-эффекта. В кремнии при облучении гамма-квантами Со60 со средней энергией ~1,25 МэВ комптоновские электроны возникают с энергией ~0,59 МэВ. Если энергия первичносмещенного атома значительна, то он может сам производить вторичные смещения и т.д.
Надо отметить, что первичные радиационные дефекты (междоузельный атом и вакансия) весьма подвижны и при комнатных температурах нестабильны. Они вступают во взаимодействие друг с другом - аннигилируют или взаимодействуют с имеющимися в кристалле примесями и несовершенствами - дислокациями и др. Так образуются более сложные вторичные радиационные дефекты, например, для кремния n-типа проводимости, легированного фосфором и наиболее характерны такие радиационные дефекты как вакансия + атом фосфора (Е-центр), вакансия + атом кислорода (А-центр), дивакансия (соединение двух вакансий) и другие. В настоящее время определено большое количество различных типов радиационных дефектов в зависимости от примесного состава полупроводника, вида радиационного воздействия, которые характеризуются различной энергией в запрещенной зоне, термической стабильностью и способностью влияния на электрические и оптические свойства полупроводника и полупроводниковых приборов (табл.1). Радиационные дефекты проявляют себя в полупроводниках как центры рекомбинации, изменяя время жизни неосновных носителей заряда, как центры захвата, снижая концентрацию основных носителей, и как центры рассеяния, уменьшая подвижность.
Таким образом, введением определенных строго
дозируемых концентраций термостабильных радиационных дефектов в полупроводники
и полупроводниковые приборные структуры можно регулировать их свойства и
характеристики порой с точностью, недостижимой при использовании диффузии
химических примесей. Это положено в основу разрабатываемых радиационных
технологий для конкретных типов полупроводниковых приборов.
1.2 Ядерные превращения
Известно, что при облучении веществ нейтронами и другими высокоэнергетичными частицами происходят ядерные реакции, приводящие к образованию атомов химических элементов, ранее отсутствовавших в материале. Легирование некоторых полупроводников при помощи медленных нейтронов (имеют большое сечение ядерной реакции) можно осуществить при равномерности распределения примесей ~3% в отличие от химическо-технологического легирования - 10÷15 %. Впервые предложил идею ядерного легирования и провел эксперимент на германии К. Ларк-Горовиц.
Особый интерес в настоящее время ядерное
легирование представляет для кремния и арсенида галлия, наиболее широко
применяемых в производстве полупроводниковых приборов и интегральных микросхем.
Таблица 1 Радиационные дефекты в кремнии и их параметры

Выращенный чистый кристалл кремния состоит в
основном из трех его изотопов - Si28 (92,21 %), Si29(4,7%)
и Si30(3,09%). Оказывается, что только изотоп Si30 может
захватывать нейтрон, превращаясь в стабильный изотоп фосфора Р31,
являющийся донором в кремнии. Ядерная реакция превращения атома кремния в атом
фосфора записывается как,
![]()
Изотопы кремния Si28 и Si29
при ядерных реакциях не дают других стабильных химических элементов, поэтому не
изменяют свойства кремния. Надо отметить , что ядерная реакция очень эффективно
протекает на медленных нейтронах (Ен.200 кэВ), плотность которых в обычном
атомном реакторе велика. Концентрацию атомов фосфора, являющегося донором в
кремнии, вследствие ядерной реакции, можно подсчитать по формуле:
![]()
где Фt- флюенс медленных нейтронов (н /см2), σ - эффективное сечение реакции (1,1∙10-25см2), N - концентрация атомов в кремнии (5∙1022см-3), Pi- содержание изотопа в кристалле (3,09 %).
Таким образом, концентрацию атомов фосфора в кристалле кремния можно регулировать дозой нейтронного облучения. После ядерного легирования кристаллы подвергаются термическому отжигу при температуре около 1350 К для устранения радиационных нарушений.
Возможность ядерного легирования арсенида галлия потоком реакторных нейтронов была впервые показана экспериментально. Ядра галлия и мышьяка (изотопы Ga69, Ga71, As75), захватившие нейтроны, превращаются в нестабильные изотопы, в результате распада которых образуются стабильные изотопы Ge70, Ge72 и Se76 согласно реакциям:

Реакции эффективно идут на медленных нейтронах
атомного реактора. Суммарная концентрация трансмутационно-вводимых примесей
может быть рассчитана по формуле (3). Подставляя соответствующие значения в
(3), получаем суммарную концентрацию атомов Ge и Se:
![]()
Соотношение концентраций трансмутационно
вводимых примесей Se и Ge составляет:
![]()
При этом обеспечивается высокая однородность и точность в распределении вводимых примесей.
Облученные в реакторе полупроводники обладают остаточной радиоактивностью, поэтому работа с ними возможна лишь после снижения удельной активности ниже определенного предела. В соответствии с рекомендациями МАГАТЭ по радиационной защите, радиоактивным считается любой материал, имеющий удельную активность 2∙10-3мкКи/г. Уровень наведенной радиоактивности определяется временем и условиями облучения, а также зависит от примесного состава облучаемого материала. В нелегированных полуизолирующих кристаллах GaAs, выращенных методом Чохральского, оптимально эффект трансмутационного легирования проявляется при облучении флюенсом медленных нейтронов в пределах 1016÷1018 н/см2.
Ядерно-легированными кристаллами кремния можно
пользоваться через сутки после облучения, арсенида галлия - через значительно
большее время.
.3 Ионизационные эффекты
В кристалле полупроводника или диэлектрика в
результате воздействия радиации образуются свободные электроны и положительно
заряженные ионы (дырки). Таким образом, возникают избыточные
электронно-дырочные пары, которых ранее в материале не было. Концентрацию таких
неравновесных пар можно подсчитать по формуле 16]:
![]()
где е - заряд электрона, φ- мощность дозы радиации; с - коэффициент преобразования, зависящий от вида радиации и ее энергетического спектра, τ- время жизни неравновесных носителей заряда.
Эффекты ионизации, с точки зрения использования в технологии, могут играть существенную роль в структурах металл-диэлектрик-полупроводник. Под воздействием излучения в диэлектрике накапливается заряд и там может сохраняться сколь угодно долго или нейтрализовать уже имеющийся в нем заряд другого знака. Этот эффект можно использовать для регулирования параметров приборов на МДП-структурах.
2. РАДИАЦИОННЫЕ ЭФФЕКТЫ В ТЕХНОЛОГИИ
.1 Ядерное легирование арсенида галлия
Применение и развитие традиционных методов металлургического легирования выявили ряд ограничений технологий, связанных с однородностью распределения легирующих примесей в объеме растущего кристалла, что обусловлено, главным образом, термодинамическими причинами. Альтернативой этому является ядерное легирование (ЯЛ) полупроводников. Мы здесь приведем некоторые полученные нами результаты по арсениду галлия .Удачное сочетание свойств данного материала (прямая структура энергетических зон, высокая эффективность излучательной рекомбинации, малая эффективная масса и высокая подвижность электронов) позволило создать на его основе многие приборы СВЧ, опто- и функциональной электроники, а также интегральные схемы. Исследования проводились на монокристаллах и эпитаксиальных слоях арсенида галлия. Ядерное легирование осуществлялось в различных каналах ядерного реактора, различающихся соотношениями плотностей медленных и быстрых (Е>0,1 МэВ) нейтронов фt/фf в диапазоне 50-185. Температура образцов в процессе облучения была около 700С.
Флюенс медленных нейтронов варьировался в пределах 5∙1016 ÷ 5∙1017 н/см2 . Отжиг образцов проводился в различных атмосферах (водород, азот) в ампулах в диапазоне температур 100÷1000 0С в течение 1 часа с шагом в 50 0С и последующим медленным охлаждением до комнатной температуры. После образцы подвергались травлению в полирующем травителе с целью удаления нарушенного слоя и промывке в деионизованной воде. Для измерения проводимости и эффекта Холла использовались образцы размером 5 х 5 мм2.
Характер восстановления свойств кристаллов ЯЛ
арсенида галлия (ЯЛАГ) зависит как от характеристик исходного материала, так и
от условий облучения рисунок 1. Анализ зависимостей удельного сопротивления от
температуры отжига p(Тотж)
позволяет выделить несколько стадий отжига. Основной отжиг радиационных
дефектов происходит в диапазоне температур 420÷520 0С.
Удельное сопротивление в результате отжига образцов снизилось на шесть
порядков.

Рисунок 1- зависимость удельного сопротивления
ЯЛ n-GaAs от температуры изохронного отжига. Исходная концентрация носителей
заряда до облучения 2∙10 16 (1) и 3∙10 15 см -3(2).
Доза облучения Фt=5∙10
17 см -2, φt/φf=50.
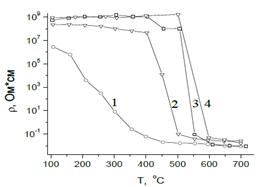
Рисунок 2- зависимость удельного сопротивления
ЯЛ полуизолирующего и n-типа GaAs от температуры изохронного отжига. Исходный
материал: 1,3- n=2∙10 16
см-3; 2,4- полуизолирующий, p>10
7 Ом.см
При отжиге образцов ЯЛАГ, облученных медленными нейтронами флюенсом Фt=5∙10 17 см -2, φt/φf=185, было установлено: чем выше исходная концентрация носителей заряда, тем с меньших температур начинает протекать процесс отжига (рис. 2). Соотношение φt/φf также влияет на характер кривых отжига p(Тотж) по сравнению с рис. 1. Происходит некоторый сдвиг кривых отжига в низкотемпературную область, и проявляются ряд стадий отжига.
Окончательное восстановление свойств происходит при несколько меньших температурах, чем в первом случае (рис. 1). Исследовалось изменение p, n, µ в результате отжига эпитаксиальных слоев (ЭС) арсенида галлия, облученных флюенсом медленных нейтронов Фt=5∙10 16 см -2, φt/φf=185 (рис. 3). Исходные эпитаксиальные слои GaAs (n=1∙10 15 см -3) были выращены методом хлоридной эпитаксии на подложках полуизолирующего арсенида галлия.
Характер отжига эпитаксиальных слоев во многом схож с отжигом объемных кристаллов. Однако есть и отличия. На зависимостях µ(Тотж) и n(Тотж) наблюдаются лишь две стадии отжига. Восстановление свойств эпитаксиальных слоев происходит при более низких температурах (~500 0С), чем у массивных образцов. Исследованиями было установлено, что ядерно-легированные слои GaAs являются более однородными по своим электрическим свойствам по сравнению со структурами аналогичного уровня легирования, полученными методами газофазной эпитаксии.
Сделаем краткий анализ экспериментальных
результатов. Процесс ядерного легирования сопровождается введением
значительного числа радиационных дефектов в образцы, источником которых
являются как реакторные излучения (нейтроны, γ-кванты),
так и первично смещенные атомы матрицы облучаемого вещества и продукты ядерных
реакций. Известно, что при реакторном облучении GaAs вводятся как точечные
радиационные дефекты, так и сложные дефектные ассоциаты (области
разупорядочения). Введенные облучением радиационные дефекты обусловливают появление
в запрещенной зоне GaAs энергетических уровней, являющихся центрами захвата для
электронов в зоне проводимости. Захват носителей на уровне РД приводит к
смещению уровня Ферми к середине запрещенной зоны и выражается в сильном
снижении концентрации носителей заряда, росте удельного сопротивления
кристалла, снижении подвижности, что и наблюдается в эксперименте.
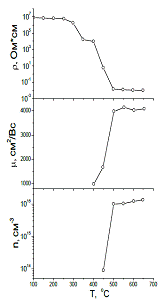
Рисунок 3 - зависимости n,p,µ
ЯЛ ЭС GaAs от температуры отжига
При равных дозах облучения этот эффект сильнее проявляется в образцах с более высоким исходным удельным сопротивлением, так как концентрация основных носителей у них ниже. Увеличение в облучающем спектре составляющей быстрых нейтронов, являющихся наиболее интенсивным источником дефектообразования, усиливает компенсацию образцов. При пострадиационной термообработке происходит отжиг радиационных нарушений и активация введенных трансмутационных примесей. Уровень Ферми перемещается в сторону зоны проводимости, стремясь к положению, определяемому уровнем ядерного легирования образцов. Изменение относительных концентраций различных типов вводимых РД, отличающихся своей термостабильностью и обусловливает наблюдаемые особенности отжига облученных кристаллов. Образцы восстанавливаются, приобретая заданную концентрацию носителей заряда, при температурах 450-600 0С.
2.2 Увеличение быстродействия полупроводниковых
приборов
Большинство полупроводниковых приборов в настоящее время изготавливается на основе кремния. Полученные по обычной диффузионной технологии или с помощью ионной имплантации биполярные кремниевые полупроводниковые приборы обладают значительной инерционностью. Это снижает их быстродействие и не позволяет применять в быстродействующей аппаратуре. Во время эксплуатации таких приборов также велики энергопотери при их коммутации. В основе эффекта инерционности, низкого быстродействия, лежит физический процесс накопления и рассасывания заряда неравновесных носителей в базе р-n-структуры (основы большинства полупроводниковых приборов: диодов, транзисторов, тиристоров и др.) при прохождении электрического тока.
При этом, чем чище и совершеннее исходный полупроводниковый кристалл, на основе которого изготовлен прибор, чем больше токи, тем выше инерционность.
Например, полупроводниковый диод, изготовленный на кремнии обычным методом, имеет время переключения из открытого состояния в закрытое порядка 10-4 - 10-6 c, а для использования в современной быстродействующей аппаратуре, а также для снижения коммутационных энергопотерь при работе прибора необходимо время переключения порядка 10-7 - 10-9 c. Для увеличения быстродействия обычно используется введение в р-n-структуры приборов диффузионным способом химических примесей (золота, платины), являющихся эффективными центрами рекомбинации неравновесных носителей заряда и уменьшающих скорость рассасывания накопленного заряда. Как показал мировой опыт, лучшие результаты дает использование золота, обусловливающего появление в запрещенной зоне кремния двух глубоких энергетических уровней: Еc-0,54 эВ и Еv+0,35 эВ. Здесь следует отметить, что операция диффузии золота в кристаллы кремния плохо контролируема и трудоемка. Диффузия золота в кремнии с р-n-переходами осуществляется при температуре около 1100 0С и процесс идет около часа. Незначительные отклонения от температурного режима, а также отклонения в параметрах исходного кремния приводят к значительному разбросу характеристик приборов и браку. Причем, пределы растворимости золота в кремнии не позволяют добиться максимального быстродействия приборов и микросхем, а способность золота скапливаться на неоднородностях и дислокациях может приводить к электрическим пробоям приборов, особенно работающих при больших импульсных токах. Кроме того, экономия золота или платины также является важным фактором, особенно для Республики Беларусь, которая не добывает этих металлов.